1.A: Apéndice- Modelos de Dispositivos Activos
- Page ID
- 86048
Este apéndice presenta los parámetros del modelo de los tres tipos de transistores más comunes utilizados en los diseños de microondas. Estos modelos están disponibles en casi todos los simuladores de circuito. Los modelos de transistores implementan ecuaciones de dispositivos que se han desarrollado a partir del conocimiento físico con las simplificaciones necesarias necesarias para su implementación en un simulador. El propósito de presentar estos modelos es para que se pueda examinar la descripción física básica de la operación.
1.A.1 Modelo MOSFET Nivel 3
El modelo MOSFET de nivel 3 es el modelo de un transistor MOSFET de silicio y es uno de un gran número de modelos MOSFET diferentes que se utilizan [15, 16, 17, 18]. Los MOSFET son el transistor más complicado de modelar, ya que su operación se basa en atraer portadoras al canal debajo de la puerta en un proceso llamado inversión. El modelo MOS nivel 3 aquí utiliza el modelo Yang—Chatterjee que conserva la carga [19] para modelar la carga y la capacitancia. Durante muchos años el modelo MOSFET de nivel 3 se implementó en simuladores de circuito pero no conservó carga. Un ejemplo de errores que pueden existir en los modelos de dispositivos.
Los parámetros del modelo enumerados en la Tabla\(\PageIndex{1}\) pueden ser especificados por el diseñador del circuito.
| Nombre | Descripción | Unidades | Predeterminado |
|---|---|---|---|
| gamma | Parámetro de umbral masivo | \(\text{V}^{0.5}\) | \(0\) |
Cuadro\(\PageIndex{1}\): Parámetros del modelo MOSFET Nivel 3.
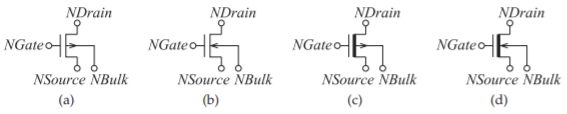
Figura\(\PageIndex{1}\): Tipos de MOSFET: (a) tipo p de modo de mejora; (b) tipo p de modo de mejora; (c) tipo n de modo de agotamiento; (d) tipo n de modo de agotamiento; (d) tipo n de modo de agotamiento;
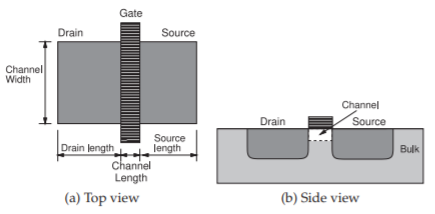
Figura\(\PageIndex{2}\): Disposición física de un transistor MOSFET.
| Nombre | Descripción | Unidades | Predeterminado |
|---|---|---|---|
| kp | Parámetro de transconductancia | \(\text{A/V}^{2}\) | \(0.000021\) |
| l | Longitud del dispositivo | \(\text{m}\) | \(0.000002\) |
| w | Ancho del dispositivo | \(\text{m}\) | \(0.00005\) |
| ld | Longitud de difusión lateral | \(\text{m}\) | \(0\) |
| wd | Ancho de difusión lateral | \(\text{m}\) | \(0\) |
| nsub | Dopaje de sustrato | \(\text{cm}^{-3}\) | \(0\) |
| phi | Potencial de inversión superficial | \(\text{V}\) | \(0.6\) |
| tox | Grosor de óxido | \(\text{m}\) | \(1\times 10^{-7}\) |
| u0 | Movilidad de superficie | \(\text{cm}^{2}/\text{V-s}\) | \(600\) |
| vt0 | Voltaje umbral de polarización cero | \(\text{V}\) | \(0\) |
| kappa | Factor de campo de saturación | \(\text{m}\) | \(0.2\) |
| t | Temperatura del dispositivo | grados | \(300.15\) |
| tnom | Temperatura nominal | grados | \(300.15\) |
| nfs | Densidad rápida del estado superficial | \(\text{cm}^{-2}\) | \(0\) |
| eta | Retroalimentación estática en el voltaje umbral | \(0\) | |
| theta | Modulación de movilidad | \(1/\text{V}\) | \(0\) |
| tpg | Tipo de material de puerta | \(0\) | |
| nss | Densidad de estado superficial | \(\text{cm}^{-2}\) | \(0\) |
| vmax | Velocidad máxima de deriva del portador | \(\text{m/sec}\) | \(0\) |
| xj | Profundidad de unión metalúrgica | \(0\) | |
| delta | Efecto de ancho en el voltaje umbral | \(0\) |
Mesa\(\PageIndex{2}\)
Ecuaciones de dispositivos
Las ecuaciones de dispositivo aquí son específicamente para un MOSFET tipo p. Se requieren cambios de señal para obtener las indicaciones actuales adecuadas para un MOSFET de tipo n. El subíndice\(D\) se refiere al drenaje,\(S\) se refiere a la fuente y\(G\) se refiere a la puerta. Las constantes utilizadas son
\[\begin{array}{ll}{q=1.6021918\times 10^{-19}\text{ (As)}}&{k=1.3806226\times 10^{-23}\text{ (J/K)}}\\{\epsilon_{0}=8.85421487\times 10^{-12}\text{ (F/m)}}&{\epsilon_{s}=11.7\:\epsilon_{0}}\end{array}\nonumber \]
Todos los parámetros utilizados se indican en\(\mathsf{THIS}\) fuente.
\[\begin{align}\label{eq:1}E_{g}&=1.16-\frac{7.02\times 10^{-4}\mathsf{T}^{2}}{\mathsf{T}+1108}(\text{V}) \quad &C_{ox}=\frac{\epsilon_{0} 3.9}{\mathsf{TOX}}(\text{F})\\ \label{eq:2}L_{\text{eff}}&=\mathsf{L}-2\mathsf{LD} \quad &W_{\text{eff}}=\mathsf{W}-2\mathsf{WD} \end{align} \]
Coeficiente de ancho de capa de agotamiento:
\[\label{eq:3}X_{d}=\sqrt{\frac{2\varepsilon_{s}}{q\mathsf{NSUB}10^{6}}} \]
Voltaje incorporado:
\[\label{eq:4}V_{bi}=\mathsf{VT0}-\mathsf{GAMMA}\sqrt{\mathsf{PHI}} \]
Raíz cuadrada del voltaje del sustrato:
\[\label{eq:5}\begin{array}{lll}{V_{BS}\leq 0}&{\Longrightarrow}&{SqV_{BS}=\sqrt{\mathsf{PHI}-V_{BS}}}\\{V_{BS}>0}&{\Longrightarrow}&{SqV_{BS}=\sqrt{\frac{\mathsf{PHI}}{1+\frac{0.5}{\mathsf{PHI}}V_{BS}(1+\frac{0.75}{\mathsf{PHI}}V_{BS})}}}\end{array} \]
Factor de corrección de efectos de canal corto:
En un dispositivo de canal corto, el voltaje umbral del dispositivo tiende a ser menor ya que parte de la carga de agotamiento en la masa termina los campos eléctricos en la fuente y el drenaje. El valor de este factor de corrección está determinado por la profundidad metalúrgica,\(\mathsf{XJ}\).
\[\begin{align}\label{eq:6}c_{0}&=0.0631353 \\ \label{eq:7}c_{1}&=0.8013292 \\ \label{eq:8}c_{2}&=-0.01110777 \\ \label{eq:9}T_{1}&=\mathsf{XJ}(c_{0}+c_{1}X_{d}SqV_{BS}+c_{2}(X_{d}SqV_{BS})^{2}) \\ \label{eq:10}F_{s}&=1-\frac{\mathsf{LD}+T_{1}}{L_{\text{eff}}}\sqrt{1-\left(\frac{X_{d}SqV_{BS}}{\mathsf{XJ}+X_{d}SqV_{BS}}\right)^{2}}\end{align} \]
Factor de correlación de efecto de canal estrecho:
Los efectos de borde en un canal estrecho hacen que la carga de agotamiento se extienda más allá del ancho del canal. Esto tiene el efecto de aumentar el voltaje umbral:
\[\label{eq:11}F_{n}=\frac{\pi\epsilon_{s}\mathsf{DELTA}}{2C_{ox}W_{\text{eff}}} \]
Coeficiente de retroalimentación estática:
El voltaje umbral disminuye porque la carga debajo del terminal de puerta agotada por el campo de unión de drenaje aumenta con\(V_{DS}\). Este efecto es la disminución de la barrera inducida por drenaje (DIBL):
\[\label{eq:12}\sigma=\frac{8.14\times 10^{-22}\mathsf{ETA}}{L_{\text{eff}}^{3}C_{ox}} \]
Voltaje umbral:
\[\label{eq:13}V_{th}=V_{bi}-\sigma C_{DS}+\mathsf{GAMMA}\: SqV_{BS}F_{s}+F_{n}SqV_{BS}^{2} \]
Operación por debajo del umbral:
Esta variable se invoca dependiendo del valor del parámetro NFS y se usa solo cuando se encuentra en el modo subumbral:
\[\label{eq:14}X_{n}=1+\frac{q\mathsf{NFS}\:10^{4}}{C_{ox}}+\frac{F_{n}}{2}+\frac{\mathsf{GAMMA}}{2}\frac{F_{s}}{SqV_{BS}} \]
Voltaje umbral modificado:
Esta variable define el límite entre inversión débil y fuerte:
\[\label{eq:15}\begin{array}{lll}{\mathsf{NFS}>0}&{\Longrightarrow}&{V_{on}=V_{th}+\frac{kT}{q}X_{n}}\\{\mathsf{NFS}\leq 0}&{\Longrightarrow}&{V_{on}=V_{th}}\end{array} \]
Voltaje de puerta subumbral:
\[\label{eq:16}V_{gsx}=\text{MAX}(V_{GS},V_{on}) \]
Movilidad superficial:
\[\label{eq:17}\mu_{s}=\frac{\mathsf{U0}10^{-4}}{1+\mathsf{THETA}(V_{gsx}-V_{th})} \]
Tensión de saturación:
El cálculo de esta tensión requiere muchos pasos. La movilidad efectiva se calcula como
\[\label{eq:18}\mu_{\text{eff}}=\mu_{s}F_{\text{drain}} \]
donde
\[\begin{align}\label{eq:19}F_{\text{drain}}&=\left(1+\frac{\mu_{s}V_{DS}}{\mathsf{VMAX}L_{\text{eff}}}\right)^{-1}\\ \label{eq:20}\beta&=\frac{W_{\text{eff}}}{L_{\text{eff}}}\mu_{\text{eff}}C_{ox}\end{align} \]
La expansión de Taylor de carga a granel es
\[\label{eq:21}F_{B}=\frac{\mathsf{GAMMA}}{4}\frac{F_{s}}{SqV_{BS}}+2F_{n} \]
El valor estándar del voltaje de saturación se calcula como
\[\label{eq:22}V_{\text{sat}}=\frac{V_{gsx}-V_{th}}{1+F_{B}} \]
El valor final de la tensión de saturación depende del parámetro\(\mathsf{VMAX}\):
\[\label{eq:23}\begin{array}{lll}{\mathsf{VMAX}=0}&{\Longrightarrow}&{V_{d\text{sat}}=V_{\text{sat}}}\\{\mathsf{VMAX}>0}&{\Longrightarrow}&{V_{d\text{sat}}=V_{\text{sat}}+V_{c}-\sqrt{V_{\text{sat}}^{2}+V_{c}^{2}},\quad V_{c}=\mathsf{VMAX}\: L_{\text{eff}}/\mu_{s}}\end{array} \]
Tensión de drenaje de saturación de velocidad:
Esto asegura que el voltaje de drenaje no exceda el voltaje de saturación:
\[\label{eq:24}V_{dsx}=\text{MIN}(V_{DS},V_{d\text{sat}}) \]
Corriente de drenaje:
Región lineal:
\[\label{eq:25}I_{DS}=\beta\frac{\mu_{s}}{\mathsf{U0}10^{-4}}F_{\text{drain}}(V_{gsx}-V_{th}-\frac{1+F_{B}}{2}V_{dsx})V_{dsx} \]
Región de saturación:
\[\label{eq:26}I_{DS}=\beta\left[(V_{GS}-V_{th})-\frac{1+F_{B}}{2}V_{d\text{sat}}\right]V_{d\text{sat}} \]
Usando la ecuación\(\eqref{eq:20}\), esto se convierte
\[\label{eq:27}I_{DS}=\frac{W_{\text{eff}}}{L_{\text{eff}}}\mu_{\text{eff}}C_{ox}\left[(V_{GS}-V_{th})-\frac{1+F_{B}}{2}V_{d\text{sat}}\right]V_{d\text{sat}} \]
Región de corte:
\[\label{eq:28}I_{DS}=0 \]
Modulación de longitud de canal:
A\(V_{DS}\) medida que aumenta más allá\(V_{d\text{sat}}\), el punto donde la velocidad del portador comienza a saturarse se mueve hacia la fuente. Esto es modelado por el término\(\Delta_{\ell}\):
\[\label{eq:29}\Delta_{\ell}=X_{d}\sqrt{\frac{X_{d}^{2}E_{p}^{2}}{4}+\mathsf{KAPPA}\: (V_{DS}-V_{d\text{sat}})}-\frac{E_{p}X_{d}^{2}}{2} \]
donde\(E_{p}\) está el campo lateral al pellizcar y viene dado por
\[\label{eq:30}E_{p}=\frac{\mathsf{VMAX}}{\mu_{s}(1-F_{\text{drain}})} \]
La corriente de drenaje se multiplica por un factor de corrección,\(l_{\text{fact}}\). Este factor evita que el denominador\((L_{\text{eff}} −\Delta_{\ell})\) vaya a cero:
\[\label{eq:31}\begin{array}{lll}{\Delta_{\ell}\leq 0.5L_{\text{eff}}}&{\Longrightarrow}&{l_{\text{fact}}=\frac{L_{\text{eff}}}{L_{\text{eff}}-\Delta_{\ell}}}\\{\Delta_{\ell}>0.5 L_{\text{eff}}}&{\Longrightarrow}&{l_{\text{fact}}=\frac{4\Delta_{\ell}}{L_{\text{eff}}}}\end{array} \]
El valor corregido de la corriente drenaje-fuente es
\[\label{eq:32}I_{DS\text{new}}=I_{DS}l_{\text{fact}} \]
Operación por debajo del umbral:
Para la operación por debajo del umbral, si\(\mathsf{NFS}\) se especifica el parámetro de densidad superficial rápida y\(V_{GS}\leq V_{on}\), entonces el valor final de la corriente drenaje-fuente viene dado por
\[\label{eq:33}I_{DS\text{final}}=I_{DS\text{new}}\text{e}^{\frac{kt}{q}\frac{V_{GS}-V_{\text{on}}}{X_{n}}} \]
Modelo de carga Yang-Chatterjee [19]
Este modelo asegura la continuidad de las cargas y capacitancias en diferentes regiones de operación. Las cantidades intermedias son
\[\label{eq:34}V_{FB}=V_{to}-\mathsf{GAMMA}\sqrt{\mathsf{PHI}}-\mathsf{PHI} \]
y
\[\label{eq:35}C_{o}=C_{ox}W_{\text{eff}}L_{\text{eff}} \]
Región de acumulación,\(V_{GS}\leq V_{FB}+V_{BS}\):
\[\label{eq:36}Q_{d}=0,\quad Q_{s}=0,\quad Q_{b}=-C_{0}(V_{GS}-V_{FB}-V_{BS}) \]
Región de corte,\(V_{FB}+V_{BS}<V_{GS}\leq V_{th}\):
\[\label{eq:37}Q_{d}=0,\quad Q_{s}=0,\quad Q_{b}=-C_{o}\frac{\mathsf{GAMMA}^{2}}{2}\{-1+\sqrt{1+\frac{4(V_{GS}-V_{FB}-V_{BS})}{\mathsf{GAMMA}^{2}}}\} \]
Región de saturación,\(V_{th}<V_{GS}\leq V_{DS}+V_{th}\):
\[\label{eq:38}Q_{d}=0,\quad Q_{s}=-\frac{2}{3}C_{o}(V_{GS}-V_{th}),\quad Q_{b}=C_{0}(V_{FB}\mathsf{PHI}-V_{th}) \]
Región lineal,\(V_{GS}>V_{DS}+V_{th}\):
\[\begin{align}\label{eq:39}Q_{d}&=-C_{o}\left[\frac{V_{DS}^{2}}{8(V_{GS}-V_{th}-\frac{1}{2}V_{DS})}+\frac{V_{GS}-V_{th}}{2}-\frac{3}{4}V_{DS}\right] \\ \label{eq:40}Q_{s}&=-C_{o}\left[\frac{V_{DS}^{2}}{24(V_{GS}-V_{th}-\frac{1}{2}V_{DS})}+\frac{V_{GS}-V_{th}}{2}+\frac{1}{4}V_{DS}\right] \\ \label{eq:41}Q_{b}&=C_{o}(V_{FB}\mathsf{PHI}-V_{th})\end{align} \]
Las corrientes finales en los nodos del transistor vienen dadas por
\[\label{eq:42}I_{d}=I_{DS\text{final}}+\frac{dQ_{d}}{dt}\quad I_{g}=\frac{dQ_{g}}{dt}\quad I_{s}=-I_{DS\text{final}}+\frac{dQ_{s}}{dt} \]
1.A.2 Materka—Kacprzak Modelo MESFET

Figura\(\PageIndex{3}\): Elemento MESFET.
El modelo de transistor Materka—Kacprzak fue desarrollado para transistores MESFET de GaAs [14] pero también se utiliza para modelar JFET de silicio y transistores HEMT semiconductores compuestos. Se basa en la interpretación física de un transistor con una puerta basada en uniones. Existen otros modelos [20, 21, 22], pero el modelo Materka—Kacprzak es representativo de los JFET.
| Nombre | Descripción | Unidades | Predeterminado |
|---|---|---|---|
| \(\mathsf{AFAB}\) | Factor de pendiente de la corriente de ruptura\((AF\: AB)\) | \(1/V\) | \(0.0\) |
| \(\mathsf{AFAG}\) | Factor de pendiente de la corriente de conducción de puerta\((AF\: AG)\) | \(1/V\) | \(38.696\) |
| \(\mathsf{AREA}\) | Multiplicador de área\((AREA)\) | - | \(1.0\) |
| \(\mathsf{C10}\) | Fuente de compuerta Capacitancia de barrera Schottky para\((C_{10})\) | \(\text{F}\) | \(0.0\) |
| \(\mathsf{CFO}\) | Capacitancia de retroalimentación de drenaje de compuerta para\((C_{F0})\) | \(\text{F}\) | \(0.0\) |
| \(\mathsf{CLS}\) | Componente parásito constante de la capacitancia puerta-fuente\((C_{LS})\) | \(\text{F}\) | \(0.0\) |
| \(\mathsf{E}\) | Parte constante del parámetro de ley de potencia\((E)\) | - | \(2.0\) |
| \(\mathsf{GAMA}\) | Parámetro de pendiente de voltaje del voltaje de pellizco\((\gamma)\) | \(1/V\) | \(0.0\) |
| \(\mathsf{IDSS}\) | Corriente de saturación de drenaje para\((I_{DSS})\) | \(\text{A}\) | \(0.1\) |
| \(\mathsf{IG0}\) | Corriente de saturación de la barrera Schottky puerta-fuente\((I_{G0})\) | \(\text{A}\) | \(0.0\) |
| \(\mathsf{K1}\) | Parámetro de pendiente de la capacitancia puerta-fuente\((K_{1})\) | \(1/V\) | \(1.25\) |
| \(\mathsf{KE}\) | Dependencia de la ley de poder sobre\(V_{GS}\),\((K_{E})\) | \(1/V\) | \(0.0\) |
| \(\mathsf{KF}\) | Parámetro de pendiente de la capacitancia de retroalimentación puerta-drenaje\((K_{F})\) | \(1/V\) | \(1.25\) |
| \(\mathsf{KG}\) | Dependencia de drenaje\(V_{GS}\) en la región lineal,\((K_{G})\) | \(1/V\) | \(0.0\) |
| \(\mathsf{KR}\) | Factor de pendiente de la resistencia intrínseca del canal\((K_{R})\) | \(1/V\) | \(0.0\) |
| \(\mathsf{RI}\) | Resistencia intrínseca del canal para\((R_{I})\) | \(\Omega\) | \(0.0\) |
| \(\mathsf{SL}\) | Pendiente de la característica de drenaje en la región saturada,\((S_{L})\) | \(\text{S}\) | \(0.15\) |
| \(\mathsf{SS}\) | Pendiente de la característica de drenaje en la región saturada\((S_{S})\) | \(\text{S}\) | \(0.0\) |
| \(\mathsf{T}\) | Retraso de tiempo de tránsito del canal\((\tau )\) | \(\text{s}\) | \(0.0\) |
| \(\mathsf{VBC}\) | Voltaje de ruptura\((V_{BC})\) | \(\text{V}\) | \(10^{10}\) |
| \(\mathsf{VP0}\) | Voltaje de pellizco para\((V_{P0})\) | \(\text{V}\) | \(-2.0\) |
Tabla\(\PageIndex{3}\): Parámetros del modelo Materka—Kacprzak
Las constantes físicas utilizadas en la evaluación del modelo son
| \(k\) | la constante de Boltzmann | \(1.3806226\: 10^{-23}\text{ J/K}\) |
|---|---|---|
| \(q\) | carga electrónica | \(1.6021918\: 10^{-19}\text{ C}\) |
Mesa\(\PageIndex{4}\)
Cálculos estándar:
\[\label{eq:43}V_{\text{TH}}=(kT)/q \]
donde\(T\) está la temperatura de análisis. También
\[\begin{array}{ll}{V_{DS}}&{\text{is the intrinsic drain source voltage}} \\ {V_{GS}}&{\text{is the intrinsic gate source voltage, and}} \\ {V_{GD}}&{\text{is the intrinsic gate drain voltage}}\end{array}\nonumber \]
Ecuaciones de dispositivos
Características actuales:
\[\begin{align}\label{eq:44}I_{DS}&=\text{Area}\: I_{DSS}\left[1+S_{S}\frac{V_{DS}}{I_{DSS}}\right]\left[1-\frac{V_{GS}(t-\tau)}{V_{P0}+\gamma V_{DS}}\right]^{(E+K_{E}V_{GS}(t-\tau))}\times\tanh\left[\frac{S_{L}V_{DS}}{I_{DSS}(1-K_{G}V_{GS}(t-\tau))}\right] \\ \label{eq:45} I_{GS}&=\text{Area}\: I_{G0}\left[\text{e}^{A_{F\: AG}V_{GS}}-1\right]-I_{B0}\left[\text{e}^{-A_{F\:AB}(V_{GS}+V_{BC})}\right] \\ \label{eq:46} I_{GD}&=\text{Area}\: I_{G0}\left[\text{e}^{A_{F\: AG}V_{GD}}-1\right]-I_{B0}\left[\text{e}^{-A_{F\:AB}(V_{GD}+V_{BC})}\right] \\ \label{eq:47}R_{I}&=\left\{\begin{array}{ll}{R_{10}(1-K_{R}V_{GS})/\text{Area}}&{K_{R}V_{GS}<1.0} \\{0}&{K_{R}V_{GS}\geq 1.0}\end{array}\right. \end{align} \]
Capacitancia:
\(C_{LVL} = 1\)(por defecto) para el modelo de capacitancia Materka—Kacprzak estándar que se describe a continuación. Las capacitancias Materka-Kacprzak son
\[\begin{align}\label{eq:48}C_{DS}'&=C_{DS} \\ \label{eq:49}C_{GS}'&=\left\{\begin{array}{ll}{[C_{10}(1-K_{1}V_{GS})^{M_{GS}}+C_{1S}]}&{K_{1}V_{GS}<F_{CC}}\\{[C_{10}(1-F_{CC})^{M_{GS}}+C_{1S}]}&{K_{1}V_{GS}\geq F_{CC}}\end{array}\right. \\ \label{eq:50}C_{GD}'&=\left\{\begin{array}{ll}{\text{Area }[C_{F0}(1-K_{1}V_{1})^{M_{GD}}]}&{K_{1}V_{1}<F_{CC}}\\{\text{Area }[C_{F0}(1-F_{CC})^{M_{GD}}]}&{K_{1}V_{1}\geq F_{CC}}\end{array}\right.\end{align} \]
1.A.3 Gummel-Poon: Modelo de Transistor de Unión Bipolar

Figura\(\PageIndex{4}\):\(\text{Q}\) - Transistor de unión bipolar: (a) transistor npn, (b) transistor pnp.
Los modelos de transistores bipolares se basan en el modelo Gummel—Poon [7] descrito aquí. La característica clave del modelo es que captura la dependencia de la ganancia de corriente directa e inversa con respecto a la corriente. En esencia, el modelo BJT es una fuente de corriente controlada por corriente. El modelo Gummel— Poon y sus derivados se utilizan para modelar BJT de silicio y HBTs semiconductores compuestos [23, 24].
| Nombre | Descripción | Unidades | Predeterminado |
|---|---|---|---|
| \(\mathsf{AREA}\) | Multiplicador de corriente | \(1.0\) | |
| \(\mathsf{BF}\) | Beta delantera máxima ideal\((B_{F})\) | \(100.0\) | |
| \(\mathsf{BR}\) | Beta inversa máxima ideal\((B_{R})\) | \(1.0\) | |
| \(\mathsf{C2}\) | Coeficiente de saturación de fuga de base-emisor | \(I_{SE}/I_{S}\) | |
| \(\mathsf{C4}\) | Coeficiente de saturación de fuga de colector base | \((I_{SC}/I_{S})\) | |
| \(\mathsf{CJC}\) | Capacitancia p-n de polarización cero del colector base\((C_{JC})\) | \(\text{F}\) | \(0.0\) |
| \(\mathsf{CJE}\) | Capacitancia p-n de polarización cero del emisor base\((C_{JE})\) | \(\text{F}\) | \(0.0\) |
| \(\mathsf{EG}\) | Voltaje de banda prohibida\((E_{G})\) | \(\text{eV}\) | \(1.11\) |
| \(\mathsf{FC}\) | Coeficiente de condensador de agotamiento de polarización directa\((F_{C})\) | \(0.5\) | |
| \(\mathsf{IKF}\) | Esquina de roll-off de alta corriente beta delantera\((I_{KF})\) | \(\text{A}\) | \(10^{-10}\) |
| \(\mathsf{IKR}\) | Esquina para roll off de alta corriente beta inversa\((I_{KR})\) | \(10^{-10}\) | |
| \(\mathsf{IS}\) | Corriente de saturación de transporte\((I_{S})\) | \(\text{A}\) | \(10^{-16}\) |
| \(\mathsf{ISC}\) | Corriente de saturación de fuga de colector base\((I_{SC})\) | \(\text{A}\) | \(0.0\) |
| \(\mathsf{ISE}\) | Corriente de saturación de fuga de base-emisor\((I_{SE})\) | \(\text{A}\) | \(0.0\) |
| \(\mathsf{IRB}\) | Corriente a la que\(\mathsf{RB}\) cae a la mitad de\(R_{BM}\)\((I_{RB})\) | \(\text{A}\) | \(10^{-10}\) |
| \(\mathsf{ITF}\) | Dependencia del tiempo de tránsito en\(\mathsf{IC}\)\((I_{TF})\) | \(\text{A}\) | \(0.0\) |
| \(\mathsf{MJC}\) | Factor de gradación p-n del colector base\((M_{JC})\) | \(0.33\) | |
| \(\mathsf{MJE}\) | Factor de gradación p-n del emisor base\((M_{JE})\) | \(0.33\) | |
| \(\mathsf{NC}\) | Coeficiente de emisión de fugas de colector base\((N_{C})\) | \(2.0\) | |
| \(\mathsf{NE}\) | Coeficiente de emisión de fugas base-emisor\((N_{E})\) | \(1.5\) | |
| \(\mathsf{NF}\) | Coeficiente de emisión de corriente directa\((N_{F})\) | \(1.0\) | |
| \(\mathsf{NR}\) | Coeficiente de emisión de corriente inversa\((N_{R})\) | \(1.0\) | |
| \(\mathsf{RB}\) | Resistencia de base de polarización cero\((R_{B})\) | \(\Omega\) | \(0.0\) |
| \(\mathsf{RBM}\) | Resistencia mínima de la base\((R_{BM})\) | \(\Omega\) | \(R_{B}\) |
| \(\mathsf{RE}\) | Resistencia óhmica del emisor\((R_{E})\) | \(\Omega\) | \(0.0\) |
| \(\mathsf{RC}\) | Resistencia óhmica del colector\((R_{C})\) | \(\Omega\) | \(0.0\) |
| \(\mathsf{T}\) | Temperatura de funcionamiento\(T\) | \(\text{K}\) | \(300\) |
| \(\mathsf{TF}\) | Tiempo ideal de tránsito hacia adelante\((T_{S})\) | \(\text{secs}\) | \(0.0\) |
| \(\mathsf{TNOM}\) | Temperatura nominal\((T_{\text{NOM}})\) | \(\text{K}\) | \(300\) |
| \(\mathsf{TR}\) | Tiempo de tránsito inverso ideal\((T_{R})\) | \(\text{S}\) | \(0.0\) |
| \(\mathsf{TRB1}\) | \(\mathsf{RB}\)coeficiente de temperatura (lineal)\((T_{RB1})\) | \(0.0\) | |
| \(\mathsf{TRB2}\) | \(\mathsf{RB}\)coeficiente de temperatura (cuadrático)\((T_{RB2})\) | \(0.0\) | |
| \(\mathsf{TRC1}\) | \(\mathsf{RC}\)coeficiente de temperatura (lineal)\((T_{RC1})\) | \(0.0\) | |
| \(\mathsf{TRC2}\) | \(\mathsf{RC}\)coeficiente de temperatura (lineal)\((T_{RC2})\) | \(0.0\) | |
| \(\mathsf{TRE1}\) | \(\mathsf{RE}\)coeficiente de temperatura (lineal)\((T_{RE1})\) | \(0.0\) | |
| \(\mathsf{TRE2}\) | \(\mathsf{RE}\)coeficiente de temperatura (cuadrático)\((T_{RE2})\) | \(0.0\) | |
| \(\mathsf{TRM1}\) | \(\mathsf{RBM}\)coeficiente de temperatura (lineal)\((T_{RM1})\) | \(0.0\) | |
| \(\mathsf{TRM2}\) | \(\mathsf{RBM}\)coeficiente de temperatura (cuadrático)\((T_{RM2})\) | \(0.0\) | |
| \(\mathsf{VA}\) | Palabra clave alternativa para\(\mathsf{VAF}\)\((V_{A})\) | \(\text{V}\) | \(10^{-10}\) |
| \(\mathsf{VAF}\) | Voltaje temprano hacia adelante\((V_{AF})\) | \(\text{V}\) | \(10^{-10}\) |
| \(\mathsf{VAR}\) | Voltaje temprano inverso\((V_{AR})\) | \(10^{-10}\) | |
| \(\mathsf{VB}\) | Palabra clave alternativa para\(\mathsf{VAR}\)\((V_{B})\) | \(10^{-10}\) | |
| \(\mathsf{VJC}\) | Colector base construido en potencial\((V_{JC})\) | \(\text{V}\) | \(0.75\) |
| \(\mathsf{VJE}\) | Emisor base construido en potencial\((V_{JE})\) | \(\text{V}\) | \(0.75\) |
| \(\mathsf{VTF}\) | Dependencia del tiempo de tránsito en\(\mathsf{VBC}\)\((V_{TF})\) | \(\text{V}\) | \(10^{-10}\) |
| \(\mathsf{XCJC}\) | Fracción de\(\mathsf{CBC}\) conexión interna a\(\mathsf{RB}\)\((X_{CJC})\) | \(1.0\) | |
| \(\mathsf{XTB}\) | Coeficiente de temperatura beta directo e inverso\((X_{TB})\) | \(0.0\) | |
| \(\mathsf{XTF}\) | Coeficiente de dependencia de sesgo de tránsito\((X_{TF})\) | \(0.0\) | |
| \(\mathsf{XTI}\) | \(\mathsf{IS}\)exponente del efecto de la temperatura\((X_{TI})\) | \(3.0\) |
Tabla\(\PageIndex{5}\): Parámetros del modelo Gummel—Poon BJT
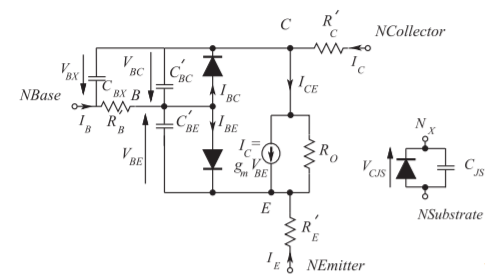
Figura\(\PageIndex{5}\): Esquema del modelo BJT.
Cálculos estándar
Las constantes físicas utilizadas en la evaluación del modelo son
| \(k\) | la constante de Boltzmann | \(1.3806226\: 10^{−23}\text{ J/K}\) |
|---|---|---|
| \(q\) | carga electrónica | \(1.6021918\: 10^{−19}\text{ C}\) |
Mesa\(\PageIndex{6}\)
Se utilizan temperaturas absolutas (en kelvin,\(\text{K}\)). El voltaje térmico es
\[\label{eq:51}V_{\text{TH}}(T_{\text{NOM}})=kT_{\text{NOM}}/q \]
Características actuales:
La corriente base-emisor es
\[\label{eq:52}I_{BE}=I_{BF}/\beta_{F}+I_{LE} \]
la corriente de colector base es
\[\label{eq:53}I_{BC}=I_{BR}/\beta_{R}+I_{LC} \]
La corriente colector-emisor es
\[\label{eq:54}I_{CE}=I_{BF}-I_{BR}/K_{QB} \]
donde está la corriente de difusión directa
\[\label{eq:55}I_{BF}=I_{S}\left(\text{e}^{V_{BE}/(N_{F}V_{\text{TH}})}-1\right) \]
La corriente emisor-base no ideal es
\[\label{eq:56}I_{LE}=I_{SE}\left(\text{e}^{V_{BE}/(N_{E}V_{\text{TH}})}-1\right) \]
La corriente de difusión inversa es
\[\label{eq:57}I_{BR}=I_{S}\left(\text{e}^{V_{BC}/(N_{R}V_{\text{TH}})}-1\right) \]
La corriente de colector base no ideal es
\[\label{eq:58}I_{LC}=I_{SC}\left(\text{e}^{V_{BC}/(N_{C}V_{\text{TH}})}-1\right) \]
El factor de carga base es
\[\label{eq:59}K_{QB}=1/2[1-V_{BC}/V_{AF}-V_{BE}/V_{AB}]^{-1}\left(1+\sqrt{1+4(I_{BF}/I_{KF}+I_{BR}/I_{KR})}\right) \]
Por lo tanto, la corriente conductora que fluye hacia la base es
\[\label{eq:60}I_{B}=I_{BE}+I_{BC} \]
la corriente conductora que fluye hacia el colector es
\[\label{eq:61}I_{C}=I_{CE}-I_{BC} \]
y la corriente conductora que fluye hacia el emisor es
\[\label{eq:62}I_{E}=I_{BE}+I_{CE} \]
Capacitancias
\(C_{BE} = \text{Area}(C_{BE\tau} + C_{BEJ})\), donde el tiempo de tránsito del emisor base o la capacitancia de difusión es
\[\label{eq:63}C_{BE\tau}=\tau_{F,\text{ EFF}}(\partial I_{BF}/\partial V_{BE}) \]
y el tiempo de tránsito base efectivo se modifica empíricamente para tener en cuenta el punchout base, el flujo de corriente limitado de carga espacial, la cuasisaturación y la dispersión lateral, que tienden a aumentar\(\tau_{\text{F}}\):
\[\label{eq:64}\tau_{F,\text{ EFF}}=\tau_{F}\left[1+X_{TF}(3x^{2}-2x^{3})\text{e}^{(V_{BC}/(1.44V_{TF})}\right] \]
y\(x = I_{BF}/(I_{BF} + \text{Area}I_{TF})\).
La capacitancia de la unión base-emisor (agotamiento) es
\[\label{eq:65}C_{BEJ}=\left\{\begin{array}{ll}{C_{JE}(1-V_{BE}/V_{JE})^{-M_{JE}}}&{V_{BE}\leq F_{C}V_{JE}}\\{C_{JE}(1-F_{C})^{-(1+M_{JE})}(1-F_{C}(1+M_{JE})+M_{JE}V_{BE}/V_{JE})}&{V_{BE}>F_{C}V_{JE}}\end{array}\right. \]
La capacitancia base-colector es\(C_{BC} = \text{Area}(C_{BC\tau} + X_{CJC}C_{BCJ})\), donde está el tiempo de tránsito de base-colector o la capacitancia de difusión
\[\label{eq:66}C_{BC\tau}=\tau_{R}\partial I_{BR}/\partial V_{BC} \]
La capacitancia de la unión base-colector (agotamiento) es
\[\label{eq:67}C_{BCJ}=\left\{\begin{array}{ll}{C_{JC}(1-V_{BC}/V_{JC})^{-M_{JC}}}&{V_{BC}\leq F_{C}V_{JC}}\\{C_{JC}(1-F_{C})^{-(1+M_{JC})}(1-F_{C}(1+M_{JC})+M_{JC}V_{BC}/V_{JC})}&{V_{BC}>F_{C}V_{JC}}\end{array}\right. \]
La capacitancia entre la base extrínseca y el colector intrínseco es
\[\label{eq:68}C_{BX}=\left\{\begin{array}{ll}{\text{Area}(1-X_{CJC})C_{JC}(1-V_{BX}/V_{JC})^{-M_{JC}}}&{V_{BX}\leq F_{C}V_{JC}}\\{(1-X_{CJC})C_{JC}(1-F_{C})^{-(1+M_{JC})}\times (1-F_{C}(1+M_{JC})+M_{JC}V_{BX}/V_{JX})}&{V_{BX}>F_{C}V_{JC}}\end{array}\right. \]
La capacitancia de la unión del sustrato es
\[\label{eq:69}C_{JS}=\left\{\begin{array}{ll}{\text{Area}C_{JS}(1-V_{CJS}/V_{JS})^{-M_{JS}}}&{V_{CJS}\leq 0}\\{\text{Area}C_{JS}(1+M_{JS}V_{CJS}/V_{JS})}&{V_{CJS}>0}\end{array}\right. \]


