4.7: Creación de Pozo y Puerta de Circuito Integrado
- Page ID
- 86495
Luego eliminamos la resistencia restante, y realizamos una etapa de activación/recocimiento/difusión, también a veces llamada “drive-in”. El propósito de este paso es doble. Queremos hacer que el tanque n sea lo suficientemente profundo para que podamos usarlo para nuestro MOS de canal p, y queremos construir una barrera de implante para que podamos implantarlo solo en la región del sustrato p. Introducimos oxígeno en el reactor durante la activación, de manera que cultivamos un óxido más grueso sobre la región donde implantamos el fósforo. La capa de nitruro sobre el sustrato p en el LHS protege esa área de cualquier crecimiento de óxido. Luego terminamos con la estructura que se muestra en la Figura\(\PageIndex{1}\).
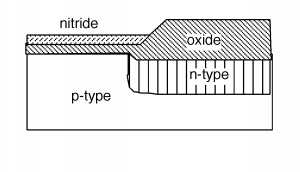
Figura\(\PageIndex{1}\): Después del recocido/Drive-In

Ahora despojamos el nitruro restante. Dado que la única manera de convertir de p a n es agregar una concentración de donante que sea mayor que la concentración de aceptor de fondo, tuvimos que mantener el dopaje en el sustrato bastante ligero para poder hacer el tanque n. El sustrato p ligeramente dopado tendría un voltaje umbral demasiado bajo para un buen funcionamiento del transistor N-mos, por lo que haremos un implante de\(V_{T}\) ajuste a través del óxido delgado del lado izquierdo, con el óxido grueso en el lado derecho bloqueando el boro para que no ingrese al tanque n. Esto se muestra en la Figura\(\PageIndex{2}\), donde el boro se implanta en el sustrato tipo p en el lado izquierdo, pero es bloqueado por el óxido grueso en la región sobre el pozo n.
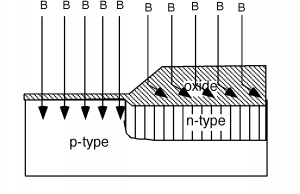
Figura\(\PageIndex{2}\):\(V_{T}\) ajustar implante

A continuación, despojamos todo el óxido y crecemos una nueva capa delgada de óxido, y luego una capa de nitruro (Figura\(\PageIndex{3}\)). La capa de óxido se cultiva solo porque es malo crecer\(\mathrm{Si}_{3} \mathrm{N}_{4}\) directamente sobre el silicio, ya que los diferentes coeficientes de expansión térmica entre los dos materiales provocan daños en la estructura cristalina de silicio. Además, resulta casi imposible eliminar el nitruro si se deposita directamente sobre el silicio.
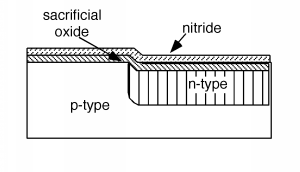
Figura\(\PageIndex{3}\): Tirar óxido, crecer nuevo nitruro

El nitruro se modela (cubierto con fotorresistente, expuesto, revelado, grabado y limpiado de fotorresistente) para hacer dos áreas que se denominan “activas” (Figura\(\PageIndex{4}\)). (Aquí es donde vamos a construir nuestros transistores.) Luego, la oblea se somete a una etapa de oxidación a alta presión que crece un óxido espeso dondequiera que se elimine el nitruro. El nitruro es una buena barrera para el oxígeno, por lo que esencialmente ningún óxido crece debajo de él. El óxido grueso se utiliza para aislar transistores individuales, y también para hacer una capa aislante sobre la cual se pueden ejecutar patrones conductores. El óxido grueso se denomina óxido de campo (o FOX para abreviar), como se muestra en la Figura\(\PageIndex{5}\).
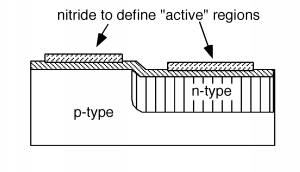
Figura\(\PageIndex{4}\): Capa de nitruro después del grabado

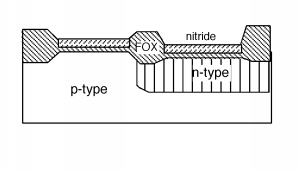
Figura\(\PageIndex{5}\): Óxido de campo en crecimiento

Después, se decapan el nitruro y parte del óxido. El óxido se graba lo suficiente como para que se elimine todo el óxido debajo de las regiones de nitruro, lo que también quitará un poco del óxido de campo. Esto se debe a que ahora queremos cultivar el óxido de puerta, que debe ser muy limpio y puro (Figura\(\PageIndex{6}\). El óxido bajo el nitruro a veces se llama óxido de sacrificio, porque se sacrifica en nombre de ultra rendimiento.
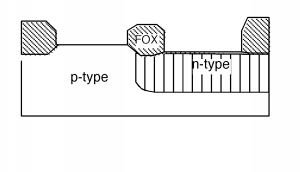 Figura\(\PageIndex{6}\): Preparándose para cultivar óxido de puerta
Figura\(\PageIndex{6}\): Preparándose para cultivar óxido de puerta

Luego se cultiva el óxido de puerta, e inmediatamente después, toda la oblea se cubre con polisilicio (Figura\(\PageIndex{7}\)).
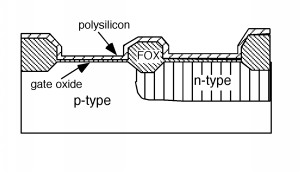
Figura\(\PageIndex{7}\): Poli deposición sobre óxido de puerta

El polisilicio es luego modelado para formar las dos regiones que serán nuestras puertas. La oblea se cubre una vez más con fotorresistente. El protector se elimina sobre la región que será el dispositivo de canal n, pero se deja cubriendo el dispositivo de canal p. También se descubre una pequeña área cerca del borde del tanque n (Figura\(\PageIndex{8}\)). Esto nos permitirá agregar algo de fósforo adicional en el pozo n, para que podamos hacer un contacto allí, para que se pueda conectar el pozo n\(V_{\text{dd}}\).
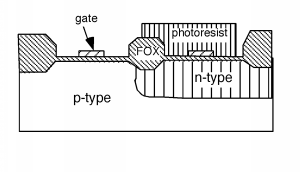
Figura\(\PageIndex{8}\): Preparación para implante de canal/drenaje NMOS

De vuelta al implantador vamos, esta vez exponiendo la oblea al fósforo. La puerta de poli, el FOX y el fotorresistente bloquean la entrada de fósforo en la oblea, por lo que hacemos dos regiones de tipo n en el sustrato tipo p, y hemos hecho nuestras regiones de fuente/drenaje MOS de canal n. También agregamos fósforo a la región de\(V_{\text{dd}}\) contacto en el pozo n para asegurarnos de que obtengamos un buen rendimiento de contacto allí (Figura\(\PageIndex{9}\)).
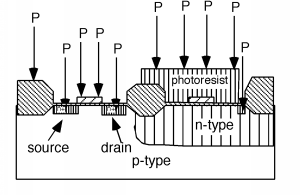
Figura\(\PageIndex{9}\): Implante de fuente/drenaje de fósforo

Obsérvese que la formación de la fuente y el drenaje se realizaron con una tecnología autoalineable y. Esto significa que usamos la propia estructura de la puerta para definir dónde estarían los dos bordes interiores de la fuente y el drenaje para el MOSFET. Si hubiéramos hecho las regiones de fuente/drenaje antes de definir la puerta, y luego intentamos alinear la puerta justo sobre el espacio entre ellas, podríamos haber obtenido algo que se parece a lo que se muestra en la Figura\(\PageIndex{10}\).

¿Cuál va a ser el problema con este transistor? Obviamente, si la puerta no se extiende hasta la fuente y el drenaje, entonces el canal tampoco lo hará, ¡y el transistor nunca se encenderá! Podríamos intentar hacer que la puerta sea más ancha, para asegurarnos de que se superpondrá ambas áreas activas, aunque esté ligeramente desalineada, pero luego se obtiene mucha capacitancia de franja extraña que ralentizará significativamente la velocidad de operación del transistor (Figura\(\PageIndex{11}\)). ¡Esto es malo! El desarrollo de la técnica de la puerta autoalineada fue uno de los grandes avances que nos ha impulsado a la era VLSI y ULSI.

Sacamos la oblea del implantador y quitamos el fotorresistente. Esto a veces es difícil, porque el acto de implantación de iones puede “hornear” el fotorresistente en una película muy dura. A veces se usa una descarga de rf en una\(\mathrm{O}_{2}\) atmósfera para “cenizas” el fotorresistente, ¡y literalmente quemarlo de la oblea! Ahora aplicamos un poco más de PR, y esta vez patrón para tener el área del foso, y un contacto de sustrato expuesto, para un implante de boro p+. Esto se muestra en la Figura\(\PageIndex{12}\).
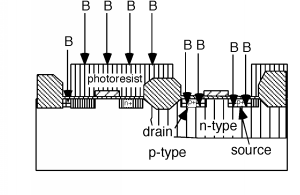
Figura\(\PageIndex{12}\): Implante S/D de canal P de boro

Ya casi terminamos. Lo siguiente que hacemos es eliminar todo el fotorresistente, y cultivar una capa más de óxido, que lo cubre todo, como se muestra en la Figura\(\PageIndex{13}\). Volvemos a poner fotorresistente sobre toda la oblea, y patrón para que los orificios de contacto pasen por el óxido. Pondremos contactos para los dos desagües, y para cada una de las fuentes, nos aseguraremos de que los agujeros sean lo suficientemente grandes como para permitirnos también conectar el contacto de la fuente al sustrato p o al foso n según sea apropiado (Figura\(\PageIndex{14}\)).
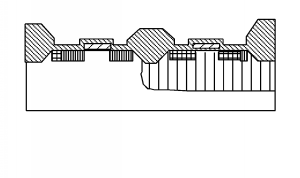
Figura\(\PageIndex{13}\): Crecimiento final de óxido

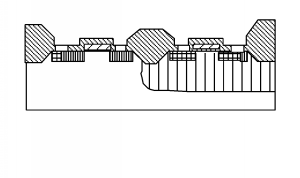
Figura\(\PageIndex{14}\): Agujeros de contacto grabados



