4.6: Fotolitografía
- Page ID
- 86520
\( \newcommand{\vecs}[1]{\overset { \scriptstyle \rightharpoonup} {\mathbf{#1}} } \)
\( \newcommand{\vecd}[1]{\overset{-\!-\!\rightharpoonup}{\vphantom{a}\smash {#1}}} \)
\( \newcommand{\dsum}{\displaystyle\sum\limits} \)
\( \newcommand{\dint}{\displaystyle\int\limits} \)
\( \newcommand{\dlim}{\displaystyle\lim\limits} \)
\( \newcommand{\id}{\mathrm{id}}\) \( \newcommand{\Span}{\mathrm{span}}\)
( \newcommand{\kernel}{\mathrm{null}\,}\) \( \newcommand{\range}{\mathrm{range}\,}\)
\( \newcommand{\RealPart}{\mathrm{Re}}\) \( \newcommand{\ImaginaryPart}{\mathrm{Im}}\)
\( \newcommand{\Argument}{\mathrm{Arg}}\) \( \newcommand{\norm}[1]{\| #1 \|}\)
\( \newcommand{\inner}[2]{\langle #1, #2 \rangle}\)
\( \newcommand{\Span}{\mathrm{span}}\)
\( \newcommand{\id}{\mathrm{id}}\)
\( \newcommand{\Span}{\mathrm{span}}\)
\( \newcommand{\kernel}{\mathrm{null}\,}\)
\( \newcommand{\range}{\mathrm{range}\,}\)
\( \newcommand{\RealPart}{\mathrm{Re}}\)
\( \newcommand{\ImaginaryPart}{\mathrm{Im}}\)
\( \newcommand{\Argument}{\mathrm{Arg}}\)
\( \newcommand{\norm}[1]{\| #1 \|}\)
\( \newcommand{\inner}[2]{\langle #1, #2 \rangle}\)
\( \newcommand{\Span}{\mathrm{span}}\) \( \newcommand{\AA}{\unicode[.8,0]{x212B}}\)
\( \newcommand{\vectorA}[1]{\vec{#1}} % arrow\)
\( \newcommand{\vectorAt}[1]{\vec{\text{#1}}} % arrow\)
\( \newcommand{\vectorB}[1]{\overset { \scriptstyle \rightharpoonup} {\mathbf{#1}} } \)
\( \newcommand{\vectorC}[1]{\textbf{#1}} \)
\( \newcommand{\vectorD}[1]{\overrightarrow{#1}} \)
\( \newcommand{\vectorDt}[1]{\overrightarrow{\text{#1}}} \)
\( \newcommand{\vectE}[1]{\overset{-\!-\!\rightharpoonup}{\vphantom{a}\smash{\mathbf {#1}}}} \)
\( \newcommand{\vecs}[1]{\overset { \scriptstyle \rightharpoonup} {\mathbf{#1}} } \)
\(\newcommand{\longvect}{\overrightarrow}\)
\( \newcommand{\vecd}[1]{\overset{-\!-\!\rightharpoonup}{\vphantom{a}\smash {#1}}} \)
\(\newcommand{\avec}{\mathbf a}\) \(\newcommand{\bvec}{\mathbf b}\) \(\newcommand{\cvec}{\mathbf c}\) \(\newcommand{\dvec}{\mathbf d}\) \(\newcommand{\dtil}{\widetilde{\mathbf d}}\) \(\newcommand{\evec}{\mathbf e}\) \(\newcommand{\fvec}{\mathbf f}\) \(\newcommand{\nvec}{\mathbf n}\) \(\newcommand{\pvec}{\mathbf p}\) \(\newcommand{\qvec}{\mathbf q}\) \(\newcommand{\svec}{\mathbf s}\) \(\newcommand{\tvec}{\mathbf t}\) \(\newcommand{\uvec}{\mathbf u}\) \(\newcommand{\vvec}{\mathbf v}\) \(\newcommand{\wvec}{\mathbf w}\) \(\newcommand{\xvec}{\mathbf x}\) \(\newcommand{\yvec}{\mathbf y}\) \(\newcommand{\zvec}{\mathbf z}\) \(\newcommand{\rvec}{\mathbf r}\) \(\newcommand{\mvec}{\mathbf m}\) \(\newcommand{\zerovec}{\mathbf 0}\) \(\newcommand{\onevec}{\mathbf 1}\) \(\newcommand{\real}{\mathbb R}\) \(\newcommand{\twovec}[2]{\left[\begin{array}{r}#1 \\ #2 \end{array}\right]}\) \(\newcommand{\ctwovec}[2]{\left[\begin{array}{c}#1 \\ #2 \end{array}\right]}\) \(\newcommand{\threevec}[3]{\left[\begin{array}{r}#1 \\ #2 \\ #3 \end{array}\right]}\) \(\newcommand{\cthreevec}[3]{\left[\begin{array}{c}#1 \\ #2 \\ #3 \end{array}\right]}\) \(\newcommand{\fourvec}[4]{\left[\begin{array}{r}#1 \\ #2 \\ #3 \\ #4 \end{array}\right]}\) \(\newcommand{\cfourvec}[4]{\left[\begin{array}{c}#1 \\ #2 \\ #3 \\ #4 \end{array}\right]}\) \(\newcommand{\fivevec}[5]{\left[\begin{array}{r}#1 \\ #2 \\ #3 \\ #4 \\ #5 \\ \end{array}\right]}\) \(\newcommand{\cfivevec}[5]{\left[\begin{array}{c}#1 \\ #2 \\ #3 \\ #4 \\ #5 \\ \end{array}\right]}\) \(\newcommand{\mattwo}[4]{\left[\begin{array}{rr}#1 \amp #2 \\ #3 \amp #4 \\ \end{array}\right]}\) \(\newcommand{\laspan}[1]{\text{Span}\{#1\}}\) \(\newcommand{\bcal}{\cal B}\) \(\newcommand{\ccal}{\cal C}\) \(\newcommand{\scal}{\cal S}\) \(\newcommand{\wcal}{\cal W}\) \(\newcommand{\ecal}{\cal E}\) \(\newcommand{\coords}[2]{\left\{#1\right\}_{#2}}\) \(\newcommand{\gray}[1]{\color{gray}{#1}}\) \(\newcommand{\lgray}[1]{\color{lightgray}{#1}}\) \(\newcommand{\rank}{\operatorname{rank}}\) \(\newcommand{\row}{\text{Row}}\) \(\newcommand{\col}{\text{Col}}\) \(\renewcommand{\row}{\text{Row}}\) \(\newcommand{\nul}{\text{Nul}}\) \(\newcommand{\var}{\text{Var}}\) \(\newcommand{\corr}{\text{corr}}\) \(\newcommand{\len}[1]{\left|#1\right|}\) \(\newcommand{\bbar}{\overline{\bvec}}\) \(\newcommand{\bhat}{\widehat{\bvec}}\) \(\newcommand{\bperp}{\bvec^\perp}\) \(\newcommand{\xhat}{\widehat{\xvec}}\) \(\newcommand{\vhat}{\widehat{\vvec}}\) \(\newcommand{\uhat}{\widehat{\uvec}}\) \(\newcommand{\what}{\widehat{\wvec}}\) \(\newcommand{\Sighat}{\widehat{\Sigma}}\) \(\newcommand{\lt}{<}\) \(\newcommand{\gt}{>}\) \(\newcommand{\amp}{&}\) \(\definecolor{fillinmathshade}{gray}{0.9}\)En realidad, los implantes (especialmente para fosos) generalmente se realizan a una energía suficientemente alta para que el dopante (fósforo) ya esté bastante lejos en el sustrato (a menudo varias micras más o menos), incluso antes de que comience la difusión. El recocido/difusión mueve las impurezas hacia la oblea un poco más, y como veremos también hace que la región n crezca más grande.
¡“La n-región”! No hemos dicho nada sobre cómo hacemos nuestro foso solo en ciertas zonas de la oblea. De la descripción que tenemos hasta ahora, parece que simplemente hemos construido una capa tipo n sobre toda la superficie de la oblea. ¡Esto estaría mal! Tenemos que llegar a algún tipo de “ventana” para permitir únicamente que las impurezas implantadoras entren en la oblea de silicio donde las queremos y no en otra parte. Esto lo haremos construyendo una “barrera” de implantación.
Para ello, lo primero que hacemos es cultivar una capa de dióxido de silicio sobre toda la superficie de la oblea. Hablamos del crecimiento del óxido cuando estábamos discutiendo MOSFET, pero entremos un poco más de detalle. Se puede cultivar óxido ya sea en una atmósfera de oxígeno seco, o en una atmósfera que contenga vapor de agua, o vapor. En la Figura\(\PageIndex{1}\), se muestra el espesor del óxido en función del tiempo de crecimiento con vapor. Secar\(O_{2}\) no se comporta de manera demasiado diferente; la tasa es sólo algo más lenta.

Figura\(\PageIndex{1}\): Grosor del óxido en función del tiempo

Encima del óxido, ahora vamos a depositar otro material más. Se trata de nitruro de silicio\(\mathrm{Si}_{3} \mathrm{N}_{4}\), generalmente llamado simplemente "nitruro” simple. El nitruro de silicio se deposita a través de un método llamado deposición química de vapor o “CVD”. La técnica habitual es hacer reaccionar diclorosilano y amoníaco en un sistema de deposición química de vapor a baja presión (LPCVD) de pared caliente. La reacción es:\[3 \left(\mathrm{Si}, \mathrm{H}_{2}, \mathrm{Cl}_{2}\right) + 10 \left(\mathrm{N}, \mathrm{H}_{3}\right) \rightarrow \mathrm{Si}_{3} \left(\mathrm{N}_{4}\right) + 6 \left(\mathrm{N}, \mathrm{H}_{4}, \mathrm{Cl}\right) + 6 \left(\mathrm{H}_{2}\right)\]
El nitruro de silicio es una buena barrera para impurezas, oxígeno y otras cosas que no queremos meter en la oblea. Echa un vistazo a Figura\(\PageIndex{2}\) y vea lo que tenemos hasta el momento. Una palabra sobre escala y dimensiones. La oblea de silicio es aproximadamente\(250 \ \mu\mathrm{m}\) gruesa (aproximadamente 0.01"), ya que tiene que ser lo suficientemente fuerte como para no romperse mientras se está manejando. Las dos capas depositadas son cada una aproximadamente\(1 \ \mu\mathrm{m}\) gruesas, por lo que en realidad deben dibujarse como líneas más delgadas que las otras líneas de la figura. Esto obviamente haría ridícula toda la idea de un boceto, por lo que dejaremos las cosas distorsionadas tal como están, teniendo en cuenta que las capas depositadas y difundidas son en realidad mucho más delgadas que el resto de la oblea, que realmente no hace nada más que soportar los circuitos activos arriba. (Ahí vamos otra vez, desperdiciando silicio. Lo bueno es barato y abundante!)

Figura\(\PageIndex{2}\): Configuración inicial de la oblea

Ahora lo que queremos hacer es eliminar parte del nitruro, para que podamos hacer nuestro n-pozo, pero no poner en fósforo donde no lo queremos. Esto lo hacemos con procesos llamados fotolitografía y aguafuerte, respectivamente. Lo primero que hacemos es recubrir la oblea con otra capa más de material. Este es un líquido llamado fotorresistente y se aplica a través de un proceso llamado recubrimiento por giro. La oblea se coloca en un mandril de vacío y se pulveriza una capa de fotorresistente líquido sobre la oblea. El mandril se hace girar rápidamente, llegando a varios miles de RPM en una pequeña fracción de segundo. La fuerza centrífuga hace que la resistencia se extienda uniformemente a través de la superficie de la oblea (¡la mayor parte, de hecho, vuela!). El disolvente para el fotorresistente es bastante volátil y por lo tanto la capa de fotorresistente se seca mientras la oblea aún está girando, dando como resultado un recubrimiento delgado y uniforme a través de la oblea como se muestra en la Figura\(\PageIndex{3}\).

Figura\(\PageIndex{3}\): La fotorresistencia es girada

El nombre “fotorresist” da alguna pista de lo que son estas cosas. Básicamente, el fotorresistente es un polímero mezclado con algún tipo de compuesto sensibilizante a la luz. En fotorresistente positivo, dondequiera que la luz lo golpee, el polímero se debilita y se puede eliminar más fácilmente con un solvente durante el proceso de desarrollo. Por el contrario, el fotorresistente negativo se fortalece cuando se ilumina con luz, y es más resistente al solvente que el fotorresistente no iluminado. La resistencia positiva se llama porque la imagen del fotorresistente desarrollado sobre la oblea se ve igual que la máscara que se utilizó para crearla. El fotorresistente negativo hace una imagen que es lo contrario de lo que parece la máscara.
Tenemos que idear alguna manera de iluminar selectivamente ciertas porciones del fotorresistente. Cualquiera que haya visto alguna vez un proyector sabe cómo podemos hacer esto. Pero, como queremos hacer cosas pequeñas, no grandes, cambiaremos alrededor de nuestro proyector para que haga una imagen más pequeña, en lugar de una más grande. El instrumento que proyecta la luz sobre el fotorresistente en la oblea se llama impresora de proyección o paso a paso (Figura\(\PageIndex{4}\)).
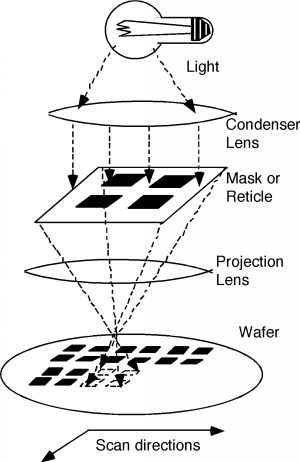
Figura\(\PageIndex{4}\): Una configuración paso a paso

Como se muestra en la Figura\(\PageIndex{4}\), el paso a paso consta de varias partes. Hay una fuente de luz (generalmente una lámpara de vapor de mercurio, aunque también están comenzando a usarse láseres excimer ultravioletas), y una lente condensadora para obtener imágenes de la fuente de luz en la máscara o retícula. La máscara contiene una imagen del patrón que estamos tratando de colocar sobre la oblea. La lente de proyección luego hace una imagen reducida (generalmente en 5x) de la máscara en la oblea. Debido a que sería demasiado costoso, si no simplemente imposible, proyectar sobre toda la oblea a la vez, solo se imprime una pequeña área seleccionada a la vez. Luego la oblea se escanea o se escalona en una nueva posición, y la imagen se vuelve a imprimir. Si ya se han formado patrones anteriores en la oblea, se utilizan cámaras de TV con algoritmos de inteligencia artificial para alinear la imagen actual con las características previamente formadas. El paso a paso mueve toda la superficie de la oblea debajo de la lente, hasta que la oblea esté completamente cubierta con el patrón deseado. Un paso a paso no es barato. Por lo general, ¡TI o Intel bifurcarán más de varios millones de dólares por cada uno! Es una de las piezas de equipo más importantes en toda la fab IC, sin embargo, ya que determina cuál será el tamaño mínimo de característica en el circuito.
Después de la exposición, el fotorresistente se coloca en un disolvente adecuado, y se “desarrolla”. Supongamos para nuestro ejemplo que la estructura mostrada en la Figura\(\PageIndex{5}\) es la que resulta del paso fotolitográfico.

Figura\(\PageIndex{5}\): Después de la exposición/desarrollo de relaciones públicas

El patrón que se utilizó en la etapa fotolitográfica (PL) expuso la mitad de nuestra área a la luz, por lo que el fotorresistente (PR) en esa región se eliminó al desarrollarse. La oblea ahora se sumerge en una solución de ácido fluorhídrico (HF). El ácido HF graba el nitruro de silicio con bastante rapidez, pero no graba el dióxido de silicio casi tan rápido, por lo que después del grabado tenemos lo que vemos en la Figura\(\PageIndex{6}\).

Figura\(\PageIndex{6}\): Después del grabado con nitruro

Ahora tomamos nuestra oblea, la ponemos en el implantador de iones y la sometemos a una “explosión” de iones de fósforo (ver Figura\(\PageIndex{7}\)).
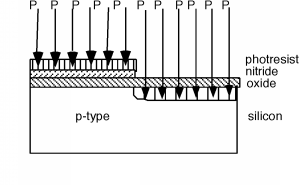
Figura\(\PageIndex{7}\): Implantación de Fósforo

Los iones pasan directamente a través de la capa de óxido en el lado derecho, pero se adhieren en la capa fotorresist/nitruro en la mitad izquierda de nuestra estructura.


