8.2: Microscopía Electrónica de Transmisión
- Page ID
- 71287
TEM: Una visión general
La microscopía electrónica de transmisión (TEM) es una forma de microscopía en la que un haz de electrones transmite a través de un espécimen extremadamente delgado, y luego interactúa con el espécimen al pasar por él. La formación de imágenes en un TEM puede explicarse mediante un diagrama de haz de electrones óptico en la Figura\(\PageIndex{1}\). Los TEM proporcionan imágenes con una resolución significativamente mayor que los microscopios de luz visible (VLM) debido a la menor longitud de onda de Broglie de los electrones. Estos electrones permiten el examen de detalles más finos, que son varios miles de veces superiores a la resolución más alta en un VLM. Sin embargo, la ampliación proporcionada en una imagen TEM contrasta con la absorción de los electrones en el material, que se debe principalmente al grosor o composición del material.

Cuando se investiga un espaciado de red cristalina (d) con electrones con longitud de onda λ, se formarán ondas difractadas en ángulos específicos 2θ, satisfaciendo la condición de Bragg,\ ref {1}.
\[ 2dsin\theta \ =\ \lambda \label{1} \]
Se puede observar la disposición regular de los puntos de difracción, el llamado patrón de difracción (DP). Mientras los haces transmitidos y difractados interfieren en el plano de la imagen, aparece una imagen ampliada (imagen de microscopio electrónico). El plano donde se forma el DP se llama el espacio recíproco, que el plano de la imagen se llama el espacio real. Una transformada de Fourier puede transformar matemáticamente el espacio real en espacio recíproco.
Al ajustar las lentes (cambiando sus distancias focales), se pueden observar imágenes de microscopio electrónico y DP. Así, ambos modos de observación se pueden combinar con éxito en el análisis de las microestructuras de los materiales. Por ejemplo, durante la investigación de DP, se observa una imagen de microscopio electrónico. Después, insertando una abertura (apertura de área seleccionada), ajustando las lentes, y enfocándonos en un área específica que nos interese, obtendremos un DP del área. Este tipo de modo de observación se denomina difracción de área seleccionada. Para investigar una imagen de microscopio electrónico, primero observamos el DP. Luego, al pasar el haz transmitido o uno de los haces difractados a través de una abertura seleccionada y cambiando al modo de imagen, podemos obtener la imagen con contraste mejorado, y los precipitados y defectos de celosía se pueden identificar fácilmente.
Describiendo la resolución de un TEM en términos del criterio clásico de Rayleigh para VLMs, que establece que la distancia más pequeña que se puede investigar, δ, viene dada aproximadamente por\ ref {2}, donde λ es la longitud de onda de los electrones, µ es el índice de refracción del medio de visión, y β es el semi-ángulo de colección de la lupa.
\[ \delta \ = \frac{0.61 \lambda }{\mu \ sin \beta} \label{2} \]
de acuerdo con las ideas de Broglie sobre la dualidad onda-partícula, el impulso de partícula p está relacionado con su longitud de onda λ a través de la constante h de Planck,\ ref {3}.
\[ \lambda = \frac{h}{p} \label{3} \]
Se le da impulso al electrón acelerándolo a través de una caída potencial, V, dándole una energía cinética, eV. Esta energía potencial es igual a la energía cinética del electrón,\ ref {4}.
\ [eV\ =\\ frac {m_ {o} u ^ {2}} {2}\ etiqueta {4}\]
Con base en lo anterior, podemos equiparar el momento (p) a la masa electrónica (mo), multiplicado por la velocidad (v) y sustituyendo por v de\ ref {5} es decir,\ ref {6}.
\ [p\ =\ m_ {o} u\ =\ (2m_ {o} eV) ^ {\ frac {1} {2}}\ etiqueta {5}\]
Estas ecuaciones definen la relación entre la longitud de onda del electrón, λ, y el voltaje de aceleración del microscopio electrónico (V), la Ec. Sin embargo, tenemos que considerar acerca de los efectos relativos cuando la energía del electrón supera los 100 keV. Entonces para ser exactos debemos modificar\ ref {6} para dar\ ref {7}.
\[ \lambda \ =\frac{h}{(2m_{o}eV)^{\frac{1}{2}} } \label{6} \]
\[ \lambda \ =\frac{h}{[2m_{o}eV(1\ +\ \frac{eV}{2m_{o}e^{2}})]^{\frac{1}{2}}} \label{7} \]
A partir de\ ref {2} y\ ref {3}, si se desea una resolución más alta, se logra una disminución en la longitud de onda del electrón aumentando el voltaje de aceleración del microscopio electrónico. En otras palabras, a mayor calificación de aceleración utilizada, mejor resolución se obtiene.
Por qué el espécimen debe ser delgado
La dispersión del haz de electrones a través del material en estudio puede formar una distribución angular diferente (Figura\(\PageIndex{2}\)) y puede ser dispersión directa o retrodispersión. Si un electrón se dispersa < 90o, entonces se dispersa hacia adelante, de lo contrario, se retrodispersa. Si el espécimen es más grueso, menos electrones se dispersan hacia adelante y más se retrodispersan. Los electrones incoherentes y retrodispersos son los únicos restos del haz incidente para especímenes masivos y no transparentes. La razón por la que los electrones pueden dispersarse a través de diferentes ángulos está relacionada con el hecho de que un electrón se puede dispersar más de una vez. Generalmente, cuantos más tiempos de dispersión ocurren, mayor es el ángulo de dispersión.

Toda dispersión en el espécimen TEM a menudo se aproxima como un solo evento de dispersión, ya que es el proceso más simple. Si el espécimen es muy delgado, esta suposición será lo suficientemente razonable. Si el electrón se dispersa más de una vez, se le llama 'dispersión plural'. Generalmente es seguro asumir que se produce una dispersión única, a menos que el espécimen sea particularmente grueso. Cuando aumentan los tiempos de dispersión, es difícil predecir qué pasará con el electrón e interpretar las imágenes y DP. Entonces, el principio es 'más delgado es mejor', es decir, si hacemos especímenes lo suficientemente delgados para que la suposición de dispersión única sea plausible, y la investigación TEM será mucho más fácil.
De hecho, la dispersión directa incluye el haz directo, la dispersión más elástica, la refracción, la difracción, particularmente la difracción de Bragg y la dispersión inelástica. Debido a la dispersión directa a través del espécimen delgado, se mostraría un DP o una imagen en la pantalla de visualización, y se puede detectar un espectro de rayos X o un espectro de pérdida de energía de electrones fuera de la columna TEM. Sin embargo, la retrodispersión aún no se puede ignorar, es un modo imaginario importante en el SEM.
Limitaciones de TEM
Interpretación de imágenes de transmisión
Un problema significativo que podría surgir cuando se analizan imágenes TEM es que el TEM nos presenta imágenes 2D de un espécimen 3D, visto en transmisión. Este problema se puede ilustrar mostrando una imagen de dos rinocerontes uno al lado del otro de tal manera que la cabeza de uno aparece unida a la parte trasera del otro (Figura\(\PageIndex{3}\)).

Un aspecto de este inconveniente particular es que una sola imagen TEM no tiene sensibilidad de profundidad. A menudo hay información sobre las superficies superior e inferior del espécimen, pero esto no es inmediatamente evidente. Se ha avanzado en la superación de esta limitación, por el desarrollo de la tomografía electrónica, que utiliza una secuencia de imágenes tomadas en diferentes ángulos. Además, ha habido mejoras en el diseño de portamuestras para permitir una rotación completa de 360o y, en combinación con un fácil almacenamiento y manipulación de datos; los nanotecnólogos han comenzado a usar esta técnica para observar estructuras inorgánicas 3D complejas como materiales porosos que contienen partículas de catalizador.
Daño por haz de electrones
Un efecto perjudicial de la radiación ionizante es que puede dañar el espécimen, particularmente los polímeros (y la mayoría de los orgánicos) o ciertos minerales y cerámicas. Algunos aspectos del daño del haz empeoraron a tensiones más altas. La figura\(\PageIndex{4}\) muestra un área de un espécimen dañado por electrones de alta energía. Sin embargo, la combinación de fuentes de electrones más intensas con detectores de electrones más sensibles, y el uso de la mejora por computadora de imágenes ruidosas, se puede utilizar para minimizar la energía total recibida por la muestra.
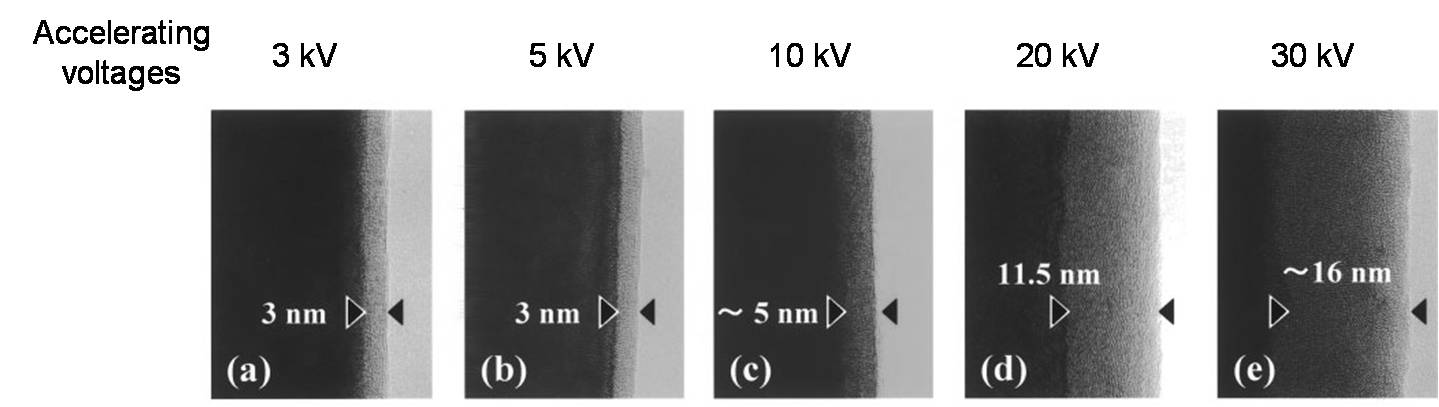
Preparación de Muestras
Los especímenes en estudio tienen que ser delgados si se va a obtener alguna información utilizando electrones transmitidos en el TEM. Para que una muestra sea transparente a los electrones, la muestra debe ser lo suficientemente delgada como para transmitir suficientes electrones de tal manera que caiga suficiente intensidad en la pantalla para dar una imagen. Esto es una función de la energía electrónica y del número atómico promedio de los elementos en la muestra. Típicamente para electrones de 100 keV, una muestra de aleación de aluminio de hasta ~ 1 µm sería delgada, mientras que el acero sería delgado hasta aproximadamente varios cientos de nanómetros. Sin embargo, más delgado es mejor y se deben usar especímenes < 100 nm siempre que sea posible.
El método para preparar los especímenes para TEM depende de qué información se requiera. Para observar imágenes TEM con alta resolución, es necesario preparar películas delgadas sin introducir contaminación ni defectos. Para ello, es importante seleccionar un método de preparación de especímenes adecuado para cada material, y encontrar una condición óptima para cada método.
Trituración
Un espécimen puede ser triturado con un mortero de ágata y un mortero. Los copos obtenidos se suspenden en un disolvente orgánico (por ejemplo, acetona), y se dispersan con un baño sónico o simplemente agitando con una barra de vidrio. Finalmente, el disolvente que contiene las escamas del espécimen se deja caer sobre una rejilla. Este método se limita a materiales que tienden a escindirse (por ejemplo, mica).
Electropulido
Cortar una muestra a granel en placas de oblea de aproximadamente 0.3 mm de espesor mediante un cortador fino o una sierra multihilo. La oblea se adelgaza mecánicamente hasta aproximadamente 0.1 mm de espesor. El electropulido se realiza en un electrolito específico suministrando una corriente continua con el polo positivo en la placa delgada y el polo negativo en una placa de acero inoxidable. Para evitar el pulido preferencial en el borde de la muestra, todos los bordes están cubiertos con pintura aislante. Esto se llama el método de ventana. El electropulido se termina cuando hay un pequeño agujero en la placa con regiones muy delgadas a su alrededor (Figura\(\PageIndex{5}\)). Este método se utiliza principalmente para preparar películas delgadas de metales y aleaciones.
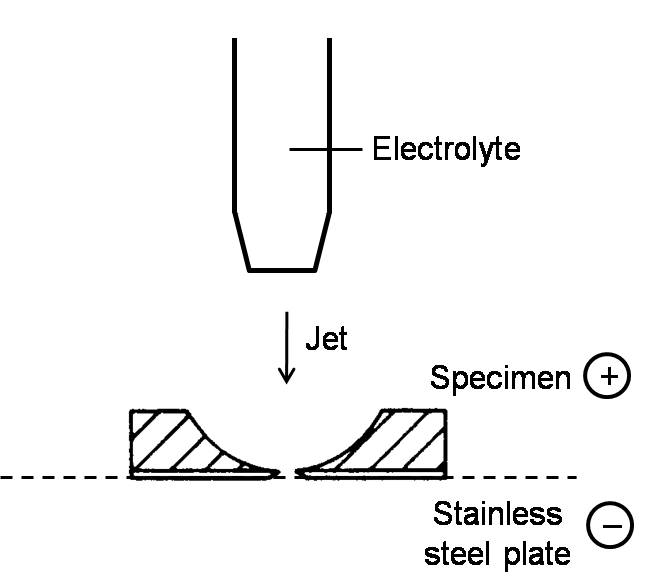
Pulido Químico
El adelgazamiento se realiza químicamente, es decir, sumergiendo el espécimen en una solución específica. En cuanto al electropulido, se debe preparar previamente una placa delgada de 0.1~0.2 mm de espesor. Si se hace un pequeño hoyuelo en el centro de la placa con una amoladora de hoyuelos, se puede hacer un agujero grabando alrededor del centro mientras se mantiene el borde del espécimen relativamente grueso. Este método se utiliza frecuentemente para diluir semiconductores como el silicio. Al igual que con el electropulido, si la muestra no se lava adecuadamente después del grabado químico, se forma contaminación como una capa de óxido en la superficie.
Ultramicrotomía
Los especímenes de películas delgadas o polvos generalmente se fijan en una resina acrílica o epoxi y se recortan con un cuchillo de vidrio antes de ser cortados con un cuchillo de diamante. Este proceso es necesario para que los especímenes en la resina puedan cortarse fácilmente con un cuchillo de diamante. Las resinas acrílicas se cortan fácilmente y se pueden quitar con cloroformo después de rebanar. Cuando se usa una resina acrílica, se usa una cápsula de gelatina como recipiente. La resina epoxi tarda menos tiempo en solidificarse que las resinas acrílicas, y permanecen fuertes bajo irradiación de electrones. Este método se ha utilizado para preparar secciones delgadas de especímenes biológicos y en ocasiones para películas delgadas de materiales inorgánicos que no son demasiado difíciles de cortar.
Fresado iónico
Se prepara una placa delgada (menos de 0.1 mm) a partir de una muestra a granel mediante el uso de un cortador de diamante y por adelgazamiento mecánico. Después, se hace un disco de 3 mm de diámetro a partir de la placa utilizando un cuchillo de diamante o un cortador ultrasónico, y se forma un hoyuelo en el centro de la superficie con una amoladora de hoyuelos. Si es posible adelgazar el disco directamente a 0.03 mm de espesor mediante adelgazamiento mecánico sin usar una amoladora de hoyuelos, el disco debe fortalecerse cubriendo el borde con un anillo metálico. Los iones Ar se utilizan generalmente para la pulverización catódica, y el ángulo de incidencia contra el espécimen de disco y el voltaje de aceleración se establecen como 10 - 20o y algunos kilovoltios, respectivamente. Este método es ampliamente utilizado para obtener regiones delgadas de cerámicas y semiconductores en particular, y también para la sección transversal de varias películas multicapa.
Haz de iones enfocados (FIB)
Este método fue desarrollado originalmente con el propósito de fijar dispositivos semiconductores. En principio, los haces de iones se enfocan bruscamente en un área pequeña, y el espécimen se adelgaza muy rápidamente por pulverización catódica. Por lo general, se utilizan iones Ga, con un voltaje de aceleración de aproximadamente 30 kV y una corriente de aproximadamente 10 A/cm2. El tamaño de la sonda es de varias decenas de nanómetros. Este método es útil para especímenes que contienen un límite entre diferentes materiales, donde puede ser difícil diluir homogéneamente la región límite por otros métodos como la molienda iónica.
Evaporación al Vacío
El espécimen a estudiar se coloca en una bobina de tungsteno-bobina o cesta. El calentamiento por resistencia es aplicado por una corriente eléctrica que pasa a través de la bobina o cesta, y la muestra se funde, luego se evapora (o se sublima) y finalmente se deposita sobre un sustrato. El proceso de deposición generalmente se realiza bajo una presión de 10-3-10-4 Pa, pero para evitar la contaminación superficial, es necesario un vacío muy alto. Como sustrato se utiliza una película de colodión o sal de roca escindida. La sal de roca es especialmente útil en la formación de monocristales con una relación de orientación especial entre cada cristal y el sustrato. La sal se disuelve fácilmente en agua, y luego las películas depositadas se pueden fijar en una rejilla. Recientemente, como alternativa al calentamiento por resistencia, se ha utilizado el calentamiento por haz de electrones o un método de pulverización catódica por haz de iones para preparar películas delgadas de diversas aleaciones. Este método se utiliza para preparar películas delgadas homogéneas de metales y aleaciones, y también se utiliza para recubrir una muestra con el metal de aleación.
Las características de la rejilla
Los tipos de especímenes TEM que se preparan dependen de la información que se necesite. Por ejemplo, un espécimen autoportante es aquel en el que todo el espécimen consiste en un material (que puede ser un compuesto). Otros especímenes se apoyan en una rejilla o en una arandela de Cu con una sola ranura. Algunas cuadrículas se muestran en la Figura\(\PageIndex{6}\). Por lo general, el espécimen o rejilla tendrá 3 mm de diámetro.

Los diseños de etapas de muestra TEM incluyen esclusas de aire para permitir la inserción del portamuestras en el vacío con un aumento mínimo de la presión en otras áreas del microscopio. Los portamuestras están adaptados para contener un tamaño estándar de rejilla sobre la que se coloca la muestra o un tamaño estándar de espécimen autoportante. Los tamaños de rejilla TEM estándar son un anillo de 3.05 mm de diámetro, con un grosor y tamaño de malla que van desde unos pocos hasta 100 µm. La muestra se coloca sobre el área de malla interna que tiene un diámetro de aproximadamente 2.5 mm. Los materiales de la rejilla suelen ser cobre, molibdeno, oro o platino. Esta rejilla se coloca en el portamuestras que se empareja con la etapa de espécimen. Existe una amplia variedad de diseños de etapas y soportes, dependiendo del tipo de experimento que se esté realizando. Además de las rejillas de 3.05 mm, a veces se utilizan rejillas de 2.3 mm, si raramente. Estas rejillas fueron particularmente utilizadas en las ciencias minerales donde se puede requerir un gran grado de inclinación y donde el material del espécimen puede ser extremadamente raro. Los especímenes transparentes de electrones tienen un espesor de alrededor de 100 nm, pero este valor depende del voltaje de aceleración.
Una vez insertada en un TEM, la muestra es manipulada para permitir el estudio de la región de interés. Para acomodar esto, la etapa TEM incluye mecanismos para la traslación de la muestra en el plano XY de la muestra, para el ajuste de altura Z del portamuestras, y generalmente al menos un grado de libertad de rotación. La mayoría de los TEM proporcionan la capacidad de dos ángulos de rotación ortogonales de movimiento con diseños de soporte especializados llamados portamuestras de doble inclinación
Se requiere que una etapa TEM tenga la capacidad de sostener un espécimen y ser manipulada para llevar la región de interés a la trayectoria del haz de electrones. Como el TEM puede operar en una amplia gama de aumentos, la platina debe ser simultáneamente altamente resistente a la deriva mecánica tan baja como unos pocos nm/minuto, al tiempo que puede moverse varios µm/minuto, con una precisión de reposicionamiento del orden de los nanómetros.
Imagen de Microscopía Electrónica de Transmisión para Nanomateriales Multicapa
Aunque los TEM solo pueden proporcionar análisis 2D para un espécimen 3D; se pueden obtener rutinariamente aumentos de 300,000 veces para muchos materiales, lo que lo convierte en un método ideal para el estudio de nanomateriales. Además de las imágenes TEM, las áreas más oscuras de la imagen muestran que la muestra es más gruesa o densa en estas áreas, por lo que podemos observar los diferentes componentes y estructuras del espécimen por la diferencia de color. Para investigar nanomateriales multicapas, un TEM suele ser la primera opción, ya que no solo proporciona una imagen de alta resolución para nanomateriales sino que también puede distinguir cada capa dentro de un material nanoestructurado.
Observaciones de nanomateriales multicapas
Se utilizó TEM para analizar las películas multicapa W/Si graduadas en profundidad. Las películas multicapa se cultivaron sobre obleas de Si pulidas de 100 mm de espesor mediante pulverización catódica con magnetrón en gas argón. Los espesores individuales de las capas de tungsteno y silicio en multicapas periódicas y graduadas en profundidad se ajustan variando la velocidad de rotación controlada por computadora de la platina del sustrato. Los tiempos de deposición requeridos para producir espesores de capa específicos se determinaron a partir de calibraciones detalladas de velocidad. Las muestras para TEM se prepararon mediante molienda con haz de iones enfocados a temperatura de N2 líquido para evitar cualquier calentamiento del haz que pudiera resultar en la re-cristalización y/o recrecimiento de cualquier capa policristalina amorfa o de grano fino en la película.
Las mediciones de TEM se realizaron con un microscopio electrónico de transmisión JEOL-4000 de alta resolución que operaba a 400 keV; este instrumento tiene una resolución punto a punto de 0.16 nm. Las imágenes transversales de gran área de una película multicapa graduada en profundidad obtenidas bajo aumento medio (~100 kX) se adquirieron a alta resolución. Una imagen TEM de corte transversal mostró 150 capas W/Si película con el espesor de capas en el rango de 3.33 ~ 29.6 nm (La figura\(\PageIndex{7}\) muestra una parte de capas). Las capas oscuras son de tungsteno y las capas de luz son de silicio y están separadas por las capas intermedias W—Si amorfas delgadas (bandas grises). Por la alta resolución del TEM y las características naturales del material, cada capa se puede distinguir claramente con su diferente oscuridad.
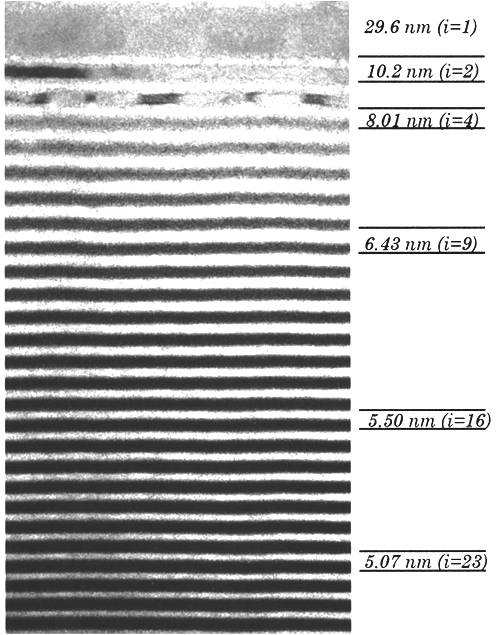
No todos los tipos de nanomateriales multicapa se pueden observar claramente bajo TEM. Se prepararon materiales compuestos por multicapas PC-Si:H mediante una deposición química de vapor fotoasistida (Foto-CVD) utilizando una lámpara de mercurio de baja presión como fuente de luz UV para disociar los gases. La multicapa PC-Si:H incluyó subcapas de a-Si:H diluidas en H2 bajas (SL) y subcapas de a-Si:H altamente diluidas en H2 (SH). El control del flujo de gas CVD (H2|SiH4) bajo irradiación UV continua resultó en la deposición de películas multicapa capa por capa.
Para una medición TEM, una película de a-Si:H sin diluir de 20 nm de espesor sobre una oblea de c-Si antes de la deposición de multicapa para evitar cualquier crecimiento epitaxial. La Figura\(\PageIndex{8}\) muestra una imagen TEM en sección transversal de un espécimen multicapa PC-Si:H de seis ciclos. Las líneas punteadas blancas se utilizan para enfatizar las franjas horizontales, las cuales tienen periodicidad en la imagen TEM. Como se puede observar, no hay límites significativos entre SL y SH podrían observarse ya que todas las subcapas se preparan en gas H2. Para obtener el grosor más preciso de cada subcapa, podrían ser necesarias otras mediciones.
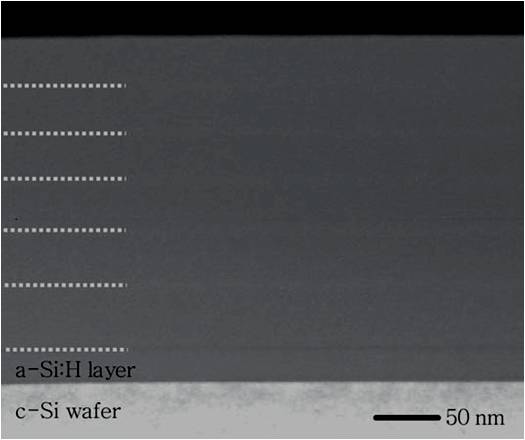
Imágenes TEM de Nanomateriales de Carbono
La microscopía electrónica de transmisión (TEM) es una forma de microscopía que utiliza un haz de electrones de alta energía (en lugar de luz óptica). Un haz de electrones se transmite a través de un espécimen ultradelgado, interactuando con el espécimen a medida que pasa. La imagen (formada a partir de la interacción de los electrones con la muestra) se magnifica y se enfoca sobre un dispositivo de imagen, como una película fotográfica, una pantalla fluorescente o detectada por una cámara CCD. Para que los electrones pasen a través del espécimen, el espécimen tiene que ser ultra delgado, generalmente más delgado que 10 nm.
La resolución de TEM es significativamente mayor que la de los microscopios ópticos. Esto se debe a que el electrón tiene una longitud de onda de Broglie mucho más pequeña que la luz visible (longitud de onda de 400~700 nm). Teóricamente, la resolución máxima, d, ha estado limitada por λ, la longitud de onda de la fuente detectora (luz o electrones) y NA, la apertura numérica del sistema.
\[ d\ = \frac{\lambda }{2n\ sin \alpha} \approx \frac{\lambda }{2NA} \label{8} \]
Para los electrones de alta velocidad (en TEM, la velocidad de los electrones es cercana a la velocidad de la luz, c, por lo que se tiene que considerar la teoría especial de la relatividad), la λe:
\[ \lambda _{e} =\ \frac{h}{\sqrt{2m_{0}E(1+E/2m_{0}c^{2})}} \label{9} \]
De acuerdo con esta fórmula, si aumentamos la energía de la fuente detectora, su longitud de onda disminuirá, y podremos obtener mayor resolución. Hoy en día, la energía de los electrones utilizados puede llegar fácilmente a 200 keV, a veces tan alta como 1 MeV, lo que significa que la resolución es lo suficientemente buena como para investigar la estructura en escala subnanométrica. Debido a que los electrones son enfocados por varias lentes electrostáticas y electromagnéticas, como los problemas que suelen tener las cámaras ópticas, la resolución de la imagen también está limitada por la aberración, especialmente la aberración esférica llamada Cs. Equipado con una nueva generación de correctores de aberración, el microscopio con corrección de aberración electrónica de transmisión (TEAM) puede superar la aberración esférica y llegar a la resolución de medio angstrom.
Aunque TEAM puede llegar fácilmente a la resolución atómica, el primer TEM inventado por Ruska en abril de 1932 difícilmente podría competir con el microscopio óptico, con solo 3.6×4.8 = 14.4 aumentos. El problema principal fue el daño por irradiación de electrones a la muestra en un sistema de vacío deficiente. Después de la Segunda Guerra Mundial, Ruska reanudó su trabajo en el desarrollo de TEM de alta resolución. Por último, esta obra le trajo el Premio Nobel de Física 1986. Desde entonces, la estructura general del TEM no ha cambiado demasiado como se muestra en la Figura\(\PageIndex{9}\). Los componentes básicos en TEM son: cañón de electrones, sistema condensador, lente objetivo (len más importante en TEM que determina la resolución final), lente de difracción, lentes proyectivas (todas las lentes están dentro de la columna del equipo, entre aberturas), sistema de grabación de imágenes (solía ser películas negativas, ahora es CCD cámaras) y sistema de vacío.
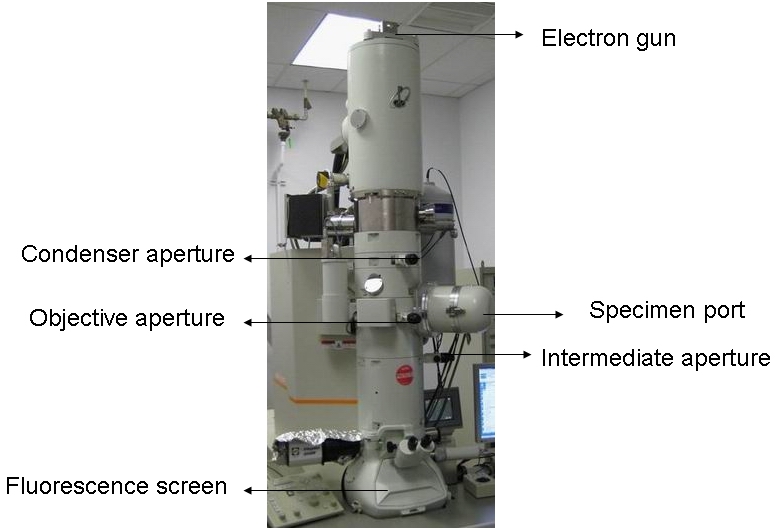
La familia de alótropos de carbono y nanomateriales de carbono
Los alótropos de carbono comunes incluyen diamante, grafito, C amorfo (a-C), fullereno (también conocido como buckyball), nanotubos de carbono (CNT, incluyendo CNT de pared simple y CNT de pared múltiple), grafeno. La mayoría de ellos son químicamente inertes y se han encontrado en la naturaleza. También podemos definir carbono como carbono sp2 (que es grafito), carbono sp3 (que es diamante) o híbridos de carbono sp2 y sp3. Como se muestra en la Figura, (a) es la estructura del diamante, (b) es la estructura del grafito, (c) el grafeno es una sola lámina de grafito, (d) es carbono amorfo, (e) es C60 y (f) es nanotubo de pared simple. En cuanto a los nanomateriales de carbono, fullereno, CNT y grafeno son los tres más investigados, debido a sus propiedades únicas tanto en mecánica como electrónica. Bajo TEM, estos nanomateriales de carbono mostrarán tres imágenes proyectadas diferentes.

Estructura Atómica de Nanomateriales de Carbono bajo TEM
Todos los naomateriales de carbono pueden ser investigados bajo TEM. Sin embargo, por su diferencia en estructura y forma, deben enfocarse partes específicas para obtener su estructura atómica.
Para C60, que tiene un diámetro de solo 1 nm, es relativamente difícil suspender una muestra sobre una rejilla de carbono con cordones (un tipo común de rejilla TEM que generalmente se usa para nanopartículas). Incluso si el C60 se asienta sobre una película delgada de a-C, también tiene algunos problemas de enfoque ya que la variación del perfil de la superficie podría ser mayor de 1 nm. Una forma de resolver este problema es encapsular el C60 en CNT de pared simple, que se conoce como nano peapods. Este método tiene dos beneficios:
CNT ayuda a enfocarse en C60. Una sola pared está alineada en una distancia larga (relativa a C60). Una vez que se suspende sobre una película de carbono de lacey, es mucho más fácil enfocarse en ella. Por lo tanto, el C60 en el interior también puede ser atrapado por cambios menores de enfoque.
El CNT puede proteger C60 de la irradiación de electrones. Los electrones intensos de alta energía pueden cambiar permanentemente la estructura de la CNT. Para C60, que es más reactivo que los CNT, no puede sobrevivir después de exponerse a electrones rápidos de dosis altas.
Al estudiar jaulas de CNT, se observa C92 como un pequeño círculo dentro de las paredes de la CNT. Mientras que la mayoría de la energía de los electrones es absorbida por la CNT, la muestra aún no es a prueba de radiación. Así, como se ve en la Figura\(\PageIndex{11}\), después de una exposición de 123 s, se pueden generar defectos y dos C92 fusionados en un nuevo fullereno más grande.
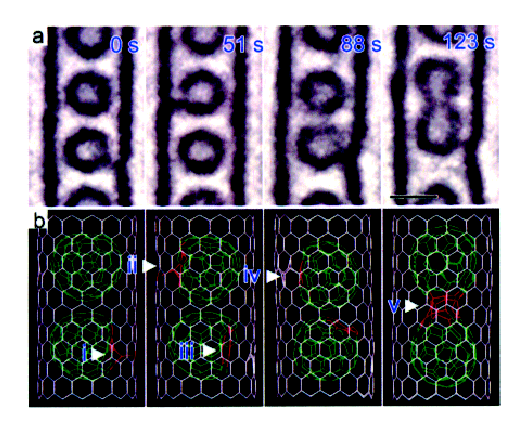
Aunque, el descubrimiento de C 60 se confirmó primero por espectros de masas en lugar de TEM. Cuando se trataba del descubrimiento de CNT, los espectros de masas ya no eran útiles porque los CNT no muestran picos individuales en los espectros de masas ya que cualquier muestra contiene un rango de CNT con diferentes longitudes y diámetros. Por otro lado, HRTEM puede aportar una imagen clara de evidencia de su existencia. Un ejemplo se muestra en la Figura\(\PageIndex{12}\).
El grafeno es una lámina plana de fullereno. Hasta hace poco, Raman, AFM y microscopía óptica (grafeno sobre oblea de 300 nm de SiO2) fueron los métodos más convenientes para caracterizar muestras. Sin embargo, para confirmar la estructura atómica del grafeno y determinar la diferencia entre monocapa y bicapa, TEM sigue siendo una buena opción. En la Figura\(\PageIndex{13}\), se observa un grafeno suspendido monocapa con su estructura atómica claramente mostrada. El recuadro es el FFT de la imagen TEM, que se puede utilizar como filtro para obtener una imagen de estructura optimizada. La imagen de campo oscuro anular de ángulo alto (HAADF) generalmente da un mejor contraste para diferentes partículas en ella. También es sensible con cambios de grosor, lo que permite determinar el número de capas de grafeno.
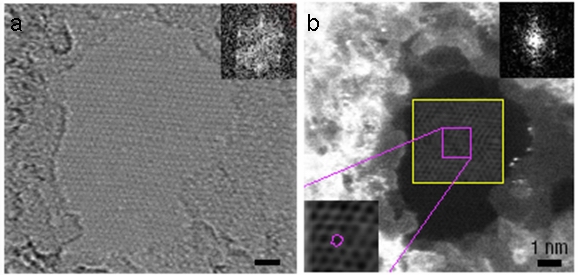
Apilamiento de grafeno y dirección de bordes
Al igual que la situación en la CNT, la imagen TEM es una imagen proyectada. Por lo tanto, incluso con el recuento exacto de líneas de borde, no es posible concluir que una muestra sea un grafeno de una sola capa o multicapa. Si el grafeno plegable tiene apilamiento AA (una capa se superpone sobre la otra), con una dirección proyectada de [001], una imagen no podría decir el grosor del grafeno. Para distinguir dicha bicapa de grafeno de una sola capa de grafeno, se debe realizar una serie de experimentos de inclinación. Diferentes estructuras de apilamiento de grafeno se muestran en la Figura\(\PageIndex{13}\) a.
Teóricamente, el grafeno tiene el potencial de efectos de borde interesantes. Basado en su estructura sp2, su borde puede ser el de una configuración en zigzag o sillón. Cada uno de estos posee diferentes propiedades electrónicas similares a las observadas para los CNT. Tanto para la investigación como para la aplicación potencial, es importante controlar el crecimiento o corte del grafeno con un borde específico. Pero antes de probar sus propiedades electrónicas, todos los bordes tienen que ser identificados, ya sea por imagen directa con STM o por TEM. La información detallada de los bordes de grafeno se puede obtener con HRTEM, simulada con transformada rápida de Fourier (FFT). En la Figura\(\PageIndex{14}\) b, las direcciones del sillón están marcadas con flecha roja respectivamente. Un modelo transparente en Figurec muestra un ángulo de 30 grados entre el borde en zigzag y el borde del sillón.
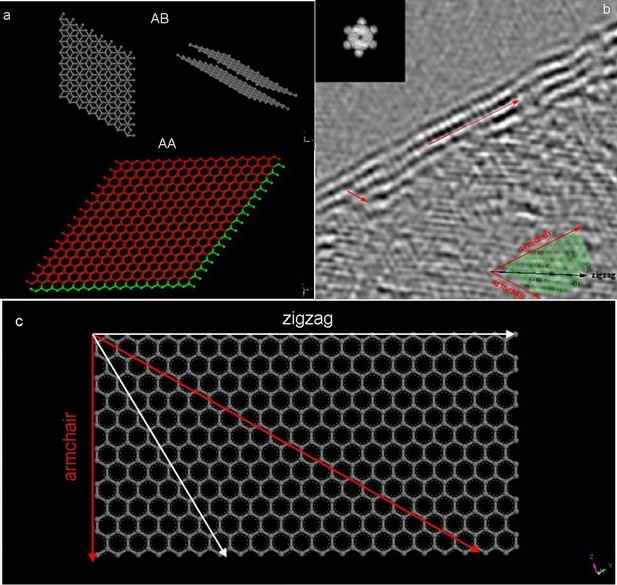
Espectroscopia de pérdida de energía electrónica de transmisión
La espectroscopia de pérdida de energía electrónica (EELS) es una técnica que mide las excitaciones electrónicas dentro de materiales de estado sólido. Cuando un haz de electrones con un rango estrecho de energía cinética se dirige a un material, algunos electrones se dispersarán inelásticamente, resultando en una pérdida de energía cinética. Los electrones pueden dispersarse inelásticamente a partir de excitaciones de fonones, excitaciones de plasmones, transiciones entre bandas o ionización de la capa interna. EELS mide la pérdida de energía de estos electrones dispersos inelásticamente y puede proporcionar información sobre la composición atómica, la unión, las propiedades electrónicas de la cenefa y las bandas de conducción y las propiedades superficiales. Un ejemplo de mapeo de composición de nivel atómico se muestra en la Figura\(\PageIndex{15}\) a. EELS incluso se ha utilizado para medir la presión y la temperatura dentro de los materiales.
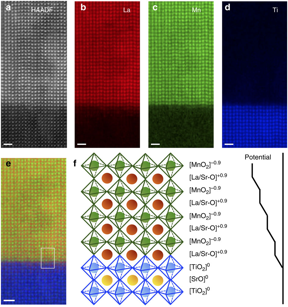
El espectro eEL
En la Figura se muestra un espectro de EEL idealizado\(\PageIndex{16}\). La característica más destacada de cualquier espectro EEL es el pico de pérdida cero (ZLP). El ZLP se debe a aquellos electrones del haz de electrones que no se dispersan inelásticamente y alcanzan el detector con su energía cinética original; típicamente 100-300 keV. Por definición, la ZLP se establece en 0 eV para su posterior análisis y todas las señales que surgen de electrones dispersos inelásticamente ocurren a >0 eV. La segunda característica más grande es a menudo la resonancia de plasmón, la excitación colectiva de los electrones de la banda de conducción dentro de un material. La resonancia de plasmón y otros picos atribuidos a electrones de capa externa o débilmente unidos ocurren en la región de “baja pérdida” del espectro. El régimen de baja pérdida se considera típicamente como pérdida de energía <50 eV, pero este corte de baja pérdida a alta pérdida es arbitrario. En el recuadro de la Figura\(\PageIndex{16}\) se muestra un borde de la pérdida de núcleo del átomo y una estructura fina adicional. Las ionizaciones de la cubierta interna, representadas por los picos de pérdida de núcleo, son útiles para determinar composiciones elementales ya que estos picos pueden actuar como huellas dactilares para elementos específicos. Por ejemplo, si hay un pico a 532 eV en un espectro de EEL, existe una alta probabilidad de que la muestra contenga una cantidad considerable de oxígeno porque se sabe que esta es la energía necesaria para eliminar un electrón de cubierta interna del oxígeno. Esta idea se explora más a fondo observando cambios repentinos en el plasmón masivo para aluminio en diferentes ambientes químicos como se muestra en la Figura\(\PageIndex{16}\).


Por supuesto, hay varias otras técnicas disponibles para sondear composiciones atómicas muchas de las cuales están cubiertas en este texto. Estos incluyen espectroscopía de rayos X dispersiva de energía, espectroscopia de fotoelectrones de rayos X y espectroscopía electrónica Auger. Por favor, haga referencia a estos capítulos una introducción exhaustiva a estas técnicas.
Espectroscopia de pérdida de energía electrónica versus espectroscopía de rayos X dispersiva de energía
Como técnica, EELS se compara con mayor frecuencia con la espectroscopía de rayos X de dispersión de energía (EDX) también conocida como espectroscopia de energía dispersiva (EDS). Los detectores de rayos X dispersivos de energía se encuentran comúnmente como sondas analíticas en microscopios electrónicos de barrido y transmisión. La popularidad del EDS se puede entender reconociendo la simplicidad del análisis composicional utilizando esta técnica. Sin embargo, los datos de EELS pueden ofrecer análisis composicionales complementarios y, en general, proporcionar una mayor comprensión de la física y química del estado sólido en un sistema a costa de una curva de aprendizaje más pronunciada. Los espectros EDS y EELS se derivan de las excitaciones electrónicas de los materiales, sin embargo, EELS sondea la excitación inicial mientras que EDS analiza las emisiones de rayos X de la descomposición de este estado excitado. Como resultado, los espectros de EEL investigan rangos de energía de 0-3 keV mientras que los espectros EDS analizan un rango de energía más amplio de 1-40 keV. La diferencia en los rangos hace que EDS sea especialmente adecuado para elementos pesados, mientras que EELS complementa elementos de medición más ligeros que Zn.
Historia e Implementación
A principios de la década de 1940, James Hillier (Figura\(\PageIndex{18}\)) y R.F. Baker buscaban desarrollar un método para emparejar el tamaño, la forma y la estructura disponible de los microscopios electrónicos con un método conveniente para “determinar la composición de partículas individuales en un espécimen mixto”. Su instrumento, mostrado en la Figura\(\PageIndex{19}\), reportado en el Journal of Applied Physics en septiembre de 1994 fue el primer instrumento electrón-óptico utilizado para medir la distribución de la velocidad en un haz de electrones que transmite a través de una muestra.


El instrumento fue construido a partir de un microscopio electrónico de transmisión reutilizado (TEM). Consistía en una fuente de electrones y tres lentes de enfoque electromagnético, estándar para los TEM en ese momento, pero también incorporaban lentes deflectoras magnéticas, que al encenderse, redirigirían los electrones 180° a una placa fotográfica. Los electrones con energías cinéticas variables se dispersaron a través de la placa fotográfica y podrían correlacionarse con la pérdida de energía de cada pico dependiendo de la posición. En este trabajo pionero, Hillier y Baker pudieron encontrar la pérdida discreta de energía correspondiente a los niveles de K tanto de carbono como de oxígeno.
La gran mayoría de los espectrómetros EEL se encuentran como analizadores secundarios en microscopios electrónicos de transmisión. No fue hasta la década de 1990 cuando EELS se convirtió en una herramienta de investigación ampliamente utilizada debido a los avances en las tecnologías de corrección de aberración de haz de electrones y vacío. Hoy en día, EELS es capaz de resoluciones espaciales hasta el nivel de un solo átomo, y si el haz de electrones es monocromático, la resolución de energía puede ser tan baja como 0.01eV. La figura\(\PageIndex{20}\) representa el diseño típico de un espectrómetro EEL en la base de un TEM.