9.1: Interferometría
- Page ID
- 70953
Aplicación de Interferometría de Barrido Vertical al Estudio de Procesos de Superficie Cristalina
Los procesos que ocurren en las superficies de los cristales dependen de muchos factores externos e internos como la estructura y composición cristalina, las condiciones de un medio donde existe la superficie cristalina y otros. La aparición de una superficie cristalina es el resultado de la complejidad de las interacciones entre la superficie cristalina y el ambiente. Los mecanismos de los procesos superficiales como la disolución o el crecimiento son estudiados por la química física de las superficies. Existen muchas técnicas computacionales que nos permiten predecir el cambio de morfología superficial de diferentes minerales que están influenciados por diferentes condiciones como temperatura, presión, pH y composición química de la solución que reacciona con la superficie. Por ejemplo, el método de Monte Carlo es ampliamente utilizado para simular la disolución o crecimiento de cristales. Sin embargo, los modelos teóricos de los procesos superficiales necesitan ser verificados por observaciones naturales. Podemos extraer mucha información útil sobre los procesos superficiales a través del estudio del cambio de la estructura de la superficie cristalina bajo la influencia de las condiciones ambientales. Los cambios en la estructura de la superficie pueden estudiarse mediante la observación de la topografía de la superficie cristalina. La topografía se puede observar directamente macroscópicamente o mediante técnicas microscópicas. La observación microscópica nos permite estudiar incluso cambios muy pequeños y estimar la tasa de procesos observando el cambio de la topografía de la superficie cristalina en el tiempo.
Mucho laboratorio trabajó bajo la reconstrucción de los cambios superficiales y la interpretación de la cinética de disolución y precipitación de los cristales. La invención de AFM hizo posible monitorear los cambios de estructura de la superficie durante la disolución o el crecimiento. Sin embargo, para detectar y cuantificar los resultados de los procesos de disolución o crecimiento es necesario determinar los cambios en el área de superficie sobre un campo de visión significativamente mayor que el que la AFM puede proporcionar. Más recientemente, la interferometría de barrido vertical (VSI) se ha desarrollado como nueva herramienta para distinguir y trazar las partes reactivas de las superficies cristalinas. VSI y AFM son técnicas complementarias y prácticamente adecuadas para detectar cambios superficiales.
La técnica VSI proporciona un método para la cuantificación de la topografía superficial a nivel de angstrom a nanómetro. Las mediciones de VSI dependientes del tiempo se pueden usar para estudiar el retroceso normal de la superficie a través del cristal y otras superficies sólidas durante el proceso de disolución. Por lo tanto, VSI se puede utilizar para medir directa y no directamente las velocidades de disolución de minerales con alta precisión. Análogamente, VSI se puede utilizar para estudiar la cinética del crecimiento de los cristales.
Principios Físicos de Interferometría Óptica
La interferometría óptica nos permite realizar mediciones extremadamente precisas y se ha utilizado como técnica de laboratorio desde hace casi cien años. Thomas Young observó interferencia de la luz y midió la longitud de onda de la luz en un experimento, realizado alrededor de 1801. Este experimento dio una evidencia de los argumentos de Young para el modelo de onda para la luz. El descubrimiento de la interferencia dio una base para el desarrollo de técnicas de interferomertría ampliamente utilizadas con éxito como en investigaciones microscópicas, como en investigaciones astronómicas.
Los principios físicos de la interferometría óptica explotan las propiedades de onda de la luz. La luz puede pensarse como onda electromagnética que se propaga a través del espacio. Si asumimos que estamos tratando con una onda linealmente polarizada que se propaga en un vacío en dirección z, el campo eléctrico E puede ser representado por una función sinusoidal de distancia y tiempo.
\[ E(x,y,z,t)\ =\ a \cos[2\pi (vt\ -\ z/\lambda )] \label{1} \]
Donde a es la amplitud de la onda de luz, v es la frecuencia y λ es su longitud de onda. El término entre corchetes se llama la fase de la onda. Vamos a reescribir esta ecuación en forma más compacta,
\[ E(x,y,z,t)\ =\ a \cos(\omega t\ -\ kz) \label{2} \]
donde ω=2πv es la frecuencia circular, y k=2π/λ es la constante de propagación. Transformemos también esta segunda ecuación en una forma exponencial compleja,
\[ E(x,y,z,t)\ =\ Re(a\ e^{i(\psi + \omega t)})\ =\ Re(a\ e^{i\omega t}) \label{3} \]
donde φ = 2πz/λ y a=E −iφ se conoce como la amplitud compleja. Si n es un índice de refracción de un medio donde se propaga la luz, la onda de luz recorre una distancia d en dicho medio. La trayectoria óptica equivalente en este caso es
\[ p\ =\ n\ \cdot \ d \label{4} \]
Cuando se superponen dos ondas de luz, la intensidad resultante en cualquier punto depende de si se refuerzan o cancelan entre sí (Figura\(\PageIndex{1}\)). Este es bien conocido fenómeno de interferencia. Supondremos que dos ondas se están propagando en la misma dirección y están polarizadas con sus vectores de campo en el mismo plano. También asumiremos que tienen la misma frecuencia. La amplitud compleja en cualquier punto del patrón de interferencia es entonces la suma de las amplitudes complejas de las dos ondas, para que podamos escribir,
\[ A\ =\ A_{1}\ +\ A_{2} \label{5} \]
donde A1=A1exp (−iφ 1) y A2=A2exp (−iφ 2) son las amplitudes complejas de dos ondas. La intensidad resultante es, por lo tanto,
\[ I\ =\ |A|^{2}\ =\ I_{1}\ +\ I_{2}\ +\ 2(I_{1}I_{2})^{1/2} cos (\Delta \psi) \label{6} \]
donde I 1 e I2 son las intensidades de dos ondas que actúan por separado, y δΦ=9 1 −9 2 es la diferencia de fase entre ellas. Si las dos ondas se derivan de una fuente común, la diferencia de fase corresponde a una diferencia de trayectoria óptica,
\[ \Delta p\ =\ (\lambda /2 \pi) \Delta \psi \label{7} \]

Si Δφ, la diferencia de fase entre los haces, varía linealmente a través del campo de visión, la intensidad varía cosinusoidalmente, dando lugar a bandas o franjas alternas de luz y oscuridad (Figura\(\PageIndex{1}\)). La intensidad de un patrón de interferencia tiene su valor máximo:
\[ I_{max}\ =\ I_{1}\ +\ I_{2}\ +\ 2(I_{1}I_{2})^{1/2} \label{8} \]
cuando δφ = 2Mπ, donde m es un número entero y su valor mínimo i determinado por:
\[ I_{min}\ =\ I_{1}\ +\ I_{2}\ -\ 2(I_{1}I_{2})^{1/2} \label{9} \]
cuando Δφ = (2m+1) π El principio de interferometría es ampliamente utilizado para desarrollar muchos tipos de configuraciones interferométricas. Una de las primeras configuraciones es la interferometría de Michelson. La idea de esta interferometría es bastante simple: las franjas de interferencia se producen dividiendo un haz de luz monocromática de manera que un haz choca con un espejo fijo y el otro un espejo móvil. Un patrón de interferencia resulta cuando los haces reflejados se vuelven a unir. El esquema interferométrico de Michelson se muestra en la Figura\(\PageIndex{2}\).
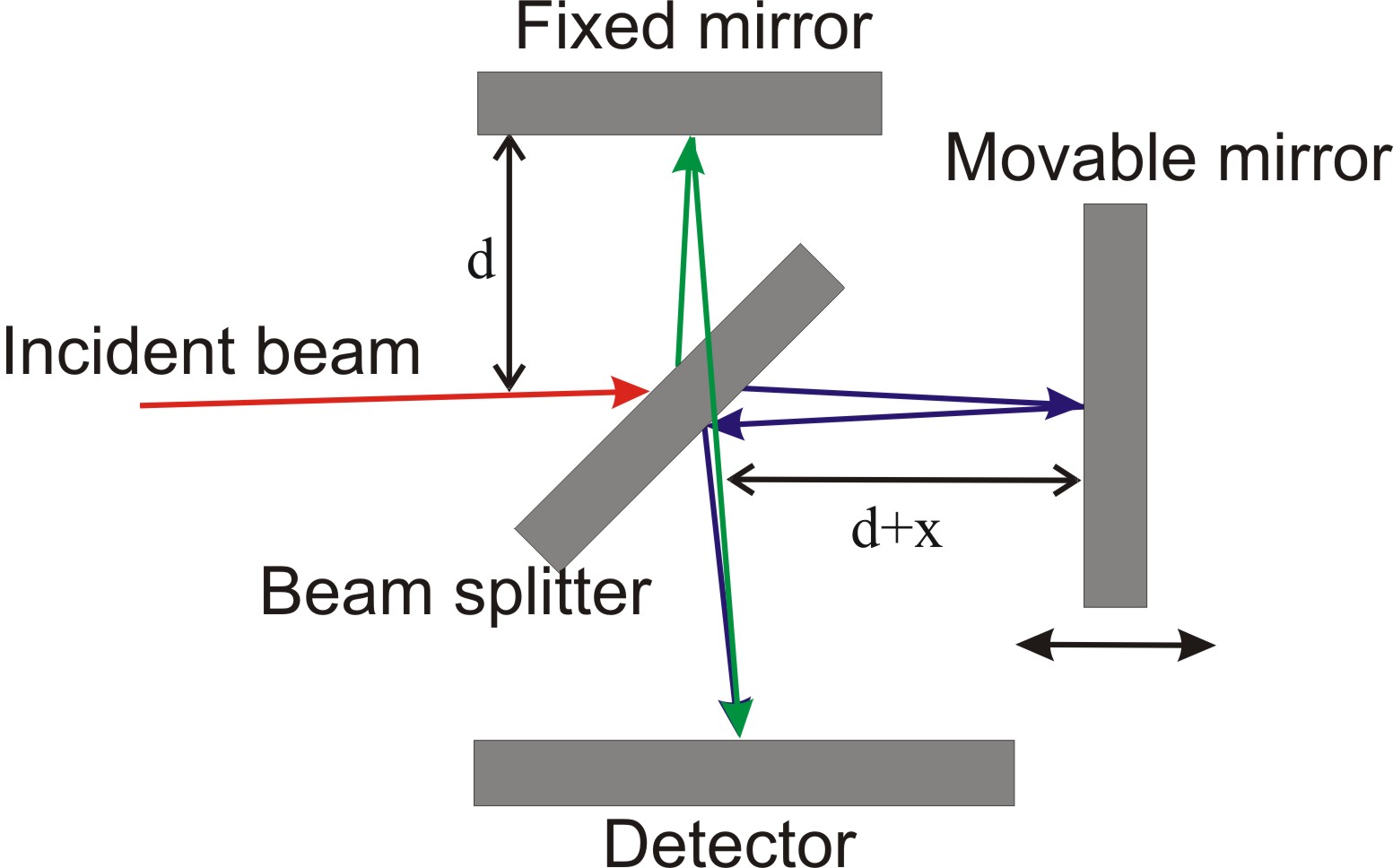
La diferencia de longitudes de trayectoria entre dos haces es 2x porque los haces atraviesan las distancias designadas dos veces. La interferencia ocurre cuando la diferencia de trayectoria es igual a números enteros de longitudes de onda,
\[ \Delta p\ =\ 2x\ m\lambda (m= 0, \pm 1, \pm 2 ... ) \label{10} \]
Los sistemas interferométricos modernos son más complicados. Usando técnicas especiales de medición de fase, son capaces de realizar mediciones de altura mucho más precisas que las que se pueden obtener con solo mirar directamente las franjas de interferencia y medir cómo se apartan de ser rectas e igualmente espaciadas. Típicamente el sistema interferométrico consiste en fuente de luz, divisor de haz, sistema objetivo, sistema de registro de señales y transformación en formato digital y computadora que procesa los datos. La interferometría de barrido vertical es contiene todas estas partes. La figura\(\PageIndex{3}\) muestra una configuración de un sistema interferométrico VSI.
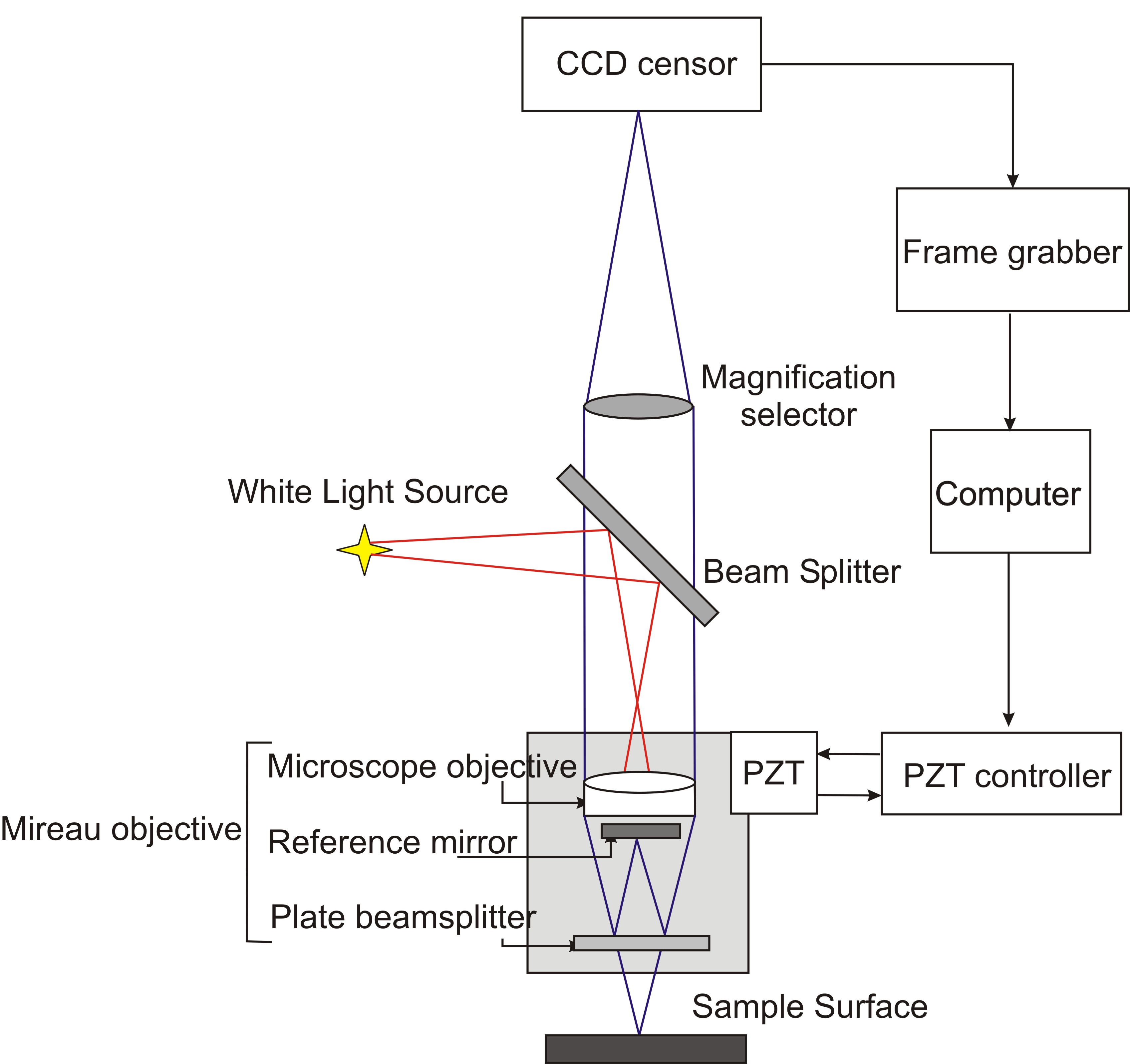
Muchos de los sistemas interferométricos modernos utilizan el objetivo Mirau en sus construcciones. El objetivo de Mireau se basa en un interferómetro Michelson. Este objetivo consiste en una lente, un espejo de referencia y un divisor de haz. La idea de obtener haces interferentes es simple: dos haces (líneas rojas) viajan a lo largo del eje óptico. Luego se reflejan desde la superficie de referencia y la superficie de la muestra respectivamente (líneas azules). Después de esto estos haces se recombinan para interferir entre sí. Se utiliza un sistema de iluminación o fuente de luz para dirigir la luz sobre una superficie de muestra a través de un divisor de haz de cubo y el objetivo Mireau. La superficie de la muestra dentro del campo de visión del objetivo es iluminada uniformemente por aquellos haces con diferentes ángulos de incidencia. Cualquier punto en la superficie de la muestra puede reflejar esos haces incidentes en forma de cono divergente. De igual manera, el punto en la referencia simétrico con el de la superficie de la muestra refleja también aquellos haces iluminados en la misma forma.
El objetivo Mireau dirige los haces reflejados de la referencia y la superficie de la muestra sobre un sensor CCD (dispositivo de carga acoplada) a través de una lente de tubo. El sensor CCD es un registro de desplazamiento analógico que permite el transporte de señales analógicas (cargas eléctricas) a través de etapas sucesivas (condensadores), controladas por una señal de reloj. El patrón de franjas de interferencia resultante es detectado por un sensor CCD y la señal correspondiente es digitalizada por un capturador de cuadros para su posterior procesamiento con una computadora.
Se conoce la distancia entre un mínimo y un máximo del interferograma producido por dos haces reflejados desde la superficie de referencia y muestra. Es decir, exactamente la mitad de la longitud de onda de la fuente de luz. Por lo tanto, con un interferograma simple la resolución vertical de la técnica también se limitaría a λ/2. Si vamos a utilizar una luz láser como fuente de luz con una longitud de onda de 300 nm la resolución sería de sólo 150 nm. Esta resolución no es lo suficientemente buena para una investigación detallada a escala casi atómica de las superficies cristalinas. Afortunadamente, la resolución vertical de la técnica se puede mejorar significativamente moviendo la referencia o la muestra por una fracción de la longitud de onda de la luz. De esta manera, se producen varios interferogramas. Entonces todos están superpuestos, y sus desplazamientos de fase comparados por el software de cómputos Figura. Este método es ampliamente conocido como interferometría de desplazamiento de fase (PSI).

La mayoría de los interferómetros de prueba óptica ahora usan técnicas de cambio de fase no solo por su alta resolución sino también porque el cambio de fase es una forma rápida de obtener la información del interferograma en la computadora con alta precisión. También el uso de esta técnica hace que el ruido inherente en el proceso de toma de datos sea muy bajo. Como resultado en un buen ambiente se pueden realizar mediciones de altura superficial angstrom o sub-angstrom. Como se dijo anteriormente, en la interferometría de desplazamiento de fase la diferencia de fase entre los haces interferentes se cambia a una velocidad constante a medida que se lee el detector. Una vez que se determina la fase a través del campo de interferencia, se puede determinar la distribución de altura correspondiente en la superficie de la muestra. La distribución de fase\(φ(x, y)\) se registra mediante el uso de la cámara CCD.
Vamos a asignar\(A(x, y)\),\(B(x, y)\),\(C(x, y)\) y\(D(x, y)\) a las intensidades de luz de interferencia resultantes que se corresponden con pasos de desplazamiento de fase de 0, π/2, π y 3π/2. Estas intensidades se pueden obtener moviendo el espejo de referencia a través de desplazamientos de λ/8, λ/4 y 3λ/8, respectivamente. Las ecuaciones para las intensidades resultantes serían:
\[ A(x,y)\ =\ I_{1}(x,y)\ +\ I_{2}(x,y) \cos(\alpha (x,y)) \label{11} \]
\[ B(x,y)\ =\ I_{1}(x,y)\ -\ I_{2}(x,y) \sin(\alpha (x,y)) \label{12} \]
\[ C(x,y)\ =\ I_{1}(x,y)\ -\ I_{2}(x,y) \cos(\alpha (x,y)) \label{13} \]
\[ D(x,y)\ =\ I_{1}(x,y)\ +\ I_{2}(x,y) \sin(\alpha (x,y)) \label{14} \]
donde\(I_1(x,y)\) y\(I_2(x,y)\) son dos vigas superpuestas de dos puntos simétricos en la superficie de prueba y la referencia respectivamente. Resolviendo Ecuaciones\ ref {11} -\ ref {14}, el mapa\(φ(x, y)\) de fases de una superficie de muestra vendrá dado por la relación:
\[ \psi (x,y)\ =\ \frac{B(x,y)\ -\ D(x,y)}{A(x,y)\ -\ C(x,y)} \label{15} \]
Una vez que se determina la fase a través del campo de interferencia píxel a píxel en una matriz CCD bidimensional, la distribución/contorno de altura local\(h(x, y)\), en la superficie de prueba viene dada por
\[ h(x,y)\ =\ \frac{\lambda}{4\pi } \psi (x,y) \label{16} \]
Normalmente, la franja resultante puede tener la forma de un patrón de franjas lineales ajustando la posición relativa entre el espejo de referencia y las superficies de muestra. Por lo tanto, cualquier franja de interferencia distorsionada indicaría un perfil/contorno local de la superficie de prueba.
Es importante señalar que el objetivo Mireau está montado en un PZT (actuador piezoeléctrico) controlado por circuito cerrado capacitivo para permitir la implementación precisa del desplazamiento de fase. El PZT se basa en el efecto piezoeléctrico referido al potencial eléctrico generado al aplicar presión al material piezoeléctrico. Este tipo de materiales se utilizan para convertir la energía eléctrica en energía mecánica y viceversa. El movimiento preciso que resulta cuando se aplica un potencial eléctrico a un material piezoeléctrico tiene una importancia para el nanoposicionamiento. Los actuadores que utilizan el efecto piezoeléctrico han estado disponibles comercialmente desde hace 35 años y en ese tiempo han transformado el mundo del posicionamiento de precisión y el control de movimiento.
El interferómetro de barrido vertical también tiene otro nombre; la interferometría de luz blanca (WLI) debido al uso de la luz blanca como fuente de luz. Con este tipo de fuente se produce un sistema de franjas separado para cada longitud de onda, y la intensidad resultante en cualquier punto de la superficie examinada se obtiene sumando estos patrones individuales. Debido al ancho de banda amplio de la fuente, la longitud coherente L de la fuente es corta:
\[ L\ =\ \frac{\lambda ^{2}}{n \Delta \lambda} \label{17} \]
donde λ es la longitud de onda central, n es el índice de refracción del medio, ∆λ es el ancho espectral de la fuente. De esta manera, solo se pueden obtener franjas de buen contraste cuando las longitudes de las trayectorias de haces interferentes están cerradas entre sí. Si variaremos la longitud de una trayectoria de un haz reflejado a partir de la muestra, la altura de una muestra se puede determinar observando la posición para la cual un contraste de flecos es máximo. En este caso, el patrón de interferencia solo existe sobre una profundidad muy baja de la superficie. Cuando variamos una trayectoria de haz muestreo-reflejado también movemos la muestra en dirección vertical para obtener la fase en la que se logrará la máxima intensidad de flecos. Esta fase se convertirá en altura de un punto en la superficie de la muestra.
La combinación de tecnología de desplazamiento de fase con fuente de luz blanca proporciona una herramienta muy potente para medir la topografía de superficies bastante rugosas con la amplitud en alturas aproximadamente y la precisión de hasta 1-2 nm. A través de un paquete de software desarrollado para evaluar cuantitativamente el interferograma resultante, el sistema propuesto puede recuperar el perfil superficial y la topografía de los objetos de muestra Figura\(\PageIndex{5}\).

Comparación de métodos comunes para determinar la topografía superficial: SEM, AFM y VSI
Excepto los métodos interferométricos descritos anteriormente, existen varias otras técnicas microscópicas para estudiar la topografía de la superficie cristalina. Los más comunes son la microscopía electrónica de barrido (SEM) y la microscopía de fuerza atómica (AFM). Todas estas técnicas se utilizan para obtener información sobre la estructura de la superficie. Sin embargo, se diferencian entre sí por los principios físicos en los que se basaron.
Microscopía Electrónica de Barrido
El SEM nos permite obtener imágenes de topografía superficial con una resolución muy superior a la de los microscopios de luz convencionales. También es capaz de proporcionar información sobre otras características superficiales como composición química, conductividad eléctrica etc, ver Figura\(\PageIndex{6}\). Todos los tipos de datos son generados por el reflejo de haces de electrones acelerados de la superficie de la muestra. Cuando los electrones golpean la superficie de la muestra, pierden su energía por dispersión aleatoria repetida y adsorción dentro de una capa externa en una profundidad que varía de 100 nm a 5 micras.

El grosor de esta capa externa también se conoce como capa interactiva depende de la energía de los electrones en el haz, composición y densidad de una muestra. Resultado de la interacción entre el haz de electrones y la superficie proporciona varios tipos de señales. El tipo principal son los electrones dispersos secundarios o inelásticos. Se producen como resultado de la interacción entre el haz de electrones y electrones débilmente unidos en la banda de conducción de la muestra. Los electrones secundarios son expulsados de los orbitales k de los átomos dentro de la capa superficial de espesor de unos pocos nanómetros. Esto se debe a que los electrones secundarios son electrones de baja energía (<50 eV), por lo que solo aquellos formados dentro de los primeros nanómetros de la superficie de la muestra tienen suficiente energía para escapar y ser detectados. Los electrones retrodispersados secundarios proporcionan la señal más común para investigar la topografía superficial con resolución lateral de hasta 0.4 - 0.7 nm.
Los electrones de haz de alta energía son elásticos dispersos desde la superficie. Este tipo de señal da información sobre la composición química de la superficie porque la energía de los electrones retrodispersados depende del peso de los átomos dentro de la capa de interacción. También este tipo de electrones pueden formar electrones secundarios y escapar de la superficie o viajar padre hacia la muestra que el secundario. La imagen SEM formada es el resultado de la intensidad de la emisión de electrones secundarios de la muestra en cada punto de datos x, y durante el barrido de la superficie.
Microscopía de Fuerza Atómica
La AFM es una herramienta muy popular para estudiar la disolución superficial. La configuración de AFM consiste en escanear una punta afilada en el extremo de un voladizo flexible que se mueve a través de una superficie de muestra. Las puntas suelen tener un radio de extremo de 2 a 20 nm, dependiendo del tipo de punta. Cuando la punta toca la superficie las fuerzas de estas interacciones conducen a la deflexión de un voladizo. La interacción entre la punta y la superficie de la muestra implica fuerzas de contacto mecánicas, fuerzas de van der Waals, fuerzas capilares, unión química, fuerzas electrostáticas, fuerzas magnéticas, etc. La deflexión de un voladizo generalmente se mide reflejando un rayo láser de la parte posterior del voladizo en una división detector de fotodiodos. Un dibujo esquemático de AFM se puede ver en la Figura\(\PageIndex{7}\). Los dos modos de operación más utilizados son el modo de contacto AFM y el modo de toma AFM, que se realizan en ambientes de aire o líquido.

Trabajando bajo el modo de contacto AFM escanea la muestra mientras monitorea el cambio en la deflexión en voladizo con el detector de fotodiodo dividido. Loop mantiene una reflexión constante en voladizo moviendo verticalmente el escáner para obtener una señal constante. La distancia que recorre el escáner moviéndose verticalmente en cada punto de datos x, y es almacenada por la computadora para formar la imagen topográfica de la superficie de la muestra. Trabajando bajo el modo de golpeteo AFM oscila el voladizo a su frecuencia de resonancia (normalmente ~ 300 kHz) y “toca” ligeramente la punta en la superficie durante el escaneo. Las fuerzas electrostáticas aumentan cuando la punta se acerca a la superficie de la muestra, por lo tanto la amplitud de la oscilación disminuye. El método de deflexión láser se utiliza para detectar la amplitud de la oscilación en voladizo. Similar al modo de contacto, el bucle de retroalimentación mantiene una amplitud de oscilación constante moviendo el escáner verticalmente en cada punto de datos x, y. El registro de este movimiento forma la imagen topográfica. La ventaja del modo de golpeteo sobre el modo de contacto es que elimina las fuerzas laterales de cizallamiento presentes en el modo de contacto. Esto permite el modo de golpeteo para obtener imágenes de superficies blandas, frágiles y adhesivas sin dañarlas, mientras que el modo de trabajo bajo contacto permite que se produzcan daños.
Comparación de Técnicas
Todas las técnicas descritas anteriormente son ampliamente utilizadas en el estudio de la nano- y micromorfología superficial. Sin embargo, cada método tiene sus propias limitaciones y la elección adecuada de la técnica analítica depende de las características de la superficie analizada y los objetivos primarios de la investigación.
Todas estas técnicas son capaces de obtener una imagen de una superficie de muestra con bastante buena resolución. La resolución lateral de VSI es mucho menor, luego para otras técnicas: 150 nm para VSI y 0.5 nm para AFM y SEM. La resolución vertical de AFM (0.5) es mejor que para VSI (1 - 2 nm), sin embargo, VSI es capaz de medir un alto rango vertical de alturas (1 mm) lo que permite estudiar incluso superficies muy rugosas. Por el contrario, la AFM nos permite medir solo superficies bastante lisas debido a su rango de barrido vertical relativamente pequeño (7 µm). SEM tiene menos resolución, que AFM porque requiere recubrimiento de un material conductor con el espesor dentro de varios nm.
La ventaja significativa de VSI es que puede proporcionar un gran campo de visión (845 × 630 µm para el objetivo 10x) de las superficies probadas. Estudios recientes de características de rugosidad superficial mostraron que los parámetros de rugosidad superficial aumentan con el aumento del campo de visión hasta alcanzar un tamaño crítico de 250,000 µm. Este valor es mayor que el campo de visión máximo producido por AFM (100 × 100 µm) pero se puede obtener fácilmente por VSI. SEM también es capaz de producir imágenes con gran campo de visión. Sin embargo, SEM es capaz de proporcionar solo imágenes 2D de un escaneo, mientras que AFM y VSI nos permiten obtener imágenes 3D. Hace más complicado el análisis cuantitativo de la topografía superficial, por ejemplo, la topografía de las membranas se estudia mediante imágenes de sección transversal y vista superior.
| VSI | AFM | SEM | |
|---|---|---|---|
| Resolución lateral | 0.5 - 1.2µm | 0.5 nm | 0.5 - 1 nm |
| Resolución Vertical | 2 nm | 0.5 Å | Solo imágenes 2D |
| Campo de visión | 845 x 630 µm (objetivo 10x) | 100 x 100 µm | 1 - 2 mm |
| Rango vertical de escaneo | 1 mm | 10 µm | - |
| Preparación de la Muestra | - | - | Recubrimiento requerido de un material conducido |
| Entorno requerido | Aire | Aire, líquido | Vacío |
Estudio experimental de procesos superficiales mediante técnicas microscópicas
Las limitaciones de cada técnica descrita anteriormente son críticamente importantes para elegir la técnica adecuada para el estudio de los procesos superficiales. Exploremos la aplicación de estas técnicas para estudiar la disolución de cristales.
Cuando la materia cristalina se disuelve, los cambios de la topografía de la superficie cristalina se pueden observar mediante técnicas microscópicas. Si vamos a aplicar una máscara no reactiva (silicio por ejemplo) sobre la superficie del cristal y colocaremos una muestra cristalina en el reactor experimental entonces obtenemos dos tipos de superficies: disolviendo y permaneciendo igual o sin reaccionar. Después de algún periodo de tiempo la superficie cristalina comienza a disolverse y cambiar su nivel z. Para estudiar estos cambios ex situ podemos sacar una muestra de la celda de reacción luego retirar una máscara y medir la diferencia de altura promedio Δh bar entre las áreas no reaccionadas y disueltas. Las alturas promedio de las áreas disueltas y no reaccionadas se obtienen a través del procesamiento digital de datos obtenidos por microscopios. La velocidad de retroceso superficial normal v SNR durante el intervalo de tiempo ∆t se define por\ ref {18}
\[ \nu _{SNR}\ =\ \frac{\Delta \hbar}{\Delta t} \label{18} \]
Dividiendo esta velocidad por el volumen molar (cm 3 /mol) da una velocidad de disolución global en las unidades familiares de moles por unidad de área por unidad de tiempo:
\[ R\ =\ \frac{\nu _{SNR}}{\bar{V}} \label{19} \]
Este método nos permite obtener valores experimentales de velocidades de disolución con solo medir con precisión las alturas medias de la superficie. Además, usando este método podemos medir las tasas de disolución local en pozos de grabado monitoreando los cambios en el volumen y la densidad de las picaduras de grabado a través de la superficie a lo largo del tiempo. La técnica VSI es capaz de realizar estas mediciones debido al amplio rango vertical de escaneo. Para obtener valores precisos de tasas que no dependan de la observación del lugar de la superficie cristalina, necesitamos medir suficientes áreas grandes. La técnica VSI proporciona datos de áreas que son lo suficientemente grandes como para estudiar superficies con dinámicas de disolución heterogéneas y obtener velocidades de disolución promedio. Por lo tanto, VSI permite medir las tasas de retroceso normal de la superficie durante la disolución y observar la formación, crecimiento y distribución de pozos de grabado en la superficie.
Sin embargo, si el mecanismo de disolución está controlado por la dinámica de pasos atómicos y sitios de torcedura dentro de una superficie atómica lisa, la observación del proceso de disolución necesita utilizar una técnica más precisa. La AFM es capaz de proporcionar información sobre los cambios en la morfología escalonada in situ cuando ocurre la disolución. Por ejemplo, se puede estudiar la respuesta inmediata de la superficie disuelta al cambio de las condiciones ambientales (concentraciones de iones en la solución, pH etc.) mediante el uso de AFM.
El SEM también se utiliza para examinar micro y nanotextura de superficies sólidas y estudiar procesos de disolución. Este método nos permite observar grandes áreas de superficie cristalina con alta resolución lo que hace posible medir una gran variedad de superficies. La desventaja significativa de este método es el requisito de cubrir la muestra examinada por sustancia conductora lo que limita la resolución de SEM. La otra desventaja del SEM es que el análisis se realiza en vacío. Técnica reciente, SEM ambiental o ESEM supera estos requisitos y hace posible incluso examinar líquidos y materiales biológicos. La tercera desventaja de esta técnica es que produce sólo imágenes 2D. Esto crea algunas dificultades para medir Δh bar dentro del área de disolución. Una de las ventajas de esta técnica es que es capaz de medir no solo la topografía superficial sino también la composición química y otras características superficiales de la superficie. Este hecho se utiliza para monitorear el cambio en la composición química durante la disolución.
Interferometría de polarización dual para caracterización de película delgada
Visión general
A medida que los intereses de investigación comienzan a enfocarse en dimensiones progresivamente más pequeñas, la necesidad de técnicas de caracterización a nanoescala ha visto un fuerte aumento en la demanda. Además, el amplio alcance de la nanotecnología en todos los campos de la ciencia ha perpetuado la aplicación de técnicas de caracterización a multitud de disciplinas. La interferometría de polarización dual (DPI) es un ejemplo de una técnica desarrollada para resolver un problema específico, pero se expandió y utilizó para caracterizar campos que van desde la ciencia de superficie, los estudios de proteínas y la cristalografía. Con un instrumento óptico simple, DPI puede realizar detección sin etiquetas del índice de refracción y espesor de capa en tiempo real, lo que proporciona información vital sobre un sistema a nanoescala, incluyendo la elucidación de las relaciones estructura-función.
Historia
DPI fue concebido en 1996 por el Dr. Neville Freeman y el Dr. Graham Cross (Figura\(\PageIndex{8}\)) cuando reconocieron la necesidad de medir el índice de refracción y el espesor de la capa de adición simultáneamente en membranas proteicas para obtener una verdadera comprensión de la dinámica del sistema. Ellos patentaron la técnica en 1998, y el instrumento fue comercializado por Farfield Group Ltd. en 2000.

Freeman y Cross dieron a conocer la primera publicación completa que describe la técnica en 2003, donde optaron por medir sistemas de proteínas conocidos y comparar sus datos con la cristalografía de rayos X y los datos de reflexión de neutrones. El primer sistema que estudiaron fue sulfo-NHS-LC-biotina recubierta con estreptavidina y un anticuerpo de captura de péptidos biotinilados, y el segundo sistema fue BS 3 recubierto con anti-HSA. Las estructuras moleculares se muestran en la Figura\(\PageIndex{9}\). Sus resultados mostraron una buena concordancia con los espesores de capa conocidos, y el método mostró claras ventajas sobre la reflexión de neutrones y la resonancia de plasmón superficial. En la Figura y Figura se muestra un esquema y una imagen del instrumento utilizado por Freeman\(\PageIndex{10}\) y Cross en esta publicación\(\PageIndex{11}\), respectivamente.
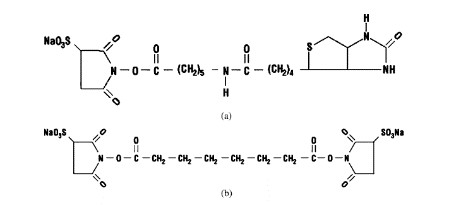


Instrumentación
Teoría
La potencia óptica de DPS proviene de la capacidad de medir dos patrones de franjas de interferencia diferentes simultáneamente en tiempo real. Los cambios de fase en estos patrones de franja son el resultado de cambios en el índice de refracción y el espesor de capa que pueden ser detectados por el interferómetro de guía de ondas, y la resolución de estos patrones de interferencia proporciona valores de índice de refracción y espesor
Óptica
En la Figura se muestra una representación del interferómetro\(\PageIndex{12}\). El interferómetro está compuesto por una guía de ondas de losa simplificada, que guía una onda de luz en una dirección transversal sin dispersión. Una amplia luz láser se ilumina en la faceta lateral de guías de onda apiladas separadas por una capa de revestimiento, donde las guías de onda actúan como una capa de detección y una capa de referencia que producen un patrón de interferencia en un campo eléctrico en descomposición (evanescente).

Una representación completa de la teoría e instrumentación DPI se muestra en la Figura\(\PageIndex{13}\) y Figura\(\PageIndex{14}\), respectivamente. Las mediciones del espesor de la capa y del índice de refracción se determinan midiendo simultáneamente dos cambios de fase en el sistema debido a que se permiten polarizaciones tanto transversalmente eléctricas como transversalmente magnéticas a través de las guías de onda. Los cambios de fase en cada polarización de la onda de luz son desplazamientos laterales del pico de onda a partir de un pico de referencia dado. Los cambios de fase son causados por cambios en el índice de refracción y espesor de capa que resultan de fluctuaciones moleculares en la muestra. La conmutación entre polarizaciones transversal-eléctrica y transversal-magnética ocurre muy rápidamente a 2 ms, donde el mecanismo de conmutación es realizado por una placa de onda de cristal líquido. Esto permite obtener mediciones en tiempo real de los parámetros simultáneamente.
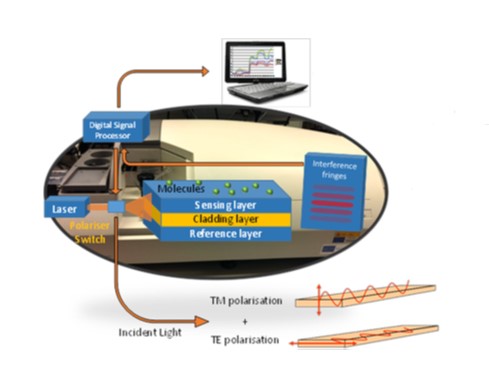

Comparación de DPI con Otras Técnicas
Evaluaciones Iniciales DPI
Las primeras técnicas rigurosamente comparadas con DPI fueron la reflexión de neutrones (NR) y la difracción de rayos X. Estos estudios demostraron que DPI tuvo una precisión muy alta de 40 pm, la cual es comparable a NR y superior a la difracción de rayos X. Adicionalmente, DPI puede proporcionar información en tiempo real y condiciones similares a un entorno in vivo, y los requisitos instrumentales son mucho más simples que los de NR. Sin embargo, la NR y la difracción de rayos X pueden proporcionar información estructural que DPI no puede determinar.
Comparación DPI con Técnicas Analíticas Ortogonales
Desde las evaluaciones iniciales se han realizado comparaciones entre DPI y técnicas alternativas, con técnicas que incluyen resonancia de plasmón superficial (SPR), microscopía de fuerza atómica (AFM) y microbalanza de cristal de cuarzo con monitoreo de disipación (QCM-D).
La SPR está bien establecida para caracterizar la adsorción de proteínas y se ha utilizado antes de que se desarrollara el DPI. Estas técnicas son muy similares en que ambas utilizan un elemento óptico basado en un campo evanescente, pero difieren mucho en el método de cálculo de la masa de proteína adsorbida. Las pruebas rigurosas mostraron que ambas pruebas dan resultados muy precisos, pero sus fortalezas difieren. Debido a que SPR utiliza pruebas puntuales con un área de 0.26 mm2 mientras que DPI utiliza las mediciones promedio sobre la longitud de todo el chip de 15 mm, SPR se recomienda para su uso en estudios cinéticos donde la difusión está involucrada. Sin embargo, DPI muestra una precisión mucho mayor que SPR al medir el índice de refracción y el grosor de la capa.
La microscopía de fuerza atómica es una técnica analítica muy diferente a la DPI porque es un tipo de microscopía utilizada para la caracterización de superficies de alta resolución. Por lo tanto, AFM y DPI son adecuados para ser utilizados en conjunto porque AFM puede proporcionar estructuras moleculares precisas y mapeo de superficie, mientras que DPI proporciona espesor de capa que AFM no puede determinar.
QCM-D es una técnica que se puede utilizar con DPI para proporcionar datos complementarios. QCM-D difiere del DPI al calcular tanto la masa del disolvente como la masa de la capa de proteína adsorbida. Estas técnicas se pueden utilizar juntas para determinar la cantidad de hidratación en la capa adsorbida. QCM-D también puede cuantificar la conformación supramolecular del adlayer usando cálculos de disipación de energía, mientras que DPI puede detectar estos cambios conformacionales mediante birrefringencia, haciendo estas técnicas ortogonales. Una forma en que DPI es superior a QCM-D es que estas últimas técnicas pierden precisión a medida que la película se vuelve muy delgada, mientras que DPI conserva la precisión en toda la escala de angstrom.
En la Tabla se muestra una representación tabulada de estas técnicas y su capacidad para medir detalles estructurales, condiciones in vivo y datos en tiempo real\(\PageIndex{2}\).
| Técnica | Tiempo Real | Cerca de In-vivo | Detalles Estructurales |
|---|---|---|---|
| QCM-D | Sí | Sí | Mediano |
| SPR | Sí | Sí | Bajo |
| Rayos X | No | No | Muy alto |
| AFM | No | No | Alto |
| NR | No | Sí | Alto |
| DPI | Sí | Sí | Mediano |
Aplicaciones de DPI
Estudios de Proteínas
El DPI se ha aplicado con mayor intensidad a los estudios de proteínas. Se ha utilizado para dilucidar la cristalización de la membrana, la orientación de las proteínas en una membrana y los cambios conformacionales. También se ha utilizado para estudiar las interacciones proteína-proteína, las interacciones proteína-anticuerpo y la estequiometría de eventos de unión.
Estudios de Película Delgada
Desde su establecimiento utilizando estudios de interacción de proteínas, DPI ha visto sus aplicaciones expandidas para incluir estudios de película delgada. El DPI se comparó con estudios de elipsometría y QCM-D para indicar que se puede aplicar a películas delgadas heterogéneas mediante la aplicación de fórmulas analíticas revisadas para estimar el espesor, índice de refracción y coeficiente de extinción de películas heterogéneas que absorben la luz. Se desarrolló un modelo de distribución de densidad no uniforme y se probó sobre polietilenimina depositada sobre sílice y comparada con mediciones QCD-M. Adicionalmente, este modelo revisado fue capaz de calcular la masa de múltiples especies de moléculas en películas compuestas, incluso si las moléculas absorbieron diferentes cantidades de luz. Esta información es valiosa para proporcionar la composición de la superficie. La estructura de la polietilenimina utilizada para formar una película adsorbente se muestra en la Figura\(\PageIndex{15}\).

Un desafío de medir el espesor de capa en películas delgadas como la polietilenimina es que el campo evanescente de DPI creará mediciones inexactas en películas no homogéneas a medida que aumenta el grosor de la película. Se observó un error de aproximadamente 5% cuando el espesor de la capa se incrementó a 90 nm. Los datos de este estudio que determinan las densidades a lo largo de la película de polietilenimina se muestran en la Figura\(\PageIndex{16}\).
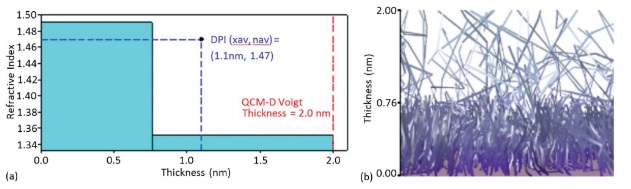
Estudios de adsorción en capa fina
Similar a los estudios de caracterización de películas delgadas, las capas delgadas de polímeros adsorbidos también se han dilucidado usando DPI. Se ha demostrado que dos conformaciones de adsorción diferentes de poliacrilamida se forman sobre resina, lo que proporciona información útil sobre los comportamientos de adsorción del polímero. Esta información es industrialmente importante porque la poliacrilamida es ampliamente utilizada en la industria petrolera, y se sabe que la adsorción de poliacrilamida sobre resina afecta la estabilidad interfacial aceite/agua.
La cinética de adsorción inicial y las conformaciones también se iluminaron mediante DPI en polielectrolitos de cepillo de botella. Los polielectrolitos de cepillo de botella se muestran en la Figura\(\PageIndex{17}\). Se demostró que los polielectrolitos con alta densidad de carga inicialmente adsorbidos en capas que eran paralelas a la superficie, pero como los polielectrolitos fueron reemplazados por especies de baja densidad de carga, la alineación cambió para preferir la disposición perpendicular a la superficie.

Estudios de biosensión Hg 2+
En 2009, Wang et al. demostró que el DPI podría ser utilizado para la detección de moléculas pequeñas. En su primer estudio describiendo este uso de DPI, utilizaron ADN monocatenario que era rico en timina para complejar iones Hg2+. Cuando el ADN se complejó con Hg2+, el ADN se transformó de una estructura de espiral aleatoria a una estructura de horquilla. Este cambio en la estructura podría ser detectado por DPI a concentraciones de Hg2+ menores a la concentración umbral permitida en el agua potable, lo que indica la sensibilidad de este método sin etiquetas para la detección de Hg2+. Se indicó alta selectividad cuando los autores no observaron cambios estructurales similares para los iones Mg2+, Ca2+, Mn2+, Fe3+, Cd2+, Co2+, Ni2+, Zn2+ o Pb2+. En la Figura se muestra una descripción gráfica de este experimento. Wang et al. demostraron posteriormente que la biosensión de moléculas pequeñas y otros cationes metálicos se puede lograr usando otras formas de ADN funcionalizado que se unen específicamente a los analitos deseados. Ejemplos de moléculas detectadas de esta manera se muestran en la Figura\(\PageIndex{18}\).




