9.2: Microscopía de Fuerza Atómica (AFM)
- Page ID
- 70910
La microscopía de fuerza atómica (AFM) es una forma de microscopía de sonda de barrido de alta resolución, también conocida como microscopía de fuerza de barrido (SFM). El instrumento utiliza un voladizo con una punta afilada en el extremo para escanear sobre la superficie de la muestra (Figura\(\PageIndex{1}\)). A medida que la sonda escanea sobre la superficie de la muestra, las fuerzas atractivas o repulsivas entre la punta y la muestra, generalmente en forma de fuerzas de Van Der Waal pero también pueden ser varias otras como electrostáticas e hidrofóbicas/hidrófilas, provocan una deflexión del voladizo. La deflexión se mide mediante un láser (Figura\(\PageIndex{2}\)) que se refleja en el voladizo en fotodiodos. A medida que uno de los fotodiodos recoge más luz, crea una señal de salida que se procesa y proporciona información sobre la flexión vertical del voladizo. Estos datos se envían luego a un escáner que controla la altura de la sonda a medida que se mueve a través de la superficie. La varianza de altura aplicada por el escáner puede ser utilizada para producir una representación topográfica tridimensional de la muestra.
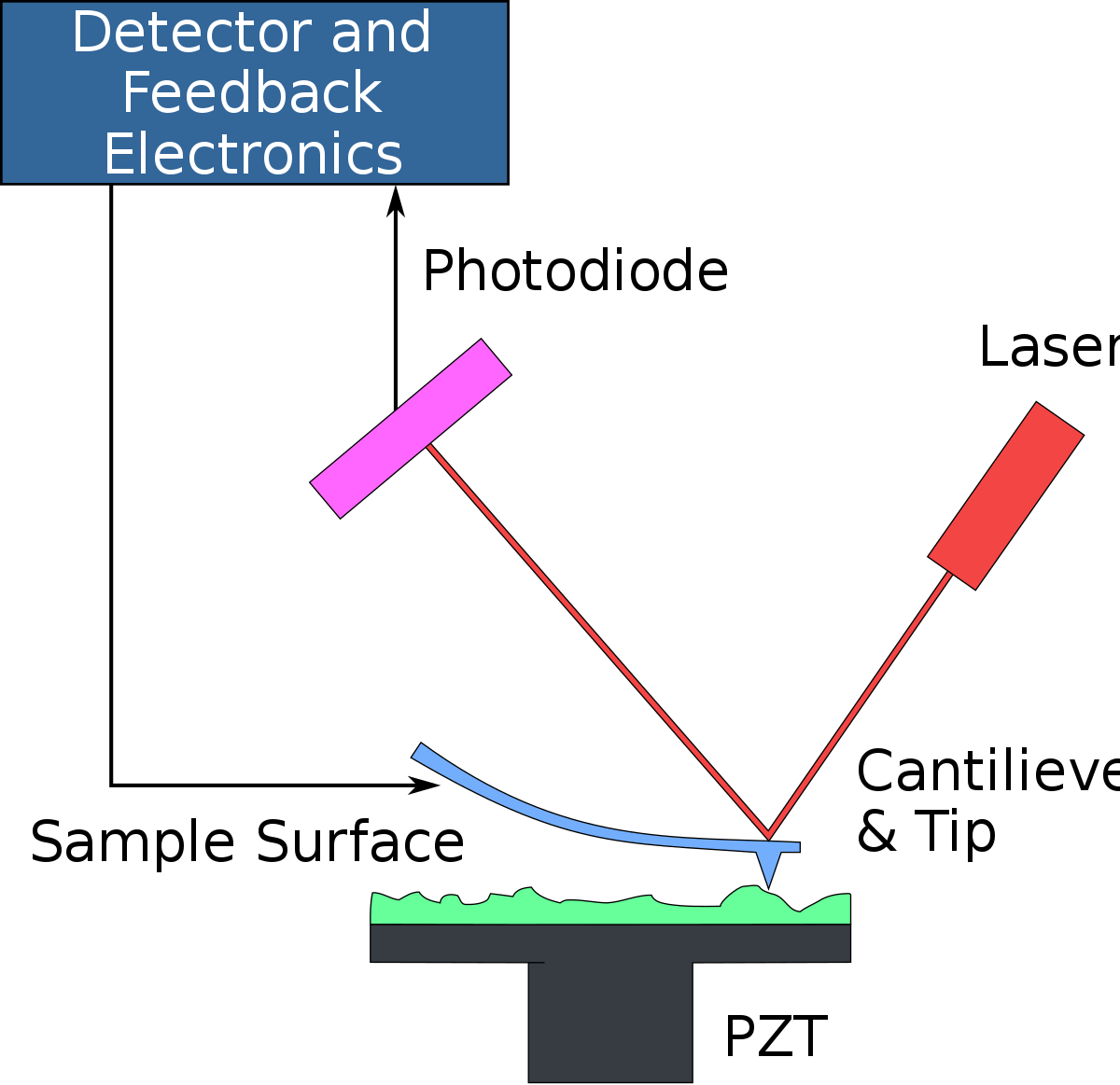
Modos de Operación
Modo de contacto
El método del modo de contacto utiliza una fuerza constante para las interacciones punto-muestra manteniendo una desviación constante de la punta (\(\PageIndex{2}\)Figura. La punta comunica la naturaleza de las interacciones que la sonda está teniendo en la superficie a través de bucles de retroalimentación y el escáner mueve la sonda completa para mantener el deflexión original del voladizo. La fuerza constante se calcula y mantiene usando la Ley de Hooke,\ ref {2}. Esta ecuación relaciona la fuerza (F), la constante elástica (k) y la deflexión en voladizo (x). Las constantes de fuerza suelen oscilar entre 0.01 y 1.0 N/m. El modo de contacto generalmente tiene los tiempos de escaneo más rápidos pero puede deformar la superficie de la muestra. También es sólo el único modo que puede alcanzar la “resolución atómica”.
\[ F\ =\ -kx \label{1} \]

Modo de roscado
En el modo de golpeteo el voladizo se hace oscilar externamente a su frecuencia de resonancia fundamental (Figura\(\PageIndex{3}\)). Se utiliza un piezoeléctrico en la parte superior del voladizo para ajustar la amplitud de oscilación a medida que la sonda escanea a través de la superficie. Se miden las desviaciones en la frecuencia o amplitud de oscilación debidas a interacciones entre la sonda y la superficie, y se proporciona información sobre la superficie o tipos de material presentes en la muestra. Este método es más suave que el AFM de contacto ya que la punta no se arrastra a través de la superficie, pero sí requiere tiempos de escaneo más largos. También tiende a proporcionar mayor resolución lateral que la AFM de contacto.

Modo sin contacto
Para el modo sin contacto el voladizo se hace oscilar justo por encima de su frecuencia de resonancia y esta frecuencia disminuye a medida que la punta se acerca a la superficie y experimenta las fuerzas asociadas con el material (Figura\(\PageIndex{4}\)). La distancia promedio punta a muestra se mide a medida que la frecuencia o amplitud de oscilación se mantiene constante, que luego se puede usar para obtener imágenes de la superficie. Este método ejerce muy poca fuerza sobre la muestra, lo que prolonga la vida útil de la punta. Sin embargo, por lo general no proporciona muy buena resolución a menos que se coloque bajo un fuerte vacío.

Limitaciones Experimentales
Un problema común que se ve en las imágenes AFM es la presencia de artefactos que son distorsiones de la topografía real, generalmente debido a problemas con la sonda, escáner o procesamiento de imágenes. El AFM escanea lentamente, lo que lo hace más susceptible a las fluctuaciones externas de temperatura que conducen a la deriva térmica. Esto conduce a artefactos y distancias inexactas entre las características topográficas.
También es importante considerar que la punta no es perfectamente nítida y por lo tanto puede no proporcionar la mejor relación de aspecto, lo que lleva a una convolución de la verdadera topografía. Esto hace que las características aparezcan demasiado grandes o demasiado pequeñas ya que el ancho de la sonda no puede moverse con precisión alrededor de las partículas y agujeros en la superficie. Es por esta razón que las puntas con radios de curvatura más pequeños proporcionan una mejor resolución en la imagen. La punta también puede producir imágenes falsas e imágenes mal contrastadas si es contundente o rota.
El movimiento de partículas en la superficie debido al movimiento del voladizo puede provocar ruido, que forma rayas o bandas en la imagen. Los artefactos también se pueden hacer por la punta siendo de proporciones inadecuadas en comparación con la superficie que se escanea. Es por esta razón que es importante utilizar la sonda ideal para la aplicación particular.
Tamaño y preparación de la muestra
El tamaño de la muestra varía con el instrumento pero un tamaño típico es de 8 mm por 8 mm con una altura típica de 1 mm. Las muestras sólidas presentan un problema para la AFM ya que la punta puede desplazar el material a medida que escanea la superficie. Las soluciones o dispersiones son las mejores para aplicar una capa de material lo más uniforme posible para obtener el valor más preciso de las alturas de las partículas. Esto generalmente se hace recubriendo por rotación la solución sobre mica recién cortada que permite que las partículas se adhieran a la superficie una vez que se haya secado.
Aplicaciones de AFM
AFM es particularmente versátil en sus aplicaciones ya que se puede utilizar en temperaturas ambiente y en muchos entornos diferentes. Se puede utilizar en muchas áreas diferentes para analizar diferentes tipos de muestras como semiconductores, polímeros, nanopartículas, biotecnología y células entre otros. La aplicación más común de la AFM es para estudios morfológicos con el fin de lograr una comprensión de la topografía de la muestra. Dado que es común que el material esté en solución, el AFM también puede dar al usuario una idea de la capacidad del material para dispersarse así como la homogeneidad de las partículas dentro de esa dispersión. También puede proporcionar mucha información sobre las partículas que se están estudiando, como el tamaño de partícula, el área de superficie, las propiedades eléctricas y la composición química. Ciertas puntas son capaces de determinar las principales propiedades mecánicas, magnéticas y eléctricas del material. Por ejemplo, en microscopía de fuerza magnética (MFM) la sonda tiene un recubrimiento magnético que detecta interacciones magnéticas, electrostáticas y atómicas con la superficie. Este tipo de escaneo se puede realizar en modo estático o dinámico y representa la estructura magnética de la superficie.
AFM de Nanotubos de Carbono
La microscopía de fuerza atómica se suele utilizar para estudiar la morfología topográfica de estos materiales. Al medir el espesor del material es posible determinar si se produjo el agrupamiento y en qué grado. También se pueden medir otras dimensiones de la muestra como la longitud y anchura de los tubos o haces. También es posible detectar impurezas, grupos funcionales (Figura\(\PageIndex{5}\)), o catalizador restante mediante el estudio de las imágenes. Se han encontrado diversos métodos de producción de nanotubos y cada uno demuestra un perfil ligeramente diferente de homogeneidad y pureza. Estas impurezas pueden ser metal recubierto de carbono, carbono amorfo u otros alótropos de carbono como fulerenos y grafito. Estos hechos pueden ser utilizados para comparar la pureza y homogeneidad de las muestras realizadas a partir de diferentes procesos, así como monitorear estas características a medida que se realizan diferentes etapas o reacciones en el material. La distancia entre la punta y la superficie ha demostrado ser un parámetro importante en el modo sin contacto AFM y ha demostrado que si la punta se mueve más allá de la distancia umbral, aproximadamente 30 μm, puede mover o dañar los nanotubos. Si esto ocurre, no se puede realizar una caracterización útil debido a estas distorsiones de la imagen.
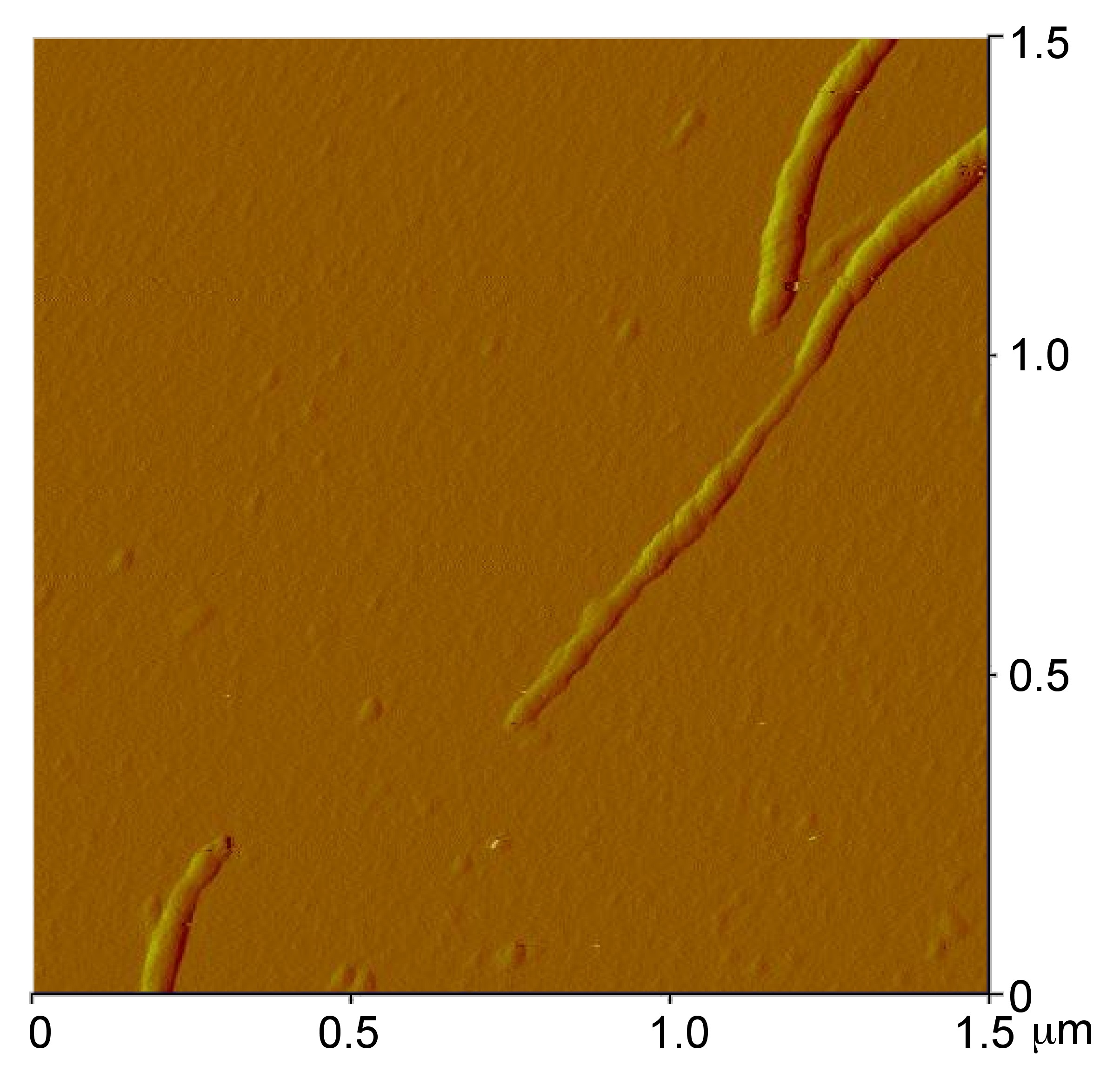
AFM de Fullerenos
La microscopía de fuerza atómica se aplica mejor a los agregados de fullerenos en lugar de a los individuales. Si bien el AFM puede realizar con precisión el análisis de altura de moléculas de fullereno individuales, tiene una resolución lateral pobre y es difícil representar con precisión el ancho de una molécula individual. Otro problema común que surge con AFM de contacto y películas depositadas de fullereno es que la punta desplaza racimos de fullerenos lo que puede conducir a discontinuidades en las imágenes de muestra.
Lo siguiente pretende ser una guía para el uso del sistema Nanoscope AFM dentro de la Autoridad de Equipos Compartidos en la Universidad de Rice (http://sea.rice.edu/). Sin embargo, se puede adaptar para instrumentos AFM similares.
Por favor, familiarícese con las Figuras. Se muestran todas las partes relevantes de la configuración de AFM.
Configuración Inicial
Iniciar sesión.
Encienda cada componente que se muestra en la Figura\(\PageIndex{6}\).
- El controlador que alimenta el alcance (el interruptor está en la parte posterior de la caja)
- El monitor de la cámara
- La fuente de luz blanca
Seleccionar el modo de imagen usando el interruptor selector de modo se encuentra en el lado izquierdo de la base del microscopio de fuerza atómica (AFM) (Figura\(\PageIndex{7}\), hay tres modos:
- Microscopía de túnel de barrido (STM)
- Microscopía de fuerza atómica/microscopía de fuerza lateral (AFM/LFM)
- Microscopía de fuerza atómica en modo roscado (TM-AFM)
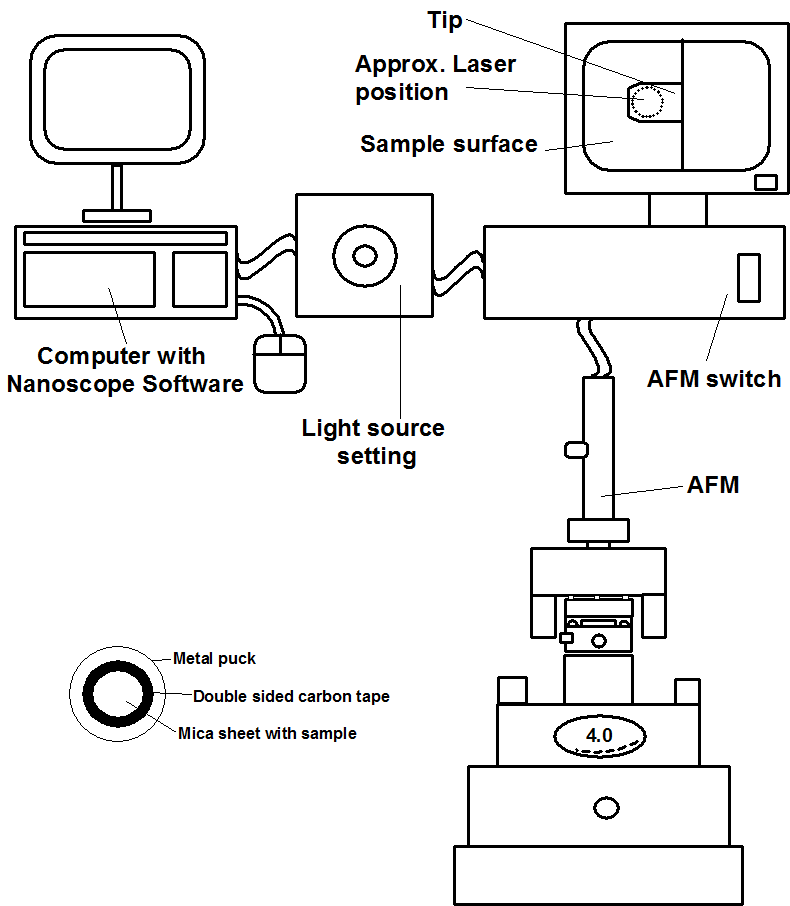
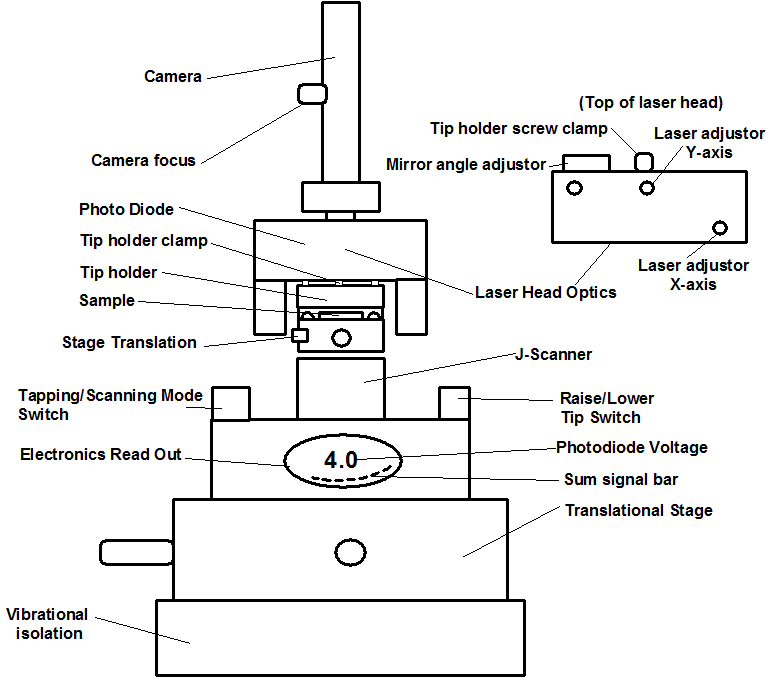
Preparación de Muestras
La mayoría de las muestras de partículas se obtienen mediante la inmovilización de las mismas sobre una lámina de mica, la cual se fija a un disco de metal (Figura\(\PageIndex{6}\)). Las muestras que se encuentran en un disolvente se depositan fácilmente. Para hacer un portamuestras se perfora una hoja de Mica y se pega a una cinta de carbono de doble cara en un disco de metal. Para asegurar una superficie prístina, la lámina de mica se escinde quitando la lámina superior con cinta Scotch™ para revelar una capa prístina debajo. La muestra puede ser recubierta por rotación sobre la mica o secada al aire.
El método de la capa de centrifugado;
- Use cinta adhesiva de carbono de doble cara para asegurar el disco en el revestidor giratorio.
- Cargue la muestra colando gota la solución de muestra sobre la superficie de mica.
- La muestra debe estar seca para asegurar que la punta permanezca limpia.
Montaje de Puck
- Coloque el disco de muestra en el portamuestras magnético y centre la muestra.
- Verificar que la cabeza de AFM esté suficientemente elevada para limpiar la muestra con la sonda. El plano de muestra es inferior al plano definido por las tres bolas. La muestra debe sentarse debajo de los nudos. Use la palanca en el lado derecho del escáner J para ajustar la altura. (N.B. las etiquetas arriba y abajo se refieren a la punta. “Tip up” mueve el portamuestras hacia abajo a seguridad, y la punta hacia abajo mueve la muestra hacia arriba. Tenga precaución al mover la muestra hacia arriba.)
- Seleccione el voladizo apropiado para el modo de imagen deseado. Las puntas son frágiles y caras (ca. $20 por propina) así que maneja con cuidado.
- Póngase en contacto con AFM utilizar una punta de nitruro de silicio (NP).
- Al tocar AFM se usa una punta de silicio (TESP).
Montaje y alineación de la punta
- Monte una punta con las pinzas finas apropiadas. Use las pinzas con cuidado para evitar posibles desalineaciones. Trabajar sobre una superficie blanca (un trozo de papel o una toalla de papel) para que el voladizo se pueda ver fácilmente. La parte delicada de la punta el voladizo se ubica en el extremo biselado y no debe manejarse en ese extremo (se muestra en la Figura\(\PageIndex{8}\)). Las puntas se almacenan en una cinta de gel pegajosa. Tenga cuidado, ya que al dejar caer la punta se romperá el voladizo. Piensa detenidamente en cómo te acercas a la punta con las pinzas. Generalmente agarrarlo por un lado es la mejor opción. Una vez que la punta está siendo sujetada por las pinzas, debe colocarse en la abrazadera del soporte de la punta. Con una mano sujetando las pinzas, use la otra mano para abrir el clip presionando hacia abajo sobre todo el soporte mientras está acostado sobre una superficie plana y dura. Una vez que el clip se eleva por presión hacia abajo inserte la punta (Figura\(\PageIndex{9}\) a). Asegúrese de que la punta esté firmemente asentada y que el extremo posterior esté en contacto con el extremo de la ranura de la sonda, hay un orificio circular en la abrazadera. Cuando la pinza sujeta la punta el agujero debe verse como una media luna, con la mitad llena con el extremo recto posterior de la punta. La ranura es más grande que la punta, así que intenta poner la punta en el mismo lugar cada vez que la reemplaces para mejorar la reproducibilidad.
- Coloque con cuidado el soporte de la punta en los tres nudos para sujetarlo suavemente en su lugar. Coloque el soporte en ángulo para evitar rasparlo contra la muestra (Figura\(\PageIndex{9}\) b).
- Apriete el tornillo de sujeción ubicado en la parte posterior de la cabeza de AFM para asegurar el soporte en voladizo y garantizar el contacto eléctrico. El tornillo está en la parte posterior de la cabeza del láser, en el centro.
- Encuentra el voladizo en la pantalla de video. Mueve la etapa traslacional para encontrarla.
- Ajuste la perilla de enfoque del microscopio óptico (ubicado encima de la cabeza AFM) para enfocar la punta en voladizo. Al apretar la perilla de enfoque se mueve la cámara hacia arriba. Enfócate en la mancha oscura del lado derecho de la pantalla ya que ese es el voladizo.
- Concéntrese en la superficie superior de mica, teniendo cuidado de no enfocarse en la superficie inferior entre la parte superior de la cinta de carbón de doble cara y la superficie de mica. Generalmente verás una burbuja atrapada entre la cinta de carbón y la superficie de la mica. Si estás enfocado en la superficie superior puedes ver frecuentemente el reflejo de la punta en la superficie de mica. El enfoque real está a medio camino entre los dos puntos de enfoque en voladizo.
- Baje lentamente la punta hacia la superficie, si la cámara está enfocada correctamente sobre la superficie, la punta voladiza gradualmente aparecerá a la vista. Sigue bajando hasta que las imágenes de las dos puntas converjan en una sola. Tenga en cuenta que puede chocar la punta contra la superficie si pasa por este punto. Esto es perjudicial para la punta y puede que no sea posible obtener una imagen si ocurre, y es posible que la punta tenga que ser reemplazada. Sabrás si esto sucede al mirar la punta voladiza si va del negro al blanco brillante. En este punto la punta está en contacto con la superficie y se vuelve blanca ya que no está reflejando la luz de nuevo en el fotodiodo, sino en la cámara.
- Encuentra el punto láser, si el punto no es visible en la pantalla de la cámara mira el soporte en voladizo y mira si era visible. Ayuda a bajar el brillo de la luz blanca, utilizar de nuevo el escenario traslacional para buscarlo.
- Una vez que se haya localizado el punto láser, use las perillas de ajuste láser X e Y para alinear el punto láser aproximadamente sobre la punta del voladizo.
- Maximice la señal de suma utilizando la palanca del espejo fotodetector ubicada en la parte posterior de la cabeza y la traslación láser X e Y. Siempre y cuando el valor de la señal de suma esté por encima de 3.6 V, el instrumento funcionará, pero seguirá ajustando las direcciones X e Y del láser hasta que la señal de suma sea lo más alta posible.
- Para asegurar que el láser esté centrado en el fotodiodo, ponga a cero las señales del detector utilizando las perillas de ajuste del espejo ubicadas en la parte superior y posterior de la cabeza. La perilla en la parte superior de la cabeza ajusta el modo TMAFM, y la perilla en la parte posterior de la cabeza ajusta el modo AFM/LFM. El rango es de -9.9 V a 9.9 V en ambos modos. El número cambiará lentamente en los extremos del rango y rápidamente alrededor de 0 V. Idealmente, la señal puesta a cero debe estar entre ±0.1 V. Haga esto primero en modo TMAFM, luego cambie al modo AFM/LFM e intente poner a cero el detector. Voltear hacia adelante y hacia atrás entre los dos modos varias veces (ajustando cada vez) hasta que el valor en ambos modos sea lo más cercano posible a 0 V. Fluctuará durante el experimento. Si hay deriva constante, puede ajustarla durante el experimento. Si el número no se asienta, el láser podría estar en una mala posición en el voladizo. Mueva el punto láser y repita (Figura\(\PageIndex{10}\)). Siempre termine este paso en modo TMAFM.
- Enfocar de nuevo en la superficie de la muestra.
- La superficie de la muestra aún se puede mover con respecto a la cámara a través de la etapa de muestra. Al elegir un lugar para obtener imágenes de nanopartículas, evita cualquier cosa que puedas ver en la superficie de la muestra. La escala en la pantalla es de 18 µm por cm.


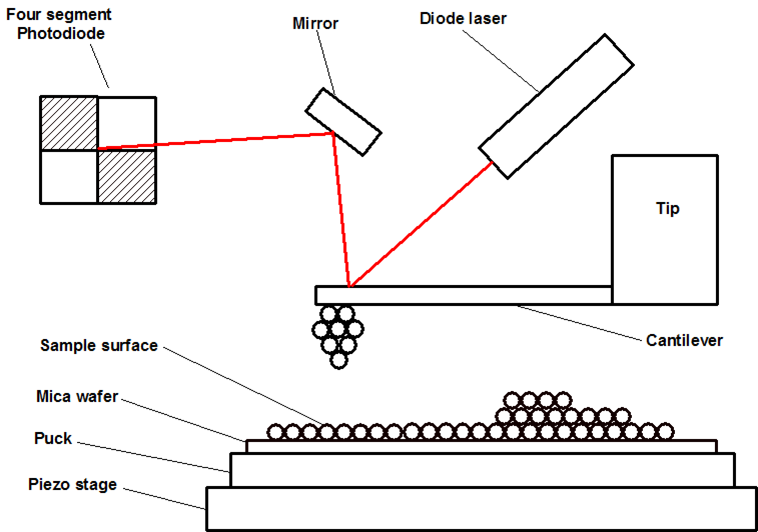
Afinación de Punta
- Inicie sesión en la computadora.
- El software se llama Nanoscope. Cierre el cuadro de diálogo de la versión. Normalmente la pantalla de la izquierda permitirá el ajuste de los parámetros del software, y la pantalla de la derecha mostrará los datos.
- En la pantalla de ajuste, los dos iconos son para ajustar el microscopio (una imagen de un microscopio) y realizar análisis de datos (una imagen de un arco iris). Haga clic en el icono del microscopio.
- Bajo el menú desplegable del microscopio, elija perfil y seleccione AFM de golpeteo. No uses otro perfil de usuario. Utilice el AFM “tapping”.
- Antes de comenzar el modo de roscado, el voladizo debe estar sintonizado para garantizar el correcto funcionamiento. Cada punta tiene su propia frecuencia de resonancia. El voladizo se puede ajustar automáticamente a ciegas o sintonizar manualmente. Sin embargo, el esquema de ajuste automático puede conducir la amplitud tan alta como para dañar la punta.
Sintonización automática
- Haga clic en el icono de melodía en voladizo.
- Haga clic en el botón de sintonización automática. La computadora ingresará al procedimiento de sintonización, ingresando automáticamente parámetros tales como punto de ajuste y amplitud de accionamiento. Si se sintoniza correctamente, la frecuencia de la unidad será de aproximadamente 300 Hz.
Afinación Manualmente
- Haga clic en el icono de melodía en voladizo.
- Seleccione la afinación manual en el menú de controles de barrido.
- La gráfica es de amplitud (blanco) y fase (amarillo) versus frecuencia. El ancho de barrido es el rango X. La frecuencia central es la frecuencia de conducción que debe estar entre 270-310 Hz. Por lo general, la gráfica inicial no mostrará ningún pico, y los ajustes X e Y deberán ajustarse para poder ver la gráfica de resonancia.
- Amplíe la ventana espectral a aproximadamente 100 Hz. La ventana de 270 a 310 Hz donde se establecerá la frecuencia de conducción debe ser visible.
- Para acercar usa la línea verde (¡este software no es clic y arrastre!) :
- Separación por clic izquierdo
- Posición de clic izquierdo
- Haga clic derecho para hacer algo
- Clic derecho para borrar líneas
- Si se recorta un pico, cambie la amplitud de la unidad. Idealmente esto estará entre 15 y 20 mV, y debería estar por debajo de 500 mV. Si una línea blanca no es visible (debe haber una línea blanca a lo largo de la parte inferior de la gráfica), se debe aumentar la amplitud de la unidad.
- Idealmente el pico tendrá una forma regular y solo hombros pequeños. Si hay mucho ruido, vuelva a instalar la punta y las cosas podrían mejorar. (Tenga cuidado ya que el esquema de ajuste automático puede conducir la amplitud tan alta como para dañar la punta).
- En este punto, el ajuste automático está bien. Podemos ver que los parámetros son razonables. Para continuar con el proceso manual, continúe siguiendo estos pasos.
- Ajusta la amplitud de la unidad para que el pico esté a 2.0 V.
- El punto de ajuste de amplitud mientras que la sintonización corresponde al desajuste vertical. Si se establece en 0, la línea verde es 0.
- Coloque la frecuencia de accionamiento no en el centro del pico, sino en el 5% hacia la energía baja (izquierda) del valor pico. Este desplazamiento es de aproximadamente 4/10 de una división. Haga clic con el botón derecho tres veces para ejecutar este cambio. Esto explica la amortiguación que se produce cuando la punta se acerca a la superficie de la muestra.
- Monitor izquierdo - cuadro de diálogo del canal 2 - haga clic en fase cero.
Adquisición de imágenes
- Haga clic en el icono del globo ocular para el modo de imagen.
- Ajustes de parámetros.
- Otros controles.
- Modo de microscopio: tapping.
- Altura máx. límite Z: 5.064 µm. Esto se puede reducir si se limita en la resolución Z.
- Mesa de colores: 2.
- Engage punto de ajuste: 1.00.
- Número de serie de este escáner (verificación doble ya que este tiene el parámetro de fábrica y es diferente del otro AFM).
- Retracción de actualización de parámetros; deshabilitada.
- Controles de escaneo
- Tamaño de escaneo: 2 µm. Tenga cuidado al cambiar este valor: automáticamente irá entre µm y nm
- (los valores razonables son de 200 nm a 100 µm).
- Relación de aspecto: 1 a 1.
- Desplazamiento X e Y: 0.
- Ángulo de escaneo (como rotación de escaneo): ráster en diagonal.
- Velocidad de escaneo: 1.97 Hz es rápido y 100 Hz es lento.
- Control de retroalimentación:
- SPM: amplitud.
- Ganancia integral: 0.5 (este parámetro y el siguiente parámetro se pueden cambiar para mejorar la imagen).
- Ganancia proporcional: 0.7.
- Punto de ajuste de amplitud: 1 V.
- Frecuencia de accionamiento: desde la sintonización.
- Amplitud de accionamiento: desde afinación.
Una vez que se hayan establecido todos los parámetros, haga clic en activar (icono con la flecha verde hacia abajo) para comenzar a enganchar voladizo a la superficie de la muestra y comenzar la adquisición La parte inferior de la pantalla debe estar “asegurada por la punta”. Cuando la punta llega a la superficie, automáticamente comienza a obtener imágenes.
Si el punto de ajuste de amplitud es alto, el voladizo se aleja de la superficie, ya que la oscilación se amortigua a medida que se acerca. Mientras esté en oscilación libre (establezca el punto de ajuste de amplitud en 3), ajuste la amplitud de la unidad para que el voltaje de salida (visto en el alcance) sea de 2 V. Los grandes cambios en este valor mientras se ejecuta un experimento indican que algo está en la punta. Una vez que el voltaje de salida esté en 2 V, vuelva a bajar el punto de ajuste de amplitud a un valor que ponga la línea de posición exterior z blanca y en el centro de la barra en el software (1 V está muy cerca).
Seleccione el tipo de datos del canal 1 — altura. Seleccione el tipo de datos del canal 2 - amplitud. La amplitud parece una imagen 3D y es una excelente herramienta de visualización o para una presentación. Sin embargo, los datos reales son los datos de altura.
Baje la punta (comience con el punto de ajuste de amplitud a 2). El objetivo es golpear lo suficientemente fuerte como para obtener una buena imagen, pero no tanto como para dañar la superficie de la punta. Establezca en 3 clics abajo jus tocando bajando aún más el punto de ajuste de amplitud con 3 clics de flecha izquierda en el teclado. La escala de posición del centro Z de la punta en la pantalla derecha muestra la extensión en el escáner piezoeléctrico. Cuando la punta esté correctamente ajustada, espere que este valor esté cerca del centro.
Seleccione el modo de visualización/alcance (el icono del alcance). Verifique si el rastreo y el retorno se están rastreando entre sí. Si es así, las líneas deberían tener el mismo aspecto, pero probablemente no se superpongan entre sí vertical u horizontalmente. Si están rastreando bien, entonces su punta está escaneando la superficie de la muestra y puede volver al modo de visión/imagen (el icono de la imagen). Si no están rastreando bien, ajuste la velocidad de escaneo, las ganancias y/o el punto de ajuste para mejorar el seguimiento. Si el rastreo y el retorno se ven completamente diferentes, es posible que deba disminuir el punto de ajuste para mejorar el seguimiento. Si el rastreo y el retroceso se ven completamente diferentes, es posible que deba disminuir el punto de ajuste uno o dos clics con la tecla de flecha izquierda hasta que comiencen a tener características comunes en ambas direcciones. Entonces reducir la velocidad de escaneo: un valor razonable para tamaños de escaneo de 1-3 µm sería de 2 Hz. Siguiente intenta aumentar la ganancia integral. A medida que aumentas la ganancia integral, el seguimiento debería mejorar, aunque alcanzarás un valor más allá del cual el ruido aumentará a medida que el bucle de retroalimentación comience a oscilar. Si esto sucede, reduzca las ganancias, si el rastreo y el retroceso aún no rastrean satisfactoriamente, vuelva a reducir el punto de ajuste. Una vez que la punta esté rastreando la superficie, elija el modo de visualización/imagen.
La ganancia integral controla la cantidad de señal de error integrada utilizada en el cálculo de retroalimentación. Cuanto más alto se establezca este parámetro, mejor será la punta rastreará la misma topografía. Sin embargo, si se establece demasiado alto, el ruido debido a la oscilación de retroalimentación se introducirá en el escaneo.
La ganancia proporcional controla la cantidad de señal de flecha proporcional utilizada en el cálculo de retroalimentación.
Una vez ajustado el punto de ajuste de amplitud con los datos de fase, cambie el canal 2 a amplitud. La escala de datos se puede cambiar (es la misma que para la visualización ya que no afecta a los datos). En la imagen de amplitud, bajar el voltaje aumenta el contraste.
Mueva pequeñas cantidades en la superficie de la imagen con desplazamiento X e Y para evitar objetos grandes y poco interesantes. Por ejemplo, establecer el desplazamiento Y en -2 eliminará las entidades en la parte inferior de la imagen, desplazando así la imagen hacia arriba. Cambiándolo a -3 moverá entonces la imagen una unidad más hacia arriba. Asegúrate de que estás usando µm y no nm si esperas ver un cambio real.
Para avanzar más, desengancha la punta (haz clic en el icono de flecha roja hacia arriba para que la punta se mueva hacia arriba 25 µm y se asegure). Mueva la etapa traslacional superior para mantener la punta a la vista en la cámara de luz. Vuelva a enganchar la punta.
Si se dibuja la sombra en la imagen, el punto de ajuste de amplitud debe bajarse aún más. El área de la imagen que se está dibujando está controlada por el menú desplegable de fotogramas (y las flechas arriba y abajo). Baje el punto de ajuste y vuelva a dibujar el mismo vecindario para ver si hay mejora. También se puede ajustar la ganancia proporcional e integral.
La ventana de marco le permite reiniciar desde la parte superior, inferior o una línea en particular.
Otra forma de ajustar el valor del punto de ajuste de amplitud es hacer clic en el alcance de la señal para garantizar la superposición de trazo y retroceso. Para detener el rasterizado Y, eje de escaneo lento.
Para tomar una mejor imagen, aumente el número de líneas (512 es máx), disminuya la velocidad (1 Hz) y baje el punto de ajuste de amplitud. La resolución es de aproximadamente 10 nm en las direcciones X e Y debido al tamaño de la punta. La resolución en la dirección Z es menor a 1 nm.
Cambiar el tamaño del escaneo nos permite acercar las funciones. Puede acercar un punto central usando el cuadro de acercamiento (clic izquierdo para alternar entre la posición y el tamaño de la caja), o puede ingresar manualmente un tamaño de escaneo en la pantalla de la izquierda.
Haga clic en capturar (el icono de la cámara) para tomar imágenes. Para acelerar las cosas, reinicie el escaneo en un borde para tomar una nueva imagen después de realizar cualquier cambio en los parámetros de escaneo y retroalimentación. Cuando se cambian los parámetros, la opción de captura cambiará a “siguiente”. Existe una opción de captura forzada, que permite recopilar una imagen incluso si los parámetros se han cambiado durante la captura. No es completamente confiable.
Para cambiar el nombre del archivo, seleccione capturar nombre de archivo en el menú de captura. El archivo se guardará en el! directorio que es d:\capture. Para guardar la imagen, en el menú desplegable de utilidades seleccione Exportación TIFF. La unidad zip es G:.
Adquisición de imágenes
El análisis implica aplanar la imagen y medir varias dimensiones de partículas, haga clic en el botón de espectro.
Seleccione los datos de altura (menú desplegable de la imagen, seleccione la imagen izquierda o derecha). Los nuevos iconos en el menú “análisis” son:
- Miniaturas
- Vista superior
- Vista lateral
- Análisis de sección
- Rugosidad
- Rolling pin (aplanamiento)
- Autoajuste plano
Para quitar las bandas (bandas) de la imagen, seleccione el rodillo. El orden de aplanamiento es el orden de la corrección de línea base. Un desplazamiento bruto es de orden 0, una línea recta inclinada es el orden 1. Por lo general, se elige una corrección de segundo orden para eliminar el “arco del escáner” que son los canales oscuros en el plano de la imagen.
Para eliminar más sombras, dibuje cuadros de exclusión sobre objetos grandes y luego vuelva a aplanar. Asegúrese de guardar el archivo con un nuevo nombre. El valor predeterminado es t sobrescribirlo.
En el análisis de sección, utilice la opción de cursor múltiple para medir una partícula en todas las dimensiones. Seleccione el cursor fijo. Puedes guardar fotos de esta información, ¡pero hay que anotar las cosas! También hay un menú de análisis de partículas.
Desenganche el voladizo y asegúrese de que el voladizo esté en modo seguro antes de mover el voladizo a los otros puntos o cambiar a otra muestra.
Afloje la abrazadera para quitar la punta y el soporte.
Retire la punta y reemplácela sobre la cinta adhesiva de gel usando las pinzas finas.
Recuperar la muestra con pinzas.
Cierre el programa.
Cierre la sesión del instrumento.
Después del experimento, apague el monitor y la potencia de la fuente de luz. Deje el controlador encendido.
Cerrar sesión en el libro de registro.
AFM - Microscopía con Sonda de Escan
La microscopía de fuerza atómica (AFM) se ha convertido en una poderosa herramienta para investigar materiales 2D y materiales 2D relacionados (por ejemplo, grafeno) tanto para la obtención de imágenes a nanoescala como para la medición y análisis de las propiedades de fricción.
La estructura básica y función del sistema típico de Nanoscope AFM se discute en la sección de la guía práctica.
Para el modo de contacto de AFM, se muestra un esquema en\(\PageIndex{11}\) la Figura La punta escanea en la superficie de la muestra, el voladizo tendrá un desplazamiento de Δz, que es función de la posición de la punta. Si conocemos la constante mecánica de la punta C, la fuerza de interacción, o la carga normal de entre la punta y la muestra se puede calcular por\ ref {2}, donde C está determinada por el material y las propiedades intrínsecas de la punta y voladizo. Como se muestra en la Figura\(\PageIndex{11}\) a, generalmente tratamos el lado posterior del voladizo como un espejo para reflejar el láser, por lo que el cambio de posición cambiará la longitud de trayectoria del láser, y luego detectado por el detector de cuadrantes.
\[ F\ =\ C \cdot \Delta z \label{2} \]
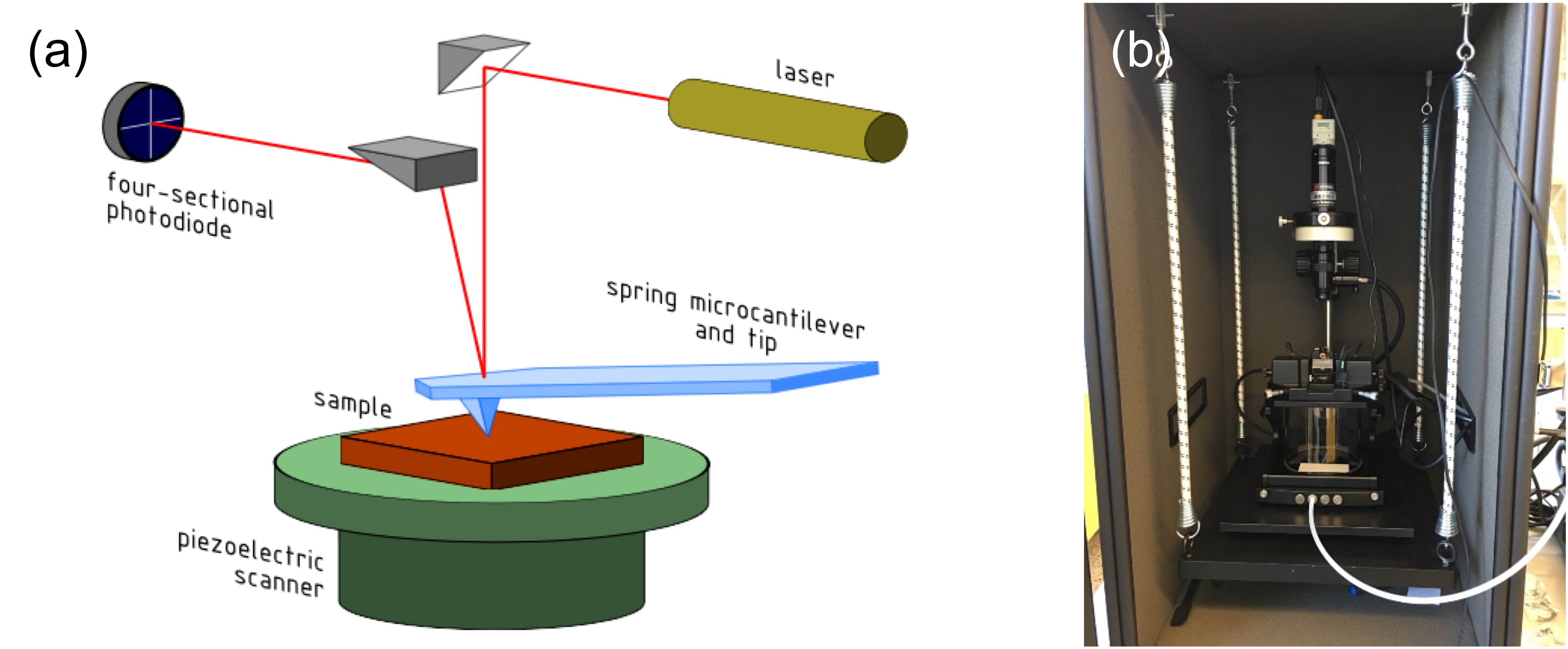
Podemos obtener la topografía, perfil de altura, fase y canal de fuerza lateral mientras se mide a través del modo de contacto AFM. Comparando el modo de golpeteo, la fuerza lateral, también conocida como fricción, parece muy crucial. La señal directa adquirida es el cambio de corriente provocado por la fuerza lateral sobre la muestra que interactúa con la punta, por lo que la unidad suele ser nA. Para calcular la fuerza de fricción real en Newton (N) o Nano-Newton (nN), es necesario dejar que esta corriente señale el tiempo de un coeficiente de fricción, que también está determinado por las propiedades intrínsecas de los materiales que hace la punta.
En la Figura\(\PageIndex{11}\) b se muestra un AFM típico. La etapa de muestra se encuentra en el interior de la cámara inferior. Puede soplar el gas en la cámara o bombear el vacío que necesita para la prueba bajo diferentes ambientes. Eso es especialmente importante en las pruebas de las propiedades de fricción de los materiales.
Para la parte de preparación de la muestra, la muestra fijada sobre la mica mencionada anteriormente en la guía es para los polvos químicos sintetizados. Para el grafeno, se puede colocar simplemente sobre cualquier sustrato plano, como mica, SiC, zafiro, sílice, etc. Simplemente colocando la muestra en estado sólido sobre el sustrato sobre la etapa de muestra y se puede realizar el trabajo posterior.
Recopilación de datos
Para la recolección de datos, la topografía y el perfil de altura se adquieren utilizando el mismo método en el modo de roscado. Sin embargo, hay dos piezas adicionales de información que son necesarias para determinar las propiedades de fricción del material. Primero, la carga normal. La carga normal se describe en\ ref {2}; sin embargo, lo que obtenemos directamente aquí proporcional a la carga normal es el punto de ajuste que le damos para la punta a la muestra. Es una corriente. Entonces necesitamos un coeficiente de fuerza vertical (CVF) para obtener cuál es la carga normal que aplicamos al material, como se ilustra en\ ref {3}
\[ F\ =\ I_{setpoint} \cdot C_{VF} \label{3} \]
Para la recolección de datos, la topografía y el perfil de altura se adquieren utilizando el mismo método en el modo de roscado. Sin embargo, hay dos piezas adicionales de información que son necesarias para determinar las propiedades de fricción del material. Primero, la carga normal. La carga normal se describe en\ ref {4}, donde K es la rigidez de la punta, se puede obtener a través del modelo vibracional del voladizo, y generalmente podemos obtenerla si compramos la punta comercial AFM. L es el coeficiente óptico del voladizo, se puede adquirir calibrando la curva fuerza-desplazamiento de la punta, como se muestra en la Figura\(\PageIndex{12}\). Entonces L se puede adquirir obteniendo la pendiente del proceso 1 o 6 en la Figura\(\PageIndex{13}\).
\[ C_{VP} \ =\ \frac{K}{L} \label{4} \]
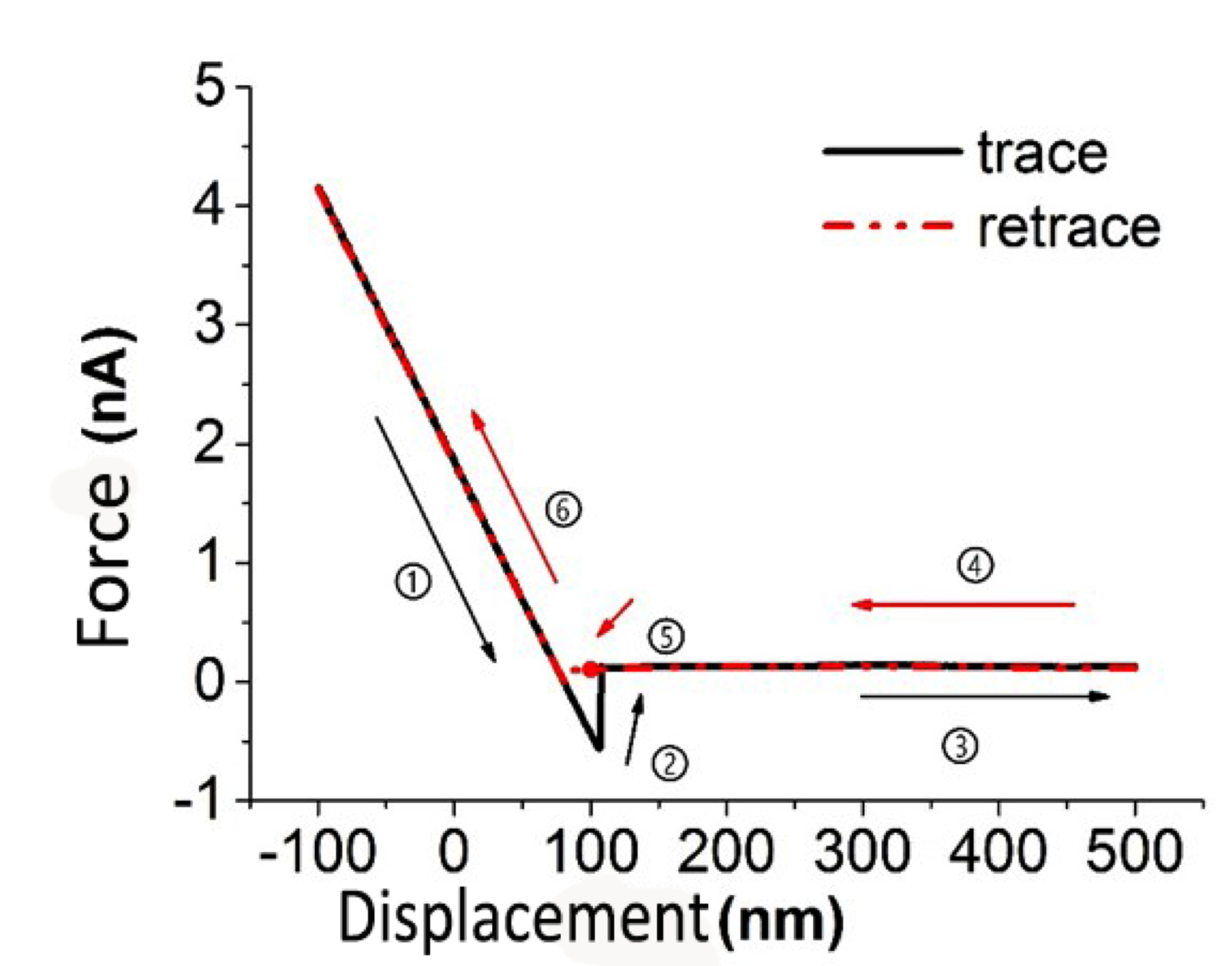
La figura\(\PageIndex{13}\) es una imagen típica de fricción, se compone de n*n líneas por escaneo. Cada punto es el valor de la fuerza de fricción correspondiente a ese punto. Todo lo que tenemos que hacer es obtener la fricción promedio para el área que nos interesa. Entonces usa esta señal de corriente multiplicada por el coeficiente de fuerza lateral entonces podemos obtener la fuerza de fricción real.

Durante el proceso de recolección de los datos originales de la fuerza lateral (fricción), para cada línea de la imagen, la información de fricción en realidad se compone de dos líneas de datos: trace y back (ver Figura\(\PageIndex{13}\)). El promedio de resultados para traza (Figura\(\PageIndex{13}\), línea negra) y retorno (Figura\(\PageIndex{13}\), línea roja) como la señal de fricción del punto determinado en la línea. Es decir, la fricción real se determina a partir de\ ref {5}, donde Iforward e Ibackward son puntos de datos que podemos derivar de la traza y retorno de la imagen de fricción, y CLF es el coeficiente de fuerza lateral.
\[ F_{f}\ =\ \frac{I_{forward}\ -\ I_{backward}}{2} \cdot C_{LF} \label{5} \]
Análisis de datos
Hay varias maneras de comparar los detalles de las propiedades de fricción en la nanoescala. La figura\(\PageIndex{14}\) es un ejemplo que compara la fricción en la muestra (en este caso, grafeno de pocas capas) y la fricción sobre el sustrato (SiO2). Como se ilustra en\ ref {5}, cualitativamente podemos ver fácilmente que la fricción en el grafeno es mucho más pequeña que en el sustrato de SiO2. Como el grafeno es un gran lubricante y tiene baja fricción, los datos originales solo nos permiten confirmarlo.

La figura\(\PageIndex{15}\) muestra múltiples capas de grafeno sobre una mica. Al seleccionar una determinada línea de sección transversal y comparar tanto el perfil de altura como el perfil de fricción, nos proporcionará alguna información de la fricción relacionada con la estructura detrás de esta sección. La curva de fricción-distancia es una ruta importante típica para el análisis de datos.
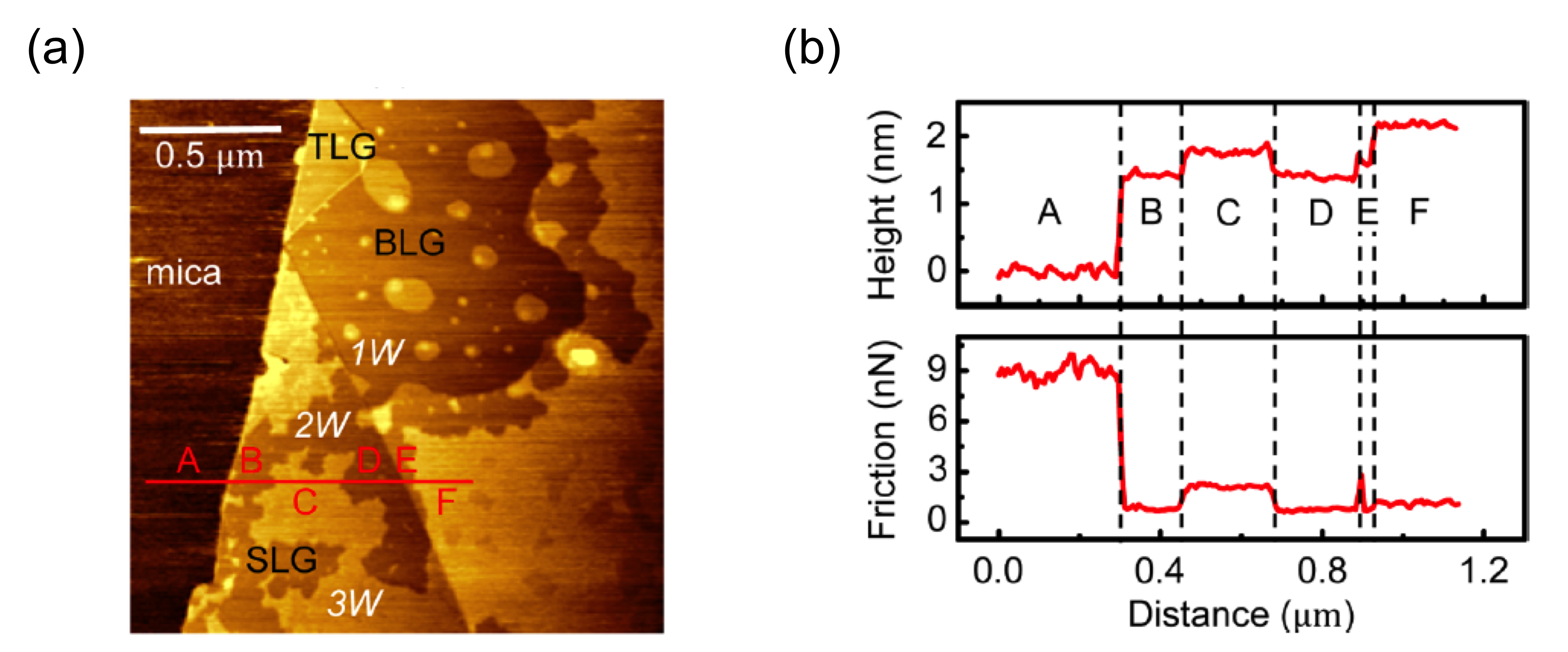
También podemos tomar la señal promedio de fricción para un área y compararla de la región a la región. La figura\(\PageIndex{16}\) muestra una región del grafeno con los números de capa de 1-4. Las figuras\(\PageIndex{16}\) a y b son también la topografía y la imagen de fricción respectivamente. Al comparar la fricción promedio del área al área, obviamente podemos ver que la fricción sobre el grafeno disminuye a medida que aumenta el número de capas. Aunque las Figuras\(\PageIndex{16}\) c y d obviamente podemos ver este cambio promedio de fricción en la superficie de 1 a 4 capas de grafeno. Pero para una forma estadística más general, obtener la señal normalizada de la fricción promedio y compararlas puede ser más sencillo.
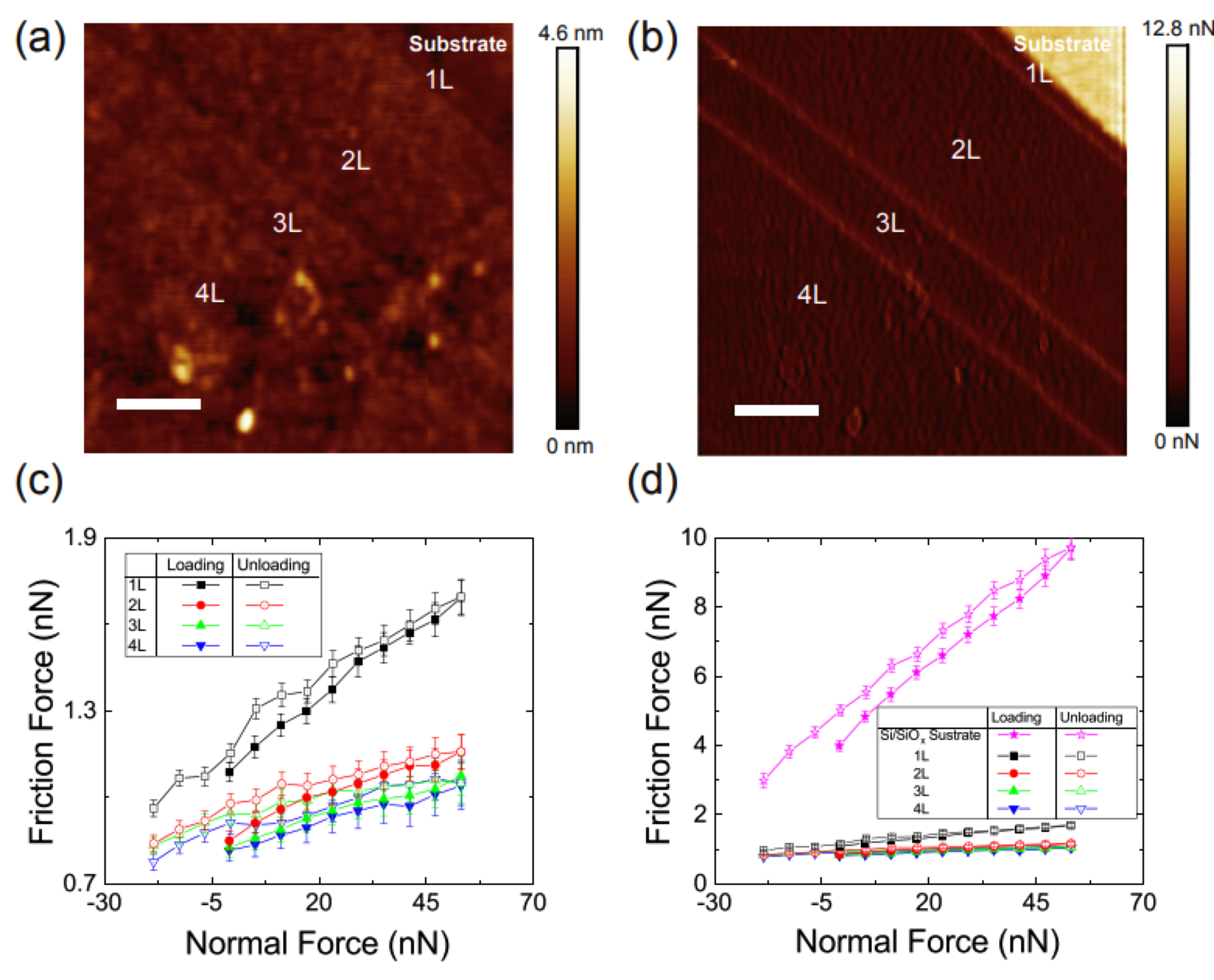
Otra forma de comparar las propiedades de fricción es que, para aplicar diferente carga normal y ver cómo cambia la fricción, luego obtener la información sobre la curva de carga fricción-normal. Esto es importante porque sabemos que demasiada carga normal para que los materiales puedan romper o desgastar fácilmente los materiales. Ejemplos y detalles se discutirán a continuación.
El efecto de H 2 O: un cuento de precaución
Durante el proceso de usar el enfoque de punta al grafeno y aplicar la carga normal (aumento de la carga normal, proceso de carga) y retirar la punta gradualmente (disminución de la carga normal, proceso de descarga), la fricción sobre el grafeno exhibe histéresis, lo que significa un gran incremento de la fricción mientras arrastramos la punta. Este proceso se puede analizar a partir de la curva de carga normal de fricción, como se muestra en la Figura\(\PageIndex{17}\). Se pensó que este efecto puede deberse al detalle del comportamiento de interacción del área de contacto entre la punta y el grafeno. Sin embargo, si prueba esto en diferentes condiciones ambientales, por ejemplo, si se sopló nitrógeno en la cámara mientras ocurrieron las pruebas, esta histéresis desaparece.
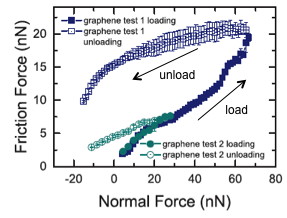
Figura Histéresis por\(\PageIndex{17}\) fricción en la superficie de grafeno/Cu. Adaptado de P. Egberts, G. H. Han, X. Z. Liu, A. T. C. Johnson, y R. W. Carpick, ACS Nano, 2014, 8, 5012. Derechos de autor: American Chemical Society (2014).
Para explorar el mecanismo de tal fenómeno, se realizó una serie de pruebas de fricción bajo diferentes condiciones. Un factor clave aquí es la humedad en el ambiente de prueba. La figura\(\PageIndex{18}\) es una medición de fricción típica en grafeno monocapa y 3 capas sobre SiOx. Podemos ver que la histéresis por fricción es muy diferente bajo gas nitrógeno seco (0.1% de humedad) y el ambiente (24% de humedad) de la Figura\(\PageIndex{19}\).

La simulación en este sistema sugiere que esta histéresis de fricción en la superficie del grafeno se debe a que el agua interactúa con la superficie del grafeno. El ángulo de contacto entre las interfaces tip/molécula agua-grafeno es el componente clave. El estudio posterior sugiere que una vez que pones las muestras de grafeno en el aire y las expongas por un largo periodo de tiempo (varios días), la unión química en la superficie puede cambiar debido a la molécula de agua en el aire de manera que las propiedades de fricción a nanoescala pueden ser muy diferentes.
La unión entre el material investigado y el sustrato puede ser muy vital para el comportamiento de fricción a nanoescala. Los estudios realizados durante los años sugieren que la fricción del grafeno disminuirá a medida que aumente el número de capas. Esto es adaptable para grafeno suspendido (sin nada que lo sostenga) y grafeno en la mayoría de los sustratos (como SiOx, lámina de Cu, etc.). Sin embargo, si el grafeno está soportado por la superficie de mica recién dividida, no hay diferencia para las propiedades de fricción del grafeno de diferentes capas, esto se debe a la gran energía de disipación superficial, por lo que el grafeno está firmemente fijado a la mica.
Sin embargo, por otro lado, la superficie de la mica también es hidrófila, esto es causal de la distribución del agua en la superficie de la mica, y la intercalación de agua entre el grafeno y la unión de mica. A través de la medición de fricción del grafeno sobre mica, podemos analizar este sistema cuantitativamente, como se muestra en la Figura\(\PageIndex{18}\).
Resumen
Este estudio de caso solo da un ejemplo de que, Microscopía de Fuerza Atómica en modo contacto, o Microscopía de Fuerza de Fricción es una herramienta poderosa para investigar las propiedades de fricción de los materiales, para su uso tanto en la investigación científica como en la industria química.
La lección más importante para los investigadores es que al analizar cualquier dato de la literatura es importante conocer cuáles son las condiciones de humedad relativa para el experimento en particular, de manera que diversos experimentos puedan compararse directamente.


