5.5: Espectrometría de Masa de Iones Secundarios
- Page ID
- 69074
La técnica de Espectrometría de Masas de Iones Secundarios (SIMS) es la más sensible de todas las técnicas analíticas de superficie comúnmente empleadas, capaz de detectar elementos de impurezas presentes en una capa superficial a una concentración < 1 ppm, y concentraciones a granel de impurezas de alrededor de 1 ppb (parte por billón) en casos favorables. Esto se debe a la alta sensibilidad inherente asociada con las técnicas basadas en espectrometría de masas.
Hay una serie de variantes diferentes de la técnica:
- Todas estas variaciones de la técnica se basan en el mismo proceso físico básico y es este proceso el que se discute aquí, junto con una breve introducción al campo de los SIMS estáticos. Se pueden obtener notas adicionales sobre SIMS dinámicos y de imagen en la Sección 7.4 - SIMS Imaging y Depth Profiling.
En SIMS la superficie de la muestra es sometida a bombardeo por iones de alta energía - esto conduce a la expulsión (o pulverización catódica) de especies tanto neutras como cargadas (+/-) de la superficie. Las especies expulsadas pueden incluir átomos, grupos de átomos y fragmentos moleculares.
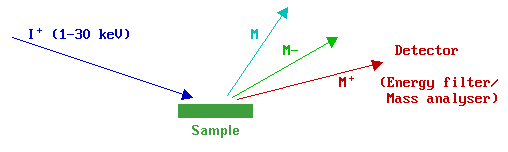
El analizador de masas puede ser un analizador de masas cuadrupolo (con resolución de masa unitaria), pero a menudo también se usan analizadores de masa de sector magnético o analizadores de tiempo de vuelo (TOF) y estos pueden proporcionar una sensibilidad y resolución de masa sustancialmente más altas, y un rango de masa mucho mayor (aunque a un costo mayor). En general, los analizadores TOF son los preferidos para los SIMS estáticos, mientras que los analizadores cuadrupolares y de sector magnético son los preferidos para los SIMS dinámicos.
Los iones incidentes más comúnmente empleados (denotados genéricamente por I + en el diagrama anterior) utilizados para bombardear la muestra son iones de gas noble (por ejemplo, Ar +) pero otros iones (por ejemplo, Cs +, Ga + u O 2 +) se prefieren para algunos aplicaciones. Con TOF-SIMS, el haz de iones primario es pulsado para permitir que los iones se dispersen a lo largo del tiempo desde el instante del impacto, y se requieren duraciones de pulso muy cortas para obtener una alta resolución de masa.


