4.3: Dopaje
- Page ID
- 86504
\( \newcommand{\vecs}[1]{\overset { \scriptstyle \rightharpoonup} {\mathbf{#1}} } \)
\( \newcommand{\vecd}[1]{\overset{-\!-\!\rightharpoonup}{\vphantom{a}\smash {#1}}} \)
\( \newcommand{\dsum}{\displaystyle\sum\limits} \)
\( \newcommand{\dint}{\displaystyle\int\limits} \)
\( \newcommand{\dlim}{\displaystyle\lim\limits} \)
\( \newcommand{\id}{\mathrm{id}}\) \( \newcommand{\Span}{\mathrm{span}}\)
( \newcommand{\kernel}{\mathrm{null}\,}\) \( \newcommand{\range}{\mathrm{range}\,}\)
\( \newcommand{\RealPart}{\mathrm{Re}}\) \( \newcommand{\ImaginaryPart}{\mathrm{Im}}\)
\( \newcommand{\Argument}{\mathrm{Arg}}\) \( \newcommand{\norm}[1]{\| #1 \|}\)
\( \newcommand{\inner}[2]{\langle #1, #2 \rangle}\)
\( \newcommand{\Span}{\mathrm{span}}\)
\( \newcommand{\id}{\mathrm{id}}\)
\( \newcommand{\Span}{\mathrm{span}}\)
\( \newcommand{\kernel}{\mathrm{null}\,}\)
\( \newcommand{\range}{\mathrm{range}\,}\)
\( \newcommand{\RealPart}{\mathrm{Re}}\)
\( \newcommand{\ImaginaryPart}{\mathrm{Im}}\)
\( \newcommand{\Argument}{\mathrm{Arg}}\)
\( \newcommand{\norm}[1]{\| #1 \|}\)
\( \newcommand{\inner}[2]{\langle #1, #2 \rangle}\)
\( \newcommand{\Span}{\mathrm{span}}\) \( \newcommand{\AA}{\unicode[.8,0]{x212B}}\)
\( \newcommand{\vectorA}[1]{\vec{#1}} % arrow\)
\( \newcommand{\vectorAt}[1]{\vec{\text{#1}}} % arrow\)
\( \newcommand{\vectorB}[1]{\overset { \scriptstyle \rightharpoonup} {\mathbf{#1}} } \)
\( \newcommand{\vectorC}[1]{\textbf{#1}} \)
\( \newcommand{\vectorD}[1]{\overrightarrow{#1}} \)
\( \newcommand{\vectorDt}[1]{\overrightarrow{\text{#1}}} \)
\( \newcommand{\vectE}[1]{\overset{-\!-\!\rightharpoonup}{\vphantom{a}\smash{\mathbf {#1}}}} \)
\( \newcommand{\vecs}[1]{\overset { \scriptstyle \rightharpoonup} {\mathbf{#1}} } \)
\(\newcommand{\longvect}{\overrightarrow}\)
\( \newcommand{\vecd}[1]{\overset{-\!-\!\rightharpoonup}{\vphantom{a}\smash {#1}}} \)
\(\newcommand{\avec}{\mathbf a}\) \(\newcommand{\bvec}{\mathbf b}\) \(\newcommand{\cvec}{\mathbf c}\) \(\newcommand{\dvec}{\mathbf d}\) \(\newcommand{\dtil}{\widetilde{\mathbf d}}\) \(\newcommand{\evec}{\mathbf e}\) \(\newcommand{\fvec}{\mathbf f}\) \(\newcommand{\nvec}{\mathbf n}\) \(\newcommand{\pvec}{\mathbf p}\) \(\newcommand{\qvec}{\mathbf q}\) \(\newcommand{\svec}{\mathbf s}\) \(\newcommand{\tvec}{\mathbf t}\) \(\newcommand{\uvec}{\mathbf u}\) \(\newcommand{\vvec}{\mathbf v}\) \(\newcommand{\wvec}{\mathbf w}\) \(\newcommand{\xvec}{\mathbf x}\) \(\newcommand{\yvec}{\mathbf y}\) \(\newcommand{\zvec}{\mathbf z}\) \(\newcommand{\rvec}{\mathbf r}\) \(\newcommand{\mvec}{\mathbf m}\) \(\newcommand{\zerovec}{\mathbf 0}\) \(\newcommand{\onevec}{\mathbf 1}\) \(\newcommand{\real}{\mathbb R}\) \(\newcommand{\twovec}[2]{\left[\begin{array}{r}#1 \\ #2 \end{array}\right]}\) \(\newcommand{\ctwovec}[2]{\left[\begin{array}{c}#1 \\ #2 \end{array}\right]}\) \(\newcommand{\threevec}[3]{\left[\begin{array}{r}#1 \\ #2 \\ #3 \end{array}\right]}\) \(\newcommand{\cthreevec}[3]{\left[\begin{array}{c}#1 \\ #2 \\ #3 \end{array}\right]}\) \(\newcommand{\fourvec}[4]{\left[\begin{array}{r}#1 \\ #2 \\ #3 \\ #4 \end{array}\right]}\) \(\newcommand{\cfourvec}[4]{\left[\begin{array}{c}#1 \\ #2 \\ #3 \\ #4 \end{array}\right]}\) \(\newcommand{\fivevec}[5]{\left[\begin{array}{r}#1 \\ #2 \\ #3 \\ #4 \\ #5 \\ \end{array}\right]}\) \(\newcommand{\cfivevec}[5]{\left[\begin{array}{c}#1 \\ #2 \\ #3 \\ #4 \\ #5 \\ \end{array}\right]}\) \(\newcommand{\mattwo}[4]{\left[\begin{array}{rr}#1 \amp #2 \\ #3 \amp #4 \\ \end{array}\right]}\) \(\newcommand{\laspan}[1]{\text{Span}\{#1\}}\) \(\newcommand{\bcal}{\cal B}\) \(\newcommand{\ccal}{\cal C}\) \(\newcommand{\scal}{\cal S}\) \(\newcommand{\wcal}{\cal W}\) \(\newcommand{\ecal}{\cal E}\) \(\newcommand{\coords}[2]{\left\{#1\right\}_{#2}}\) \(\newcommand{\gray}[1]{\color{gray}{#1}}\) \(\newcommand{\lgray}[1]{\color{lightgray}{#1}}\) \(\newcommand{\rank}{\operatorname{rank}}\) \(\newcommand{\row}{\text{Row}}\) \(\newcommand{\col}{\text{Col}}\) \(\renewcommand{\row}{\text{Row}}\) \(\newcommand{\nul}{\text{Nul}}\) \(\newcommand{\var}{\text{Var}}\) \(\newcommand{\corr}{\text{corr}}\) \(\newcommand{\len}[1]{\left|#1\right|}\) \(\newcommand{\bbar}{\overline{\bvec}}\) \(\newcommand{\bhat}{\widehat{\bvec}}\) \(\newcommand{\bperp}{\bvec^\perp}\) \(\newcommand{\xhat}{\widehat{\xvec}}\) \(\newcommand{\vhat}{\widehat{\vvec}}\) \(\newcommand{\uhat}{\widehat{\uvec}}\) \(\newcommand{\what}{\widehat{\wvec}}\) \(\newcommand{\Sighat}{\widehat{\Sigma}}\) \(\newcommand{\lt}{<}\) \(\newcommand{\gt}{>}\) \(\newcommand{\amp}{&}\) \(\definecolor{fillinmathshade}{gray}{0.9}\)Comenzando con una oblea preparada y pulida, ¿cómo conseguimos entonces un circuito integrado? Nos centraremos en el proceso CMOS, descrito en el último capítulo. Supongamos que tenemos oblea que se dopó durante el crecimiento para que tenga una concentración de fondo de aceptores en ella (es decir, es de tipo p). Refiriéndose de nuevo a CMOS Logic, se puede ver que lo primero que necesitamos construir es un n-tanque o foso. Para ello, necesitamos alguna forma de introducir impurezas adicionales en el semiconductor.
Hay varias formas de hacerlo, pero la tecnología actual se basa casi exclusivamente en una técnica llamada implantación de iones. En la figura de la sección anterior se muestra un diagrama de un implantador iónico. Un implantador de iones utiliza un gas fuente de dopante, lo ioniza y conduce los iones a la oblea. El gas dopante se ioniza y los iones cargados resultantes se aceleran a través de un campo magnético, donde se analizan en masa. El campo magnético vertical hace que el haz de iones se extienda, según su masa. Una abertura delgada selecciona los iones de interés, y los deja pasar, bloqueando a todos los demás. Esto asegura que solo estemos implantando el ion que queremos, y de hecho, ¡incluso selecciona para el isótopo adecuado! Los átomos ionizados son luego acelerados a través de varias decenas a cientos de kilovoltios, y luego desviados por un campo eléctrico, al igual que en un osciloscopio CRT. De hecho, la mayoría de las veces el haz de iones se “rastrea” a través de la superficie de la oblea de silicio. Los iones golpean la oblea de silicio y pasan a su interior. Una medición del flujo de corriente en el sistema y su integral, es una medida de cuánto dopante se depositó en la oblea. Esto suele darse en términos del número de dopantes\(\frac{\mathrm{atoms}}{\mathrm{cm}^2}\) al que se ha expuesto la oblea.
Después de que los átomos ingresan al silicio, interactúan con la celosía, creando defectos, y disminuyendo la velocidad hasta que finalmente se detienen. Las distribuciones atómicas típicas, en función del voltaje del implante, se muestran en la Figura\(\PageIndex{1}\) para su implantación en silicio amorfo. Cuando la implantación se realiza en material monocristalino, canalizar la movilidad mejorada de un ion por el “pasillo” de una dirección de celosía dada puede sesgar significativamente la distribución de impurezas. Solo pequeños cambios de menos de un grado pueden hacer grandes diferencias en la forma en que finalmente se distribuyen los átomos de impurezas en la oblea. Por lo general, el operador de la máquina de implantes inclina intencionadamente la oblea unos grados de lo normal con respecto a la viga para llegar a resultados más reproducibles.

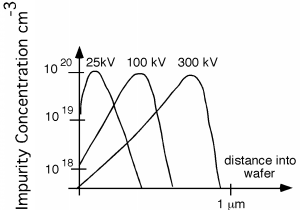
Como era de esperar, disparar\(100 \mathrm{~kV}\) iones a una oblea de silicio probablemente dañe bastante la estructura cristalina. No sólo eso, sino solo tener, digamos, boro en tu oblea no significa que vayas a tener agujeros. Para que el boro se vuelva “eléctricamente activo”, es decir, para actuar como aceptor, tiene que residir en un sitio de celosía de silicio. Incluso si el átomo de boro, de alguna manera, termina en un sitio real de celosía cuando deja de chocar en la oblea, los muchos defectos que se han creado actuarán como trampas profundas. Por lo tanto, el orificio que se forma probablemente quedará atrapado en un sitio de trampa y de todos modos no podrá contribuir a la conductividad eléctrica en la oblea. ¿Cómo podemos arreglar esta situación? Si calentamos cuidadosamente la oblea, podemos hacer que los átomos en el cristal tiemblen, y si lo hacemos bien, todos regresan a donde pertenecen. No solo eso, ¡sino que las impurezas recién agregadas también terminan en sitios de celosía! A este paso se le llama recocido y hace justo lo que se supone que debe hacer. Las temperaturas y tiempos típicos para tal recocido son\(500\) de 10 a 30 minutos.\(1000^{\circ} \mathrm{~C}\)
Algo más ocurre durante la etapa de recocido, sin embargo. Acabamos de agregar, por nuestro paso de implantación, impurezas con una distribución bastante apretada como se muestra en la Figura\(\PageIndex{1}\). Hay un gradiente obvio en la distribución de impurezas, y si hay un gradiente, entonces las cosas pueden comenzar a moverse por difusión, especialmente a temperaturas elevadas.


